电容电压测量技术、技巧与陷阱
在“半导体C-V测量基本原理”一文中,我曾谈到,电容-电压(C-V)测试长期以来被用于判断多种不同器件和结构的各种半导体参数,适用范围包括MOSCAP、MOSFET、双极结型晶体管和JFET、III-V族化合物器件、光伏(太阳能)电池、MEMS器件、有机薄膜晶体管(TFT)显示器、led/' target='_blank'>光电二极管和碳纳米管等等。研发实验室广泛利用C-V测量技术*测新材料、工艺、器件和电路。负责产品和良率增强的工程技术人员利用它们优化工艺和器件性能。可靠性工程师利用这类测量技术对供货商的材料进行资格检验,监测工艺参数,分析失效机理。毋庸置疑,它们是半导体特征分析与测试的基础。
本文讨论如何针对特定的应用选择最合适类型的C-V测量仪器,并探讨某些C-V测试的典型功能和参数提取限制、连接探针台以及校正探针尖的技巧。半导体C-V测试目前可以采用三种不同的电容测量技术:常用的交流阻抗电容计、准静态电容测量以及射频技术(采用矢量网络分析仪和射频探测器)。下面简要介绍每一种电容测量技术。
交流阻抗电容计
交流阻抗表,也称为LCR表(电感L、电容C、电阻R),它利用一个自动平衡电桥保持电容的检测端交流假接地,从而测量复阻抗。
这类电表的通常频率范围为1kHz到10MHz,其工作原理(图1)相对简单。它通过在高电流输出端(HCUR)施加一个交流电压来测量交流阻抗。通过低电流端(LCUR)测量流过器件的电流,通过高低电位端(HPOT和LPOT)测量器件上的电压降。电压和电流的测量采用了能精确判断二者之间相位角的锁相方式。通过测量幅值和相位角,就可以计算出任意所需的交流阻抗参数。
图1:交流阻抗表。
图2:基本的交流阻抗参数。
Z、θ ——阻抗与相位角
R+jX ——电阻与电抗
Cp-Gp ——并联电容和电导=相位角
Cs-Rs ——串联电容和电阻
Cp-D ——并联电容和耗散因子
Cs-D ——串联电容和耗散因子
为要得到基本交流阻抗参数就必须测量阻抗的幅值(在图2中表示为“Z”),此外还需要测量电流和电压之间的相位角(θ)。因此,在极坐标方式下,这一阻抗就是相角为θ的Z。还可以从数学上将其转化为直角坐标的形式,即表示为R+jX,其中R是实数部分,即同相阻抗矢量;jX是虚数部分,即相位阻抗矢量偏转90°,它也是电容矢量。我们甚至可以从数学上将极坐标和直角坐标形式转化为实际的电容和电阻值。
有两种常用的交流阻抗模型:并联模型和串联模型。在并联模型中,结果表示为并联电容(Cp)和并联电导(Gp)。在串联模型中,结果表示为串联电容(Cs)和串联电阻(Rs)。耗散因子(D),即实阻抗与虚阻抗的比值,是从数学上推导出的另外一个常用参数。当测量晶圆上的电容时,我们通常要看耗散因子,因为它是判断最终C-V测量质量的最佳指标。无论采用哪种交流阻抗模型,耗散因子都很容易计算出来。
基于数字源表的准静态电容测量
在准静态电容测量中,我们通过测量电流和电荷来计算电容值。这种“斜率”方法使用简单,但是它的频率范围有限(1~10Hz),因而只能用于一些特殊情况。
斜率测量方法只需要使用两台数字源表(SMU)。通过第一台SMU将一个恒定电流加载到待测器件(DUT)的一个节点上。这台SMU还负责测量该节点上的电压和时间。与此同时,第二台SMU测量DUT另一个节点输出的电流,然后可以利用下列公式计算出电容:
I=C*dV/dt或者C=I/(dV/dt)
这种方法通常可用于测量大小为100~400pF斜率为0.1~1V/S的电容。
利用射频技术测量电容
传输线的电容测量通常采用射频技术,其中利用矢量网络分析仪测量散射参数(S参数),即入射波的反射和传输系数。尽管射频C-V测量问题已超出本文的范围,笔者还是给出了一些有关这类测量技术的相关参考资料[1][2][3]。
C-V测量方法与应用的匹配
交流阻抗技术是最常用的电容测量技术,最适合于一般的低功率门电路,也适用于大多数测试结构和大多数探针,其优势在于所需的设备相对便宜,大多数电子实验室都可以直接找到。但是,它也有一些缺点,例如它的校正方法不如射频测量中使用的校正方法那样精确。另外一个明显的缺点是要求交流阻抗的测试频率必须接近DUT的工作频率,否则必须内插一些测量结果。
图3:准静态C-V“斜率”测量方法。
尽管准静态C-V是最所有测量方法中成本最低,只使用一对SMU,但是它适用的范围有限,包括低漏流高k材料、有机器件或显示器领域。不幸的是,在准静态C-V测量中,测量误差很容易破坏测量结果,尤其对于具有少量漏流器件的特征分析是不准确的。
射频C-V测量是超薄栅、漏电电介质特征分析的最佳选择,它还适用于射频器件的建模。射频探针的矫正方法很容易理解和实现。射频方法的不足之处在于它需要非常昂贵的设备、测试结构和射频探针。此外,它只适用于特征阻抗为50欧姆左右的传输线。如果器件阻抗并不是十分接近50欧姆,这种方法就不准确了。对于某些应用和用户而言,射频测量的配置和分析过程可能太复杂,在这些情况下,经典的交流阻抗测量方法可能更适合。
C-V参数提取的局限性
在探讨C-V测试系统的配置方法之前,了解半导体C-V测量技术的局限性很重要。这些限制有:电容从10fF到1uF法;电阻从0.1欧姆到100M欧姆;小电感从1nH到10mH。
栅介质:可以提取的等价栅氧厚度范围从不到10纳米到几百纳米;可以检测出的电介质玷污浓度从每平方厘米5e9个离子到约1e13个离子,界面阱范围从约1e10/cm2到1e13/cm2电荷左右(取决于器件结构)。现代仪器和探针台的超低电容测量功能能够测量更厚的叠层电介质。
MOS掺杂:可以提取MOSFET的掺杂分布情况,灵敏度范围从约1e14/cm3到1e18/cm3,掺杂深度从0.01μm到10μm。少数载流子寿命从1μs到10ms,可从C-V测量中测得10μs的寿命时间。
PN和肖特基结掺杂:可在0.1μm到100μm的深度范围内测出约1e13/cm3到1e18/cm3的二极管载流子浓度。
FET和BJT建模参数:除了测量器件和材料特性之外,C-V测试还可进行直接测量用于构建FET和BJT晶体管中的参数。
特别要注意很多因素都会影响这些参数提取范围,例如最大电压值、器件尺寸和栅氧厚度。幸运的是,有很多文献能帮助广大研究人员和工程师判断所需的测量范围是否与现在的C-V测量技术很好地匹配[4][5][6]。
连接与校正
尽管很多C-V测量技术本身相对简单,但是以一种能够确保测量质量的方式实现C-V测试仪与探针台的连接却不是那么简单。目前探针台使用的机械手和探针卡多种多样,当试图在一个探针台上同时支持I-V、C-V和脉冲式或超快I-V测量时,它们就会带来一些实际的问题。当进行I-V、C-V或超快I-V测量时,测量结果的质量与线缆的品质和所采用的探针台配置直接相关。
直流I-V测量最好采用低噪声同轴线缆和远程探测线。C-V测量需要使用具有远程探测线的同轴线缆,而且线缆长度要控制的非常精确。超快I-V测试需要50欧姆的同轴线缆,但是远程探测线却给超快I-V测试带来了阻抗失配的问题。射频C-V测量需要使用特殊的射频线缆和“地-信号-地”结构的探针以及校准基座。但不幸的是,这些接线方法与其它方法都不兼容。
通过吉时利实验室中的实验,我们选择了American Probe Technologies公司提供的探头配置(73系列或74系列)(如图4所示)。它的优势在于大多数探针台供货商都有供货。这种特制的探头是同轴的,带有一个开氏连接,其主体和屏蔽层都是浮空的,因此可用作I-V测量的驱动保护,或者通过跳接实现C-V和超快I-V测量的短接地路径。这类探针上的接头称为SSMC。
图4:American Probe Technologies的探头配置。
有三类线缆可用于实现与这类探针的高品质连接:SSMC到三轴线缆连接适用于直流I-V测量和一般性应用(直接或间接连接);SSMC到同轴线缆连接可用于C-V或超快I-V测试(间接连接);而更特殊的SSMC到SMA







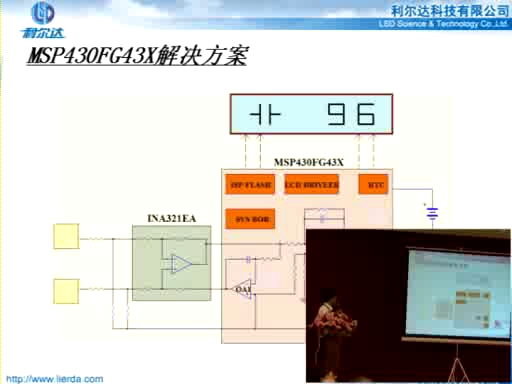


评论