用白光干涉测量法描述化学机械抛光面
化学机械抛光(CMP)在半导体工业内部得到了广泛的应用,化学机械抛光(CMP)加工处理的质量不仅要通过最终的表面平面度,而且也要通过抛光时人为造成缺陷的程度来评价,这些人为造成的缺陷包括:1)碟形凹陷和腐蚀的数量;2)线高变化的均匀性;3)缺陷、粒子的数量和残余物的总量。例如,碟形腐蚀的平面级别过高会导致在光刻成像的时候随焦距而决定的一个空间,因此,在高需求量中,测量工具能够刻画这些人为造成的缺陷特征。
许多方法,例如原子力显微镜方法(AFM)和铁笔轮廓曲线法曾被开发用来检查硅片表面质量,这些方法在一个选定的表面区域采集数据并继续通过侧面交叉扫描,虽然用高分辨率侧面扫描法能够获得三维形貌图,但用这种方法采集数据是非常耗时的。同样,对于生产监测应用这些仪器也是不适用的,此外,也必须考虑这些仪器的高度传感器尖端可能改变或损坏高质量表面的可能性。
在这里,我们介绍一种可供选择的基于白光干涉测量(WLI)原理之上的非接触光学测量方法,同样,如雷达(电波探测器)或垂直扫描干涉测量(法)被看作是一致的。白光干涉测量在光学领域中成为一种标准技术,比如拉模孔光洁度光学检查仪,干涉显微镜内部,照明光束被分离成一个参考面和一个测试波阵面,这些波阵面分别在参考面和测试面的远方光束反射后重组产生了一个干涉图,为了随后的分析一个被数字化表述的干涉图被送到计算机,完整数据的获得组成了曾被数字化后测试和参考波阵面之间光程差一样的规律顺序按线性变化的干涉图,图1示出了白光干涉测量法通常所用的典型的干涉显微镜。
 |
在白光照明下,来自干涉图顺序记录的每一个象素的强度分布图(或干涉信号)立即被建立起来,需要在象素下考虑,当测试和参考波阵面之间的光程差接近零时,可获得一个最大的干涉信号的对比,对比顶点光程差的偏移量,光程差OPD=0位置时是一个常量,这个常量取决于表面材料的特性,当光程差逐渐增大而信号逐渐丢失时信号对比度迅速地下降,照明的长度与光程差的区域比较一致,在图2中表述了一个典型的干涉测量信号与它的R(n)功能形成了明显的对照,注释了所有的检波器同时获得了象素数据。
 |
如果在一个给定的象素测试表面反射图像,然后那个给定的象素记录多个反射信号进行相比较,会得到更多的反射图像,对比每个信号的顶点组成可以看出不同时间的位置与它的相应表面的光程差(OPD)是有关系的,由材料特性引起的照明能量的变化和每个信号的大小对比应得的也是不同的,如果这些反射表面在光源长度一致之内,光路之间合成的反射信号将会交迭,一个典型的合成反射信号交迭呈现在图3中。
 |
在特定象素下考虑,干涉测量的相位是由测试面和参考波阵面之间相位的差异来支配的,测试波阵面的相位是受到影响的,在测试表面由于传播相位延迟和反射相移相对波阵面的相是有影响的,当传播相到达测试表面的高度时是有直接关系的,反射移相是由1)综合表面的实际(n)和假想的(k)组成的折射指数;2)多层堆叠层厚不等;3)表面层之内不同类型的层(例如,未定的显微结构)。
商业上广泛应用的频谱干涉仪通常具有在非接触条件下对表面区域进行测量的优势,由提取的相和干涉信号的位置进行最大限度的对比可以看出,干涉仪是能够以亚纳米精度来测量不透明的单一材料或相同一致表面的,由于探测器的所有象素反射相位的移动和光程差的偏移两者之前的对比高度是常量,所以这是可能的,这些常量对高度的偏移保持不变作出贡献,使其在测量表面形貌时不受影响。 对于不均匀的测试表面,例如,对一个电路图形的硅片进行CMP加工处理,反射相位的移动和光程差的偏移亮点的对比变化以图像位置与表面特性空间变化的结果主是一样的,而一个给定的干涉信号之内的对比记录毫无必要符合物体表面边界,结果,大家熟知的白光干涉测量技术是不能正确测量这些测试表面。
白光干涉测量仪在该领域未正式服役前介绍其固有的内在优势及使用方法,因为它扩展了自己的轮廓不均匀测试表面的实际应用能力。这种非接触方法能够适应高生产率和纳米精度对带有电路图形硅片的测量,这意味着它是研制开发和生产环境中CMP加工工艺过程匹配良好的监控器。在新的生产中具有适应大生产能力的新计量学仪器工具NamoXam。
2 原理
在白光干涉仪探测器图像象素中时间强度分布或干涉信号可表达为:
 |
式中,z是从焦点到反射点的距离;h是从焦点到反射镜的距离;k是波数,θ0是物镜数值孔径的表达或表达为NA=sinθ0;a(k,θ)是测量表面反射相和光谱调制相的移相结果,而F(k)是调制振幅,F(k)可表达为:
F(k)=R(k)Rg(k)=Rf(k) (2)
式中:Rg(k)是照明光谱功率强度,而R(k)是测量表面的反射系数振幅。
照明光谱功率强度Rg(k)包括光源的光谱分布状态,摄像头的光谱响应和干涉仪的光学特性,为了精确地描述来自干涉显微镜的时间强度分布状态,Rg(k)必须校准。
对一个测量表面的合成反射系数是由菲涅耳公式给出;
式中,Ni是入射媒质的折射指数;Nj是第二媒质的折射指数;R(k)是反射系数振幅;而φ(k)是反射系数相。
当光通过涂有一层透明薄膜层的表面时,合成反射系数变成:
 |
式中:θ是入射角,N0是入射媒质折射指数,而d和N1分别是薄膜的厚度和折射指数。
当光通过涂有多层透明薄膜层的表面时,合成发射系数可表达为:
式中:Ni是入射媒质的折射指数;Ns是基底的折射指数;
而A,B,C和D是由公式(7)定义:
 |
式中,βi=kNiIicoθi;而Pi=Nicosθi(假设为横向电场或TE偏振);Pi=Ni/cosθi(假设为横向磁场或TM偏振)。
角度θi是波向量和到薄膜表面法线之间的内角,Ni和li分别是折射指数和第i个薄膜的厚度,而n是透明薄膜层数,如果θi=0,方程(8)变为:
 |
一旦方程(3)、方程(4)和方程(6)建立,Rg(k)从校正和反射振幅R(k)、反射相φ(k)获得,从方程(1)和方程(2)来看,在探测器象素方面显示的强度分配与指定表面特性的是能够评估的,图4示出干涉显微镜摄像象素记录铜表面的时间强度分布状态与方程(1)相应的状态分布预测,图5示出在硅上附有3个薄膜层(厚度分别为66nm、27nm和100nm)时测试区域的时间强度分布状态,或者是多反射面和它的理论上预测的分布状态,在图4和图5中描述和记录的固体线条分布状态是由方程(1)产生的,"+"特性描述了来自测量抽取样本的强度值。
 |
由方程(1),产生一个时间信号与一个校准的照明功率密度谱,z向移动步长常数与测量表面的不同特性,例如,薄膜厚度和材料的折射指数,每个信号与测量获得的实际信号进行比较,一旦最匹配的理论信号被决定,表面特性效用适合于原型信号是我们渴望寻求的特性。
3 测量结果
下列测量结果是用我们的配有50X反射物镜系统所获得的,这个配置具有大约300μm300μm的观察视场,图6示出了一个全视场经过x和y向侧表面高度图指针位置的2个例子,灰度图像的亮度在表面高度上的每个象素都是成比例的,图像中的暗区由硅表面产生而亮区是在硅上早期提及的相应的多层结构,(分别为200nm厚的TEOS,50nm厚的SiN和500nm厚的PGS)。
 |
完成的附加测量法建立在被提议方法的有效性上,图7是一维侧面图,来自一个post-CMP硅片的腐蚀碟形之上扫描得到的高分辨率铁笔轮廓曲线图,图8呈现出按被提议方法放大的相应侧面缩小图。
 |
图9示出了Veeco AFS和我们的测量系统两者使用被提议的同一种测量方法,源自AFM轮廓的步高是97.55nm,这个结果与源自NanoXam测量系统的结果96.33nm是如此的一致。
 |
4 结论
论文介绍了已开发和推广的一种非接触表面图形绘制系统--Nano Xam及其测量方法,用这个系统获得的测量结果直接与(AFM)原子力显微分析法和其他精确的表面接触测量系统比较,这些比较证明测量表面梯形高度包括不一致材料特性之间的一种高级关系,最大优点还是能够提供对薄膜层厚度以下表面的充分评价,这一能力意味着在进行(CMP)化学机械抛光加工处理时人为造成的例如铜碟形腐蚀,能够用非接触光学表面形貌测量法以纳米级精度在测量区域上方迅速的描述。
 |
图10示出表面图形绘制系统和用该系统输出的晶圆片图形小部分上方的三维高度图的一个例子,高效率和非接触测量系统能够对复杂的合成表面进行精确的粗放的测量,意味着它对广阔而多样的测量应用拥有强大的潜能。







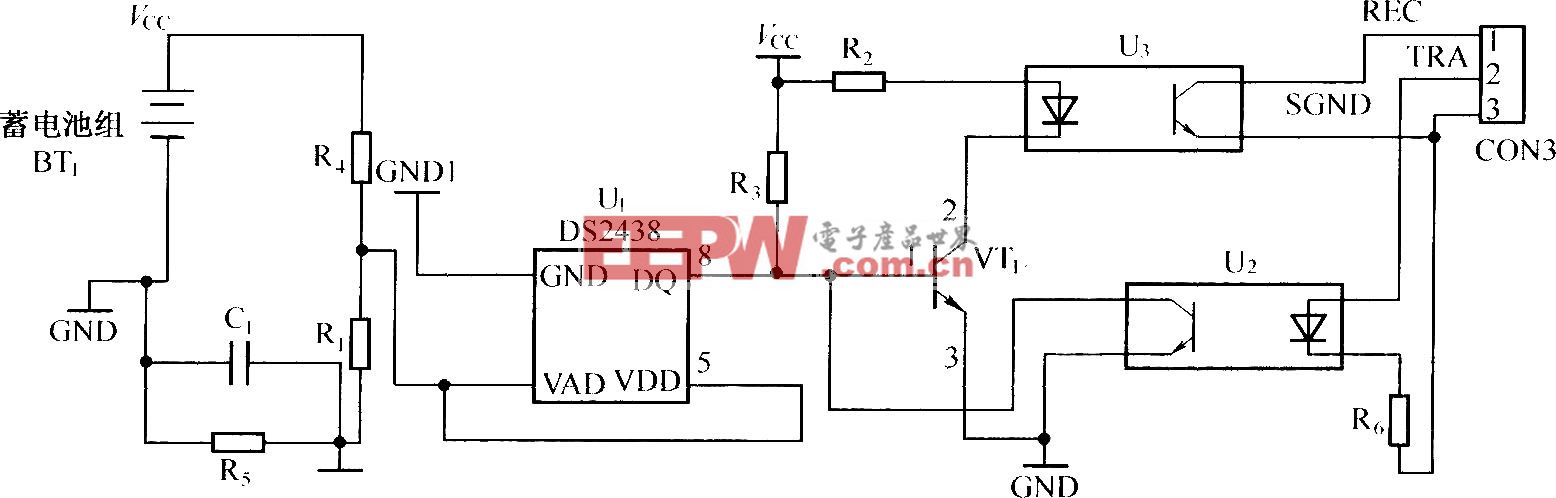



评论