高k介质中频率离散的原因
C-V测量是测定MOS器件特性的主要方法,它广泛地应用于半导体材料的研究中。C-V测量时常常在SiO2中观察到有害的频率离散。用于校正测量误差数据的一些分析公式和模型已得到充分研究。着重于消除串联电阻、氧化物漏电、氧化物与半导体间不希望有的损耗介电薄层、多晶硅耗尽层和表面粗糙度等等的影响。减少纳米级MOS器件中栅极漏电的迫切需求刺激了用高k电介质替代SiON的努力。但是,将高k电介质引入生产线将再次引起C-V测量曲线积累区处的频率离散。到目前为止,频率离散的准确来源仍有待讨论。
本文引用地址:http://www.eepw.com.cn/article/195776.htm本文研究了高k电介质堆层中频率离散的原因。特别提出了电介质介电常数(k值)的频率离散。为了确证单独k值相关影响,对高k电介质和硅衬底间损耗界面层的影响及串联电阻和硅金属背接触的重要性也充分地进行了讨论,并基于双频技术建模。根据实际测得的LaAlO3/SiO2、ZrO2/SiO2和LaxZr1-xO2/SiO2叠层电容值评估它们k值的频率相关性。
器件加工和实验过程
将高k电介质(LaAlO3、ZrO2和LaxZr1-xO2)淀积在n型Si(100)衬底上。高k薄膜和硅衬底间的界面层是~1nm的原始SiO2,由截面透射电子显微镜测得(没有示出)。用1100℃下干法氧化热生长的SiO2样品与高k叠层比较。MOS电容用Au栅热蒸发制造,有效面积为4.9x10-4cm2。所选Si晶圆的背面接触用HF缓冲溶液清洗,接着用热蒸发方法淀积200nm厚的Al膜以使串联电阻影响最小。然后,所有样品在合成气体中400℃退火30分钟,再在1k到1Mz频率范围内用HP4192阻抗分析仪测量。
实验结果和讨论
基于高k介质的典型C-V结果分别示于图1(a)和(b)。不管淀积方法、条件和材料如何,有时仍能得到频率离散。产生这一问题可能有三个因素:串联电阻影响,包括不完美的背接触;有损耗界面层的影响(~1nm原始SiO2);k值的频率相关影响。在讨论k值的频率相关影响前,必需充分研究串联电阻影响和有损耗界面层的影响。
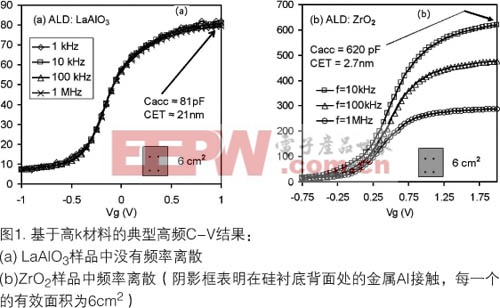
串联电阻影响(通常是由于硅体电阻和不完美的背接触)的重要性在热SiO2 MOS电容中得到最好的展示,其中体电介质与硅衬底间的损耗界面层的影响是可以忽略的。SiO2中频率离散只有在衬底有效面积小的样品中观察到,如图2(a)所示。此外,对于没有Al背接触的小样品,尽管测量条件是同一的,测得的结果也不再重复,如图2(b)所示(闭合的符号)。这就破坏了测量方法的可靠性。
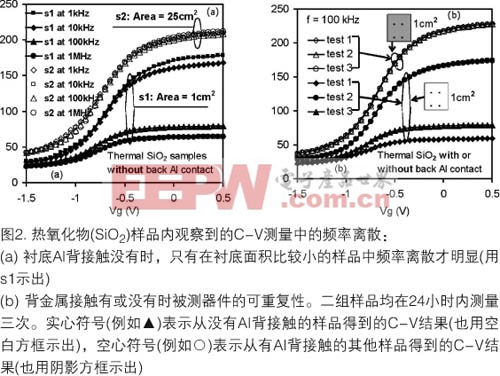
为了在任意测量时间和频率下对SiO2重建测得的C-V曲线,必须考虑可能由背接触不完美和硅串联电阻产生的“寄生”分量。然后对C-V曲线实施校正以得到它们的真实值。图3(a)是理想情况下的等效电路,可与实际测量模式比较,其中Cox代表SiO2栅介质的实际频率自主电容,Rs含有硅衬底的体电阻及不同接触电阻产生的量。背接触不完美也用电容Cp建模。CC、GC、Cm、Gm分别指已校正(没有“寄生”分量 Rs和Cp的影响)或测得的电容和电导。
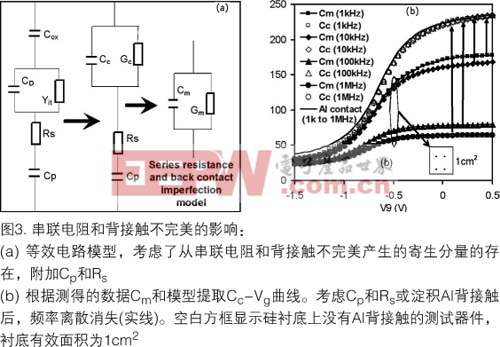




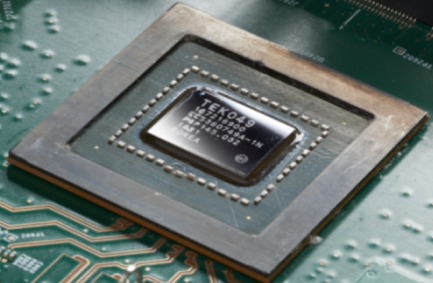





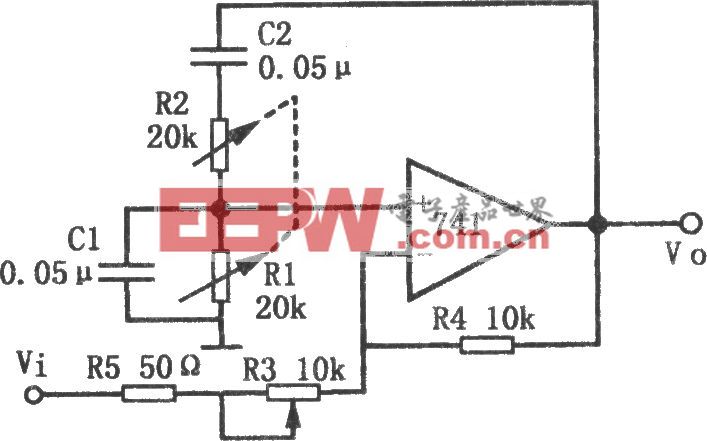


评论