陶瓷垂直贴装封装的焊接
CVMP封装的焊接
CVMP封装可以利用标准回流技术焊接。焊膏模板与封装尺寸一致。贴片后,根据规定的温度曲线加热电路板。
由于陶瓷封装的质量相对较大,建议采用图3所示的焊接温度曲线(根据JEDEC标准温度曲线修改)。

图3. 推荐的CVMP焊接温度曲线
关于垂直和水平安装方向的CVMP焊盘布局(焊盘图形),请参阅本应用笔记的焊盘布局部分。CVMP背面的焊盘布局如图7所示。注意,封装正面上有一些额外的焊盘(见图4)没有显示在焊盘布局中,这些焊盘用作测试点,不应进行电气连接。
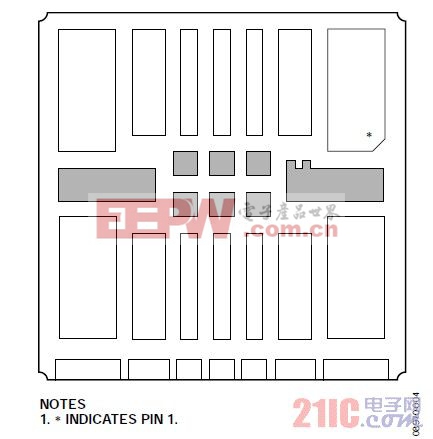
图4. CVMP的背面(灰色阴影部分为测试点,请勿对这些测试点进行电气连接)。
提高焊点可靠性
焊接工艺的有效性通过焊点可靠性来评估。焊点可靠性衡量焊点在一定时间内、在指定的工作条件下符合机械和电气要求的能力。机械振动、温度周期变化或过大电流可能会使焊点性能下降。
CVMP封装的嵌入式引脚可使封装与基板PCB形成直接机械耦合。与SOIC等其它封装不同,CVMP没有分离的引脚可用来释放应力,因此,焊点必须吸收更多的应力。
焊接完成后,由于焊料厚度有限,封装与PCB之间会有一个较窄的空间。已经证明,用底部填充材料填充此空间可以改善焊接抗疲劳寿命,因为它能减轻这种封装(引脚为嵌入式,不能用来释放应力)中焊点应力的影响。
底部填充材料是在回流焊之后填充到封装与PCB之间的空间(见图5)。它通常是以液体形式填充,其粘度非常低,可以流入较小的间隙中,然后在指定的温度下固化。这种材料的例子有Dexter的Hysol/FP4531和CooksON STaychip/3077.其它类型的底部填充材料是在贴片之前填充,其流动和固化符合标准回流焊温度曲线,因此无需额外的固化步骤。这种材料的例子有Cookson Staychip/2078E.
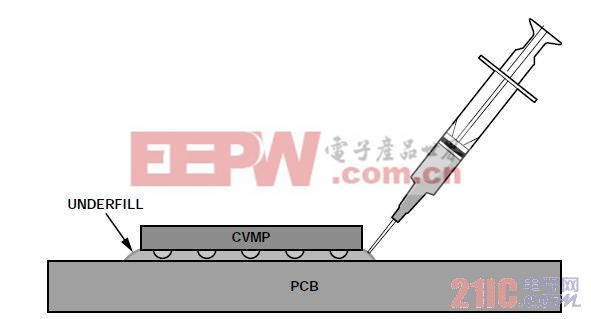
图5. 底部填充(可以是在回流焊之后以液体形式填充,或者在芯片贴装到PCB之前以膏体或固体形式涂敷填充)。








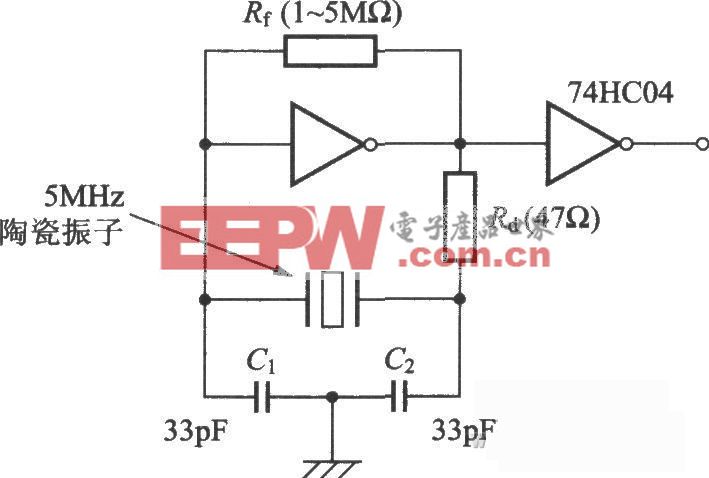


评论