解决微盲孔填充及通孔金属化的方法介绍
引言
本文引用地址:https://www.eepw.com.cn/article/189876.htm线路板在机加工之后的微、通孔板,孔壁裸露的电介质必须经过金属化和镀铜导电处理,毫无疑问,其目的是为了确保良好的导电性和稳定的性能,特别是在定期热应力处理后。
在印制线路板电介质的直接金属化概念中,ENVISION HDI工艺在高密度互连PCB的生产中被认为是高可靠性、高产量的环保工艺。
这项新工艺可使微盲孔填充及通孔金属化同步进行,使用普通的直流电源就具有优异的深镀能力。另外一些研究显示,CUPROSTAR CVF1不改变电源及镀槽设计的条件下仍能保证填盲孔,不影响通孔电镀的性能。
本文总结了CUPROSTAR CVF1最新研发结果、工艺的潜能以及对不同操作控制条件的兼容性,描述了微盲孔和通孔的物理特性和导电聚合体用于硬板和软板的直接金属化技术新的发展方向以及与CVF1电镀的兼容性。
半一站垂直浸入式工艺(表1),可利用现有的电镀设备(直流电源和可溶性阳极)进行微孔填铜。
常规的电镀液中含有活化剂和抑制剂(甚至还含有整平剂),CUPROSTAR CVF1的两种添加剂是分开的:预浸液中只含有活化剂,镀液中只含有抑制剂。各添加剂成份可用CVS定量分析,即使是在镀液老化后,添加剂分解造成的污染还是可维持在最低水平。
图1 简明表现了CVF1的电镀反应机理。通过预浸,PCB铜面浸附上活化剂分子。电镀过程中,板面铜层被氯化物和抑制剂分子共同抑制,迫使铜电镀只能在盲孔的底部及通孔的中部的低电流密度区进行。
在用高电流密度填充前先要用低电流密度(1.5-2.0A/dm2范围内,具体取决于微孔的直径大小)在较短的时间(15-30分钟)内在微孔底部镀上一层均匀的铜,在抑制剂的作用下,PCB工件表面电镀铜的厚度控制在较薄的范围内,整个填充电镀的时间为60-90分钟(具体取决于微孔的直径大小)。
众所周知,微孔的填充功效与槽液因添加剂分解而积聚的有机污染有密切关糸,通常情况下,一般填充电镀槽液在电镀 40-60 Ah/L 后,填充功效会下降,此时需过滤处理槽液(活性碳处理/UV 曝光处理),
表1 CUPROSTAR CVF1的流程步骤及操作控制参数
生产因此而停顿。CUPROSTAR CVF1 因其简单、独立的添加剂体系,槽液的工作寿命比一般的填充电镀槽液提高了3倍以上 (图3)。
通孔金属化效果与通孔内电镀液的交换有密切关系,电镀时必需有搅拌(图 4)。工作槽液的流动从只使用单一空气搅拌(中试线实验)的“缓和流动”发展到“强烈流动”(空气搅拌 + 喷射),其结果是不管纵横比如何,通孔金属化功效均可提高 20%。在客户生产线上,使用最佳的搅拌方式,同样可以得到同中试线一样的效果。
CUPROSTAR CVF1是因微盲孔的电镀填充需求而发展,不管怎样,未来工艺技术的发展方向是在无需改变化学添加剂及电镀设备(图5)的条件下,保持电镀及通孔金属化功效不受影响。
很显然,填充电镀铜前微盲孔和导通孔的 PTH 活化层和闪镀铜层的品质对填充效果有很大的影响,不良的化学铜活化层或不均匀的闪镀铜(图6)以及高纵横比深镀能力差的闪镀铜层都会导致填孔不完整,出现空洞。
CUPROSTAR CVF1 具有优异的深镀能力,可用于闪镀铜流程,填充电镀前在微盲孔和通孔孔镀上 4- 5 μm厚的均匀铜层是必需的(图7)。
不管怎样,如果化学铜沉积出了问题,则后续的闪镀铜的品质就无法接受。特别对于高纵横比的微孔来说,由于孔内溶液交换量的不足,先天不足的化学铜工艺已不能满足流程的需要,这就需要一种新工艺能在微孔壁均匀镀覆上一层镀铜导电层。
采用导电聚合物导电的直接金属化工艺则不存在诸如孔内溶液交换量必须足够的限制,由于无需孔内溶液交换就可以在微孔内壁介质上产生约 200 nm厚 的导电聚合膜(图8),此外,CUPROSTAR CVF1 与导电聚合体兼容,优秀的通孔金属化性能,可直接用于下一步的“闪镀铜及镀通孔”工艺中。
使用导电聚合体进行直接金属化
导电聚合体的本质是通过噻吩中的C-C双键连接结构来实现的。聚合体工艺是PEDT(EDT单体)的一种氧化聚合反应,在MnO2物的作用下,PEDT与聚苯乙烯磺酸(PSSA)结合形成不溶性的导电聚合物。具体反应机理请参看 J. Hupe High Reliable and Productive Metallisation Process for Blind Micro Via Applications (2)。
从化学反应机理来分析,介质表面必须先要有小量的MnO2存在,才能为聚合反应提供必须的“氧化能力”。众所周知,PEDT在聚酰亚胺基材上的导电性比在标准FR4和高Tg板材的导电性明显地低。
除了“在导电聚合体形成过程中无需体积交换”外,ENVISION HDI工艺步骤少、成本低、流程控制简单,仅只在介质层上形成聚合体。然而,在低聚体的形成中,因氧化副反应的存在,溶液的寿命大约限制在5-6天(或~5m2/L),具体取决于生产条件。
新一代稳定EDT溶液(ENVISION HDI CATALYST 7375)已问世,它通过减少不必要的低聚体的形成从而将工作液的寿命从5天延长至10天(图10)。除了延长工作液的寿命外,新的流程监控方法能够通过用 UV 仪测量吸收率(@870nm)来连续监控低聚体的形成。当催化剂老化时,吸收峰值增大,催化剂的老化程度与导电性能下降紧密相关。
如前文所述,在80-85℃的高锰酸盐的处理过程中,与标准的 FR4层压板相比,极少 MnO2吸附在聚酰亚胺上。新一带低温高锰酸盐引发剂已研发,操作温度在 50-60℃之间,特别适用于聚酰亚胺板(ENVISION HDI-Flex 7325)。尽管引发剂 7325主要用于 PI板,但也可以同样用于标准FR4层压板和高Tg层压板。
使用低温引发剂会使更多的MnO2吸附在聚酰亚胺板基材上,可以大大增强后工序生成的PEDT聚合体的导电性。与FR4相比,虽然聚酰亚胺上的MnO2量只有FR4上的25%,但同样可以确保在通风的环境里储存36天后仍有优异的导电性。
有关新型改良导电聚合体工艺和软板用的低温引发剂更详细介绍请参阅参考文献3《导电聚合体与电介质层金属化》。
案例分析:CUPROSTAR CVF1与ENVISION HDI-Flex
我们用多层聚酰亚胺基材证实新研发的引发剂和改良的催化剂优异的性能,经过 ENVISION HDI工艺后,层压板用 CUPROSTAR CVF1镀液镀铜。
直流微孔填充电镀的深镀能力很好,亦可用于闪镀铜。电镀铜层保持板材不均匀的轮廓(图11),不均匀的轮廓缘于 PI多层板内层间存在粘合剂(由客户供应的品质决定)。
闪镀铜后,在含有抑制剂的镀液中(包括预浸)同时进行填孔和镀通孔。无论孔的表面形态如何,都可以100%填孔和通孔金属化(6个点测试法),通孔也可以获得均匀的铜层。按照Auger 分析,选择性地在孔壁电介质上形成的聚合体被证实在通过3次漂锡热冲击测试(测试温度为260℃) 后,内层连接性能仍很优异。
结论
CUPROSTAR CVF1 微、盲孔填充电镀工艺适用传统可溶性阳极垂直电镀线,具有优异的填孔效率和深镀能力。在镀液流动性优良的情况下,纵横比6:1 的通孔深镀能力可达到100%。
在不改变镀槽设备和基本化学品的情况下,CUPROSTAR CVF1仍能保持对微通孔有卓越的深镀能力。
此外,CUPROSTAR CVF1 通孔金属化性能卓着,在介质层金属化后可闪镀铜形成薄的化学铜层。



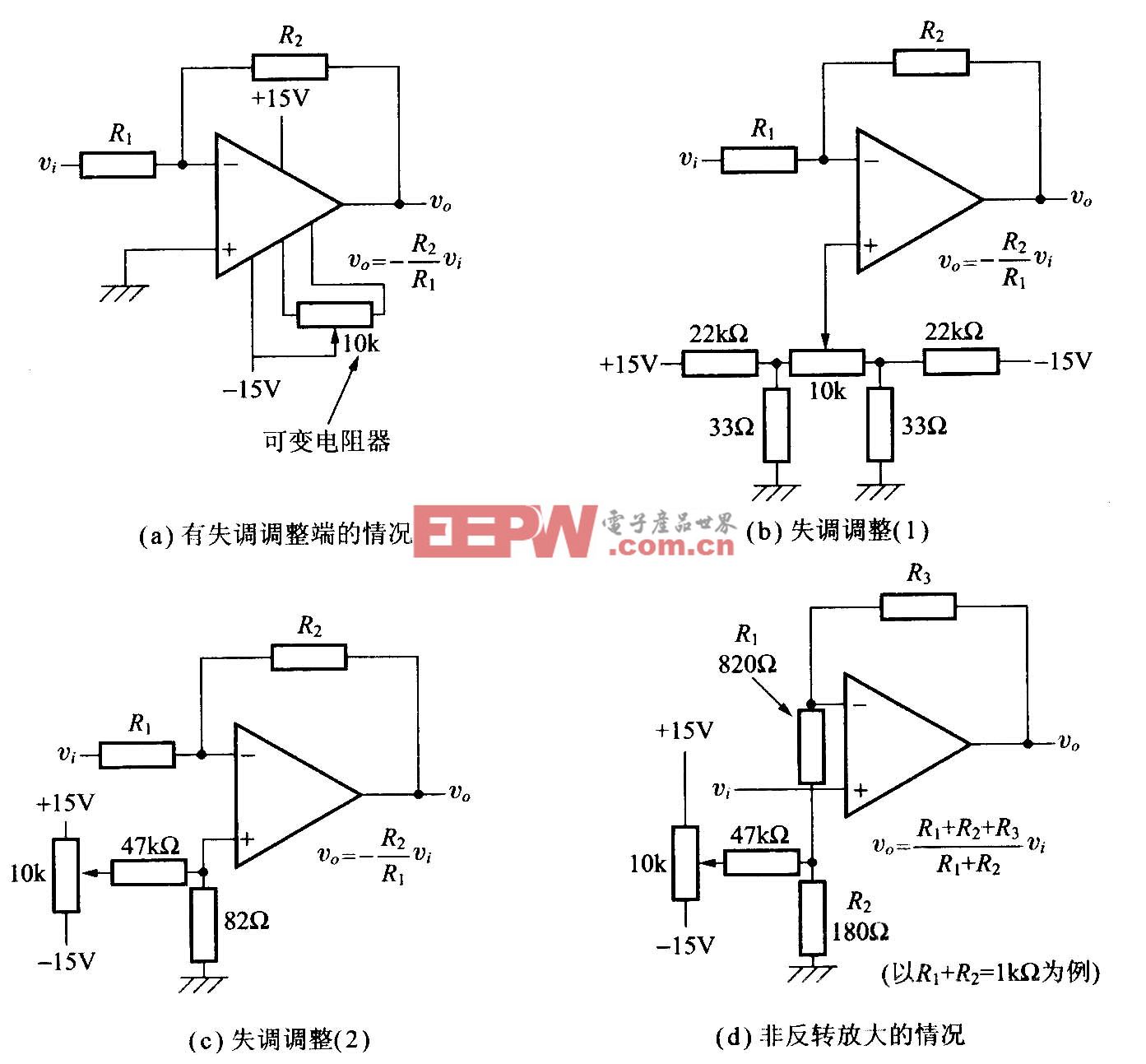





评论