SiP:面向系统集成封装技术
——
集成电路的发展在一定程度上可概括为一个集成化的过程。近年来发展迅速的SiP技术利用成熟的封装工艺集成多种元器件为系统,与SoC互补,能够实现混合集成,设计灵活、周期短、成本低。
多年来,集成化主要表现在器件内CMOS晶体管的数量,比如存储器。随着电子设备复杂程度的不断增加和市场需求的迅速变化,设备制造商面临的集成难度越来越大,开始采用模块化的硬件开发,相应地在IC上实现多功能集成的需求开始变得突出。SoC在这个发展方向上走出了第一步。但受到半导体制造工艺的限制,SoC集成的覆盖面有固定的范围。随着网络与通信技术的普及,物理层前端硬件(模拟系统)是多数系统中必要的组成,以SoC实现这类系统的单芯片集成有明显困难。
封装载体与组装工艺
是构成SiP技术要素
构成SiP技术的要素是封装载体与组装工艺。前者包括PCB,LTCC,Silicon Submount(其本身也可以是一块IC)。后者包括传统封装工艺(Wirebond和Flip Chip)和SMT设备。无源器件是SiP的一个重要组成部分,其中一些可以与载体集成为一体(Embedded,MCM-D等),另一些(精度高、Q值高、数值高的电感、电容等)通过SMT组装在载体上。SiP的主流封装形式是BGA。就目前的技术状况看,SiP本身没有特殊的工艺或材料。这并不是说具备传统先进封装技术就掌握了SiP技术。由于SiP的产业模式不再是单一的代工,模块划分和电路设计是另外的重要因素。模块划分是指从电子设备中分离出一块功能,既便于后续的整机集成又便于SiP封装。电路设计要考虑模块内部的细节、模块与外部的关系、信号的完整性(延迟、分布、噪声等)。随着模块复杂度的增加和工作频率(时钟频率或载波频率)的提高,系统设计的难度会不断增加,导致产品开发的多次反复和费用的上升,除设计经验外,系统性能的数值仿真必须参与设计过程。
优化系统性能
提高集成度
与在印刷电路板上进行系统集成相比,SiP能最大限度地优化系统性能、避免重复封装、缩短开发周期、降低成本、提高集成度。对比SoC,SiP具有灵活度高、集成度高、设计周期短、开发成本低、容易进入等特点。SiP将打破目前集成电路的产业格局,改变封装仅仅是一个后道加工厂的状况。未来集成电路产业中会出现一批结合设计能力与封装工艺的实体,掌握有自己品牌的产品和利润。目前全世界封装的产值只占集成电路总值的10%,当SiP技术被封装企业掌握后,产业格局就要开始调整,封装业的产值将会出现一个跳跃式的提高,这是我国发展有自主知识产权的先进封装技术的良好时机。
SiP技术优势在无线通信中充分显露
SiP技术可以应用到信息产业的各个领域,但目前研究和应用最具特色的是在无线通信中的物理层电路。商用射频芯片很难以用硅平面工艺实现,使得SoC技术能实现的集成度相对较低,性能难以满足要求。同时由于物理层电路工作频率高,各种匹配与滤波网络含有大量无源器件,SiP的技术优势就在这些方面充分显示出来。目前SiP技术尚属初级阶段,虽有大量产品采用了SiP技术,其封装的技术含量不高,系统的构成与在PCB上的系统集成相似,无非是采用了未经封装的芯片通过COB技术与无源器件组合在一起,系统内的多数无源器件并没有集成到载体内,而是采用SMT分立器件。
在SiP这一名词普及之前就已经出现了多种单一封装体内集成的产品,历史原因造成了这些产品至今还没有贴上SiP的标签。最早出现的模块是手机中的功率放大器,这类模块中可集成多频功放、功率控制、及收发转换开关等功能。另外三维多芯片的存储模块,逻辑电路与存储电路的集成也处于这种情况。
集成度较高的是Bluetooth和802.11(b/g/a)。Philips公司的BGB202 Bluetooth SiP模块除了天线之外,包含了基带处理器和所有的物理层电路,其中一部分滤波电路就是用薄膜工艺实现的(但不是在SiP的载体中,而是以一个分立的无源芯片形式出现的)。整个模块的外围尺寸是7mm







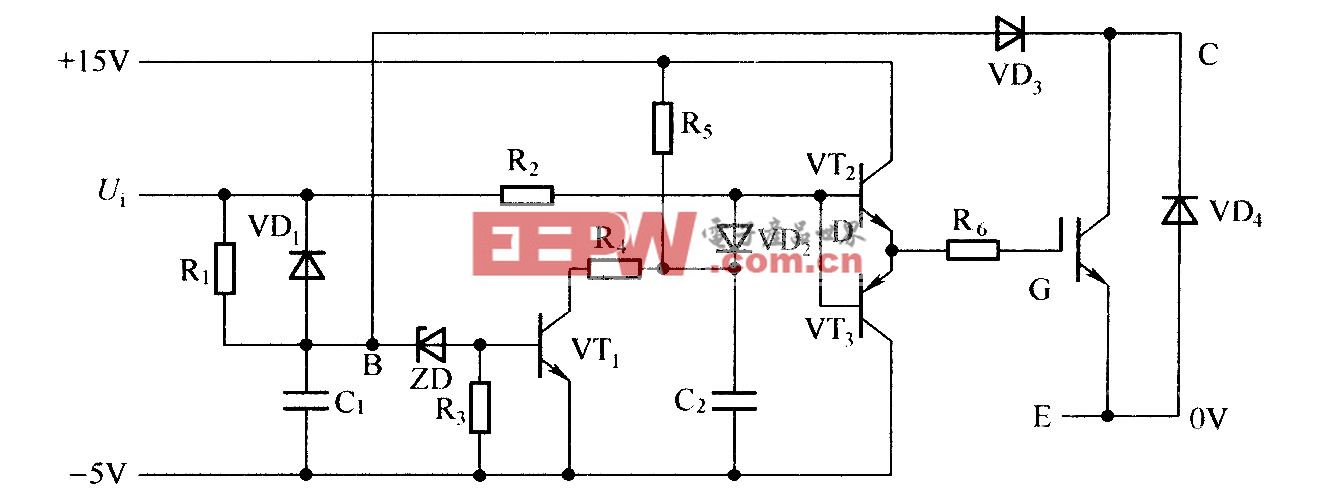
评论