用于通用照明的大电流密度的高电压交/直流LED芯片
(4)2010年11月,美国GE公司开发出采用喷射技术的冷却方法,特别适用于大功率灯具。
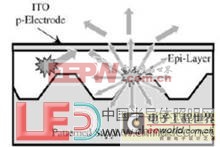
图1:Nichia的正大电流密度芯片的截面图
2010年9月,一直以开发和生产小芯片著称的日亚(Nichia)公司宣布:在实验室中,1x1mm2正装结构的大电流密度LED芯片,在1000mA电流驱动时,效率达到135lm/W(4700k)。(摘自“中国半导体照明网”)
Nichia的正装结构的大电流LED芯片的主要的特征是:优化外延层设计、改进电学设计去降低电压、采用图形蓝宝石生长衬底、采用低电阻和高透光率的ITO(电阻是7欧姆,透光率大于90%),见图1。
对于以蓝宝石为衬底的正装大电流密度LED芯片,对于封装的散热性能要求更高。
另外,在向芯片输入大电流时,需要防止电流从打线焊盘直接向下经过ITO层流向发光层。
2、垂直结构的大电流密度的LED芯片
2010年3月,科锐(Cree)推出大电流密度的直流LED芯片产品:XLamp-XP-G,在1500mA电流驱动下,得到460lm的光通量,相当于4个Cree的XLampXR-E(摘自“中国半导体照明网”)。

在向芯片输入大电流时,需要防止电流从打线焊盘直接流向N-GaN外延层,造成局部电流拥塞。解决方法的专利技术之一是,打线焊盘形成在绝缘层上,见图2。
2010年4月,Osram推出大电流密度的直流LED芯片产品:UX-3,在3000mA电流驱动时得到830lm,见图3(摘自“中国半导体照明网”)。
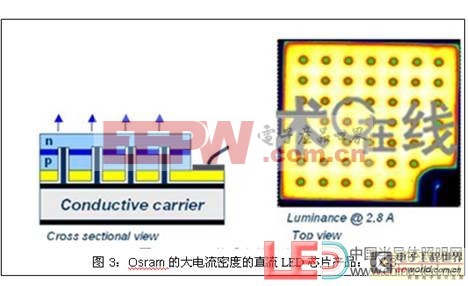
Osram按照在大电流密度时效率下降的俄歇复合的理论设计外延层结构,由于俄歇复合的发生概率与载流子密度的3次方成比例,因此,降低载流子密度的话,便可减少俄歇复合的发生,通过加厚活性层,降低了载流子密度。活性层并非简单加厚,而是对掺杂量等进行了优化。另外,其芯片结构的设计与Lumileds的芯片基本相同:多个通孔中的导电栓把n型限制层与导电支持衬底电连接;这种结构使得电压均匀加到p型限制层,消除了电流密度局部较高的部分。不同之处在于,其p型限制层通过金线与外界电源电连接。
2010年11月,Cree推出型号为XLamp-XM-L的2x2mm2芯片,在3A电流驱动下,亮度达到1000lm。
3、3维垂直结构的直流LED器件
2010年7月,Lumileds推出大电流密度的直流LED器件LUXEONRebelES,在1000mA电流下,可提供300流明以上的光通输出,而光效可达100流明/瓦,见图4(摘自“中国半导体照明网”)。Lumileds按照制造工艺(倒装)和物理外形(薄膜),将其称为倒装薄膜。如果按照电流是否垂直(或接近垂直)流过p-GaN来定义,可称其为垂直结构,由于无需打金线,称其为3维垂直结构器件。
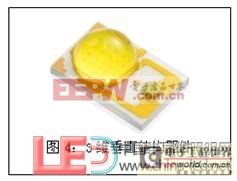
其他的3维垂直结构芯片和器件的结构包括:
(a)QFN类型的3维垂直结构器件(图5)

图5:QFN类型的3维垂直结构器件
剥离了生长衬底的LED薄膜的p型限制层键合在金属上(称为p金属),n型限制层通过电极与另一金属(称为n金属)电连接,p金属和n金属的另一面分别与外界电源相连接,成为SMD器件。其优势之一是小于1℃/W的热阻。因此特别适用于大电流密度驱动,解决了芯片和封装的散热。
(b)通孔支持衬底类型的3维垂直结构器件(图6)
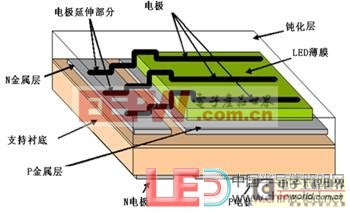
图6:通孔支持衬底类型的3维垂直结构器件
剥离了生长衬底的LED薄膜的p型限制层键合在金属层上(称为p金属层),n型限制层通过电极与另一金属层(称为n金属层)电连接,p金属层和n金属层通过支持衬底中的通孔与支持衬底的另一面上的金属层(分别称为p电极和n电极)形成电连接,成为SMD器件。当采用散热较好的支持衬底时,解决了芯片和封装的散热。
(c)通孔3维垂直结构LED芯片
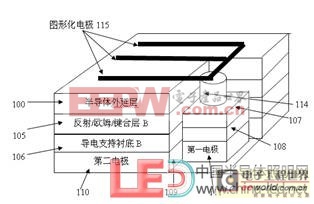
图7:通孔3维垂直结构LED芯片
其结构如图7所示,半导体外延层的第一类型限制层上的图形化电极通过外延层中的通孔与第一电极形成电连接,半导体外延层的第二类型限制层键合在第二导电支持衬底(例如铜合金)上,从而与第二电极形成电连接,形成无需打金线的SMD型式的垂直结构芯片。当采用散热较好的导电支持衬底时,解决了芯片的散热。
(二)高电压的直流LED芯片
1、正装结构的高电压LED芯片
把一个芯片的外延层分割成数个芯片单元,并把它们串联起来,则构成高电压芯片。
2008年,晶元提出制造高电压直流芯片的方法(图8),2010年6月,晶元推出正装结构的高电压直流芯片,其中红光芯片HF27A的电压为34伏,效率达到128lm/W。白光达到135lm/W(5000k)。

图8:高电压芯片的串联的多个正装结构芯片单元
高电压直流芯片的结构如下:一个芯片包括多个正装结构的芯片单元,芯片单元之间通过电极形成串联形式的电连接。如图8所示,一个芯片单元的N电极与相邻的芯片单元的P电极形成串联。一个芯片上的所有芯片单元形成串联的电连接,则构成一个正装结构的高电压直流LED芯片。一个芯片上的芯片单元形成数个串联的电连接,再形成整流桥式电连接,则构成一个正装结构的高电压交流LED芯片。
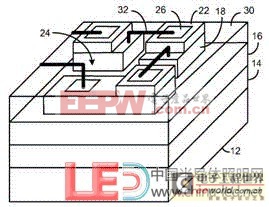
图9:高电压芯片的串联的多个正装结构芯片单元
2008年,Lumileds提出的高电压直流芯片的结构,如图9所示。一个芯片上的所有芯片单元形成串联的电连接,则构成一个正装结构的高电压直流LED芯片。一个芯片上的芯片单元形成数个串联的电连接,再形成整流桥式电连接,则构成一个正装结构的高电压交流LED芯片。据报道,Lumileds的高电压直流LED芯片的效率超过100lm/W。
对于蓝宝石衬底的GaN基芯片,由于蓝宝石散热较差,限制了驱动电流密度。

2010年11月,亚威朗光电(中国)提出45V高电压正装结构LED芯片样品(见图10)。
2、倒装结构的高电压LED芯片

2010年10月,晶科提出倒装结构的高电压LED芯片样品(见图11),其优势是散热较好。
(三)高电压和大电流密度的直流LED芯片
垂直结构LED芯片采用了散热较好的支持衬底,散热优良,适于采用大电流密度驱动。据此,垂直结构和三维垂直结构的高电压芯片被提出。
1、垂直结构的高电压大电流密度LED芯片
2009年Cree提出垂直结构的高压LED芯片。2010年10月,Cree推出2款高电压芯片(1)XLampMX-6S:电压20V,在60mA驱动时,得到139lm,其驱动电流密度相当于35A/cm2;(2)XLampMX-3S:电压11V,在115mA驱动时,得到122lm。

图12:大电流密度的垂直结构高电压芯片
一款适用于大电流密度的垂直结构的高电压芯片的结构如图12所示,数个LED外延层薄膜110a和110b分别键合在互相绝缘的金属膜102b和102c上,电极107b把外延层110a和110b串联,形成高电压芯片。采用导热优良的支持衬底101a。与Cree的芯片的区别在于,打线焊盘不在芯片单元上,因此,可以采用较大电流密度驱动,而不会在打线焊盘附近形成电流拥塞。
2、3维垂直结构的高电压大电流密度LED芯片
垂直结构的高电压芯片的支持衬底采用通孔导电支持衬底,则形成3维垂直结构的高电压大电流密度LED芯片。在导热优良的支持衬底中的金属栓把形成在支持衬底两面的金属膜电连接,形成SMD型式的无需打线的高电压大电流芯片。其优势在于,散热优良,无需打金线,适宜采用大电流密度驱动。
三、交流LED芯片
(一)正装结构的交流LED














评论