铜在电力电子中的广泛应用
前言
对于功率半导体器件来说,硅是最常见的元素,然而由于铜的高导电性,对于印刷电路板(PCB)和陶瓷基板上的基板来说,铜是最佳选择。由于铜的导热率,所以铜成为基板和散热底板最常用的材料。而且,铜对于功率器件的金属化和互连来说非常重要。日益增加的能量密度、载流能力和可靠性要求也是铜在本行业中广泛使用的原因。铜具有以下优点:易于获得、相对便宜,且供应稳定。
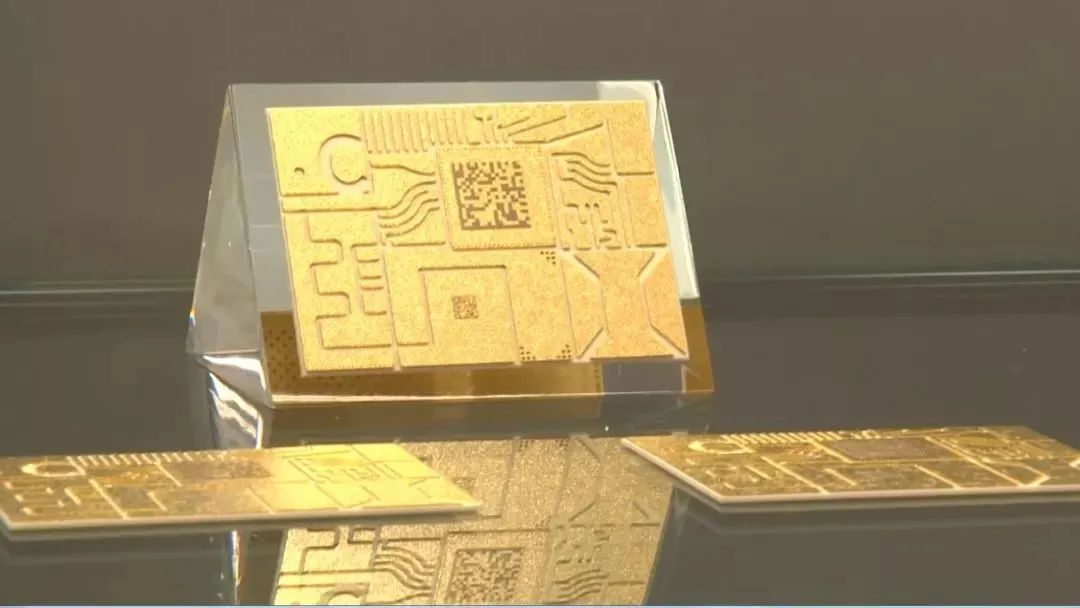
铜和铝的比较
根据具体应用,铝是铜的最佳替代品。例如,在散热底板中,铝与铜相比,更便宜、更轻,所以铝是首选材料。但是,对于导热率比减重更重要的某些应用,铜是更理想的材料。在室温条件下,铜的导热率为400 W/m-K,而铝的导热率为235 W/m-K。因此,在所有其它因素相同的条件下,铜制散热底板的散热效果优于铝制散热底板。所以,许多带有集成铜扰流柱散热底板的功率模块目前已被市场认可,并成功用于混合动力和电动车辆领域。
铝和铝合金被广泛用于芯片金属化。它们的电阻较低,且在硅和氧化硅层上有良好粘附性。尽管如此,由于铜具有更好的导热及导流能力,芯片领域已经引入铜金属化技术来代替铝金属化。电阻率较低能使单位面积的电流较高,且单位电流发热量较少,而且较高的导热率能更有效地散热。这两个明显优点使铜的电流更高、紧凑化效果更好。不足的是,在干法蚀刻工艺中,铜不像铝一样易于蚀刻化。所以,不是所有芯片都使用铜金属化处理。而且,由于成本和应力问题,铜金属化厚度只能在5 μm 和10 μm之间,不过层厚越大越能保障更大的电流驱动能力、更高的热容量和散热能力。虽然,可能有一些变通方案,如丹佛斯公司利用其键合缓冲技术,将一个薄铜箔熔结到芯片顶部。
将铜用于标准芯片金属化处理的另一个驱动因素是可靠性。在最先进的功率模块中发生的故障的主要原因是键合线脱落。因此,已经研发了将多个芯片互连接入功率模块的新方案,以代替传统铝线。许多方案依赖于不同形状和几何结构的铜材料:铜线、铜带、铜柱、铜快接或铜框架,这些可以锡焊、烧结或焊接到芯片上。其它方案包括平面互连和芯片嵌入技术,在这些技术中,顶部电极触点通过铜通孔连接起来。
重铜不再足够厚重
尽管某些基板仍采用铝金属化处理,PCB内外层导线和陶瓷基板主要使用铜。
铜厚度可以规定为以盎司为单位的每平方英尺的铜重量(oz/ft²)。市场上最常见的PCB是为低功率应用生产制造的,其铜导线用重量不小于0.5 oz/ft² (18 µm)且不超过3 oz/ft² (105 µm)铜制成的。对于大功率应用,厚实的铜电路可以用重量在4 oz/ft² (140 µm)和 20 oz/ft² (686 µm)之间的铜制作。铜重量也可以超过20 oz/ft²,这种铜被称为极度铜。
尤其是,直接键合铜(DBC)和活性金属钎焊(AMB)基板被用于将多个功率器件并联安装到一个模块上,以实现规定应用要求的额定功率。可以获得铜厚度127 µm到800 µm的这种基板。但是,功率模块也确实有微型化趋势。因此,模块制造商日益增加对半导体和封装技术的要求,以便进一步提高现有或更小元器件封装的输出功率。而且,因为性能提高不应影响成本和可靠性,所以基板和底板或散热底板必须用新的连接技术,或最好集成到一个组件中。因此最终促使铜层厚度超过1mm的基板的研发。
通常,厚铜层利用和标准铜层一样的湿法化学蚀刻工艺生产制作。因为其各向同性的特征,湿法化学蚀刻不适合制作厚铜层,否则会造成导线之间有较大沟槽,而客户需要较窄沟槽,以减少模块封装尺寸。因此,必须研发专门的构建技术,来实现小间隙、直侧壁和可忽略不计的底部内切。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。