机会与变数
机会与变数
经历了几年的低谷期,终于迎来了电子行业的复苏。问题是,这几年的衰退带给我们什么经验教训呢?这些经验教训会使我们聪明起来吗?瑞得电子集团的资深编辑和研究人员为了帮助业界人士更好的了解电子行业的走势,帮助经营人员把握商机,分别对市场、芯片设计、制成、测试、封装,以及资源整合趋势等焦点话题进行了深入的分析。我们在这里精炼出这些研究和分析的精华,以飨读者。
消费者大量购买采用复杂 IC 的电子装置会推动技术向着复苏;支持复苏的趋势是音乐、语音、视频所有数据类型,包括数字化、以及这些不同类型数据在网络和终端设备上的“融合”。
消费者拉动(pull)信息流增长,而网络和通信市场作为推动(push)一方,也终于开始前行。希望这是技术经济可持续发展的一个开端。
在有线通信领域,基础设施建设有了长足的进步,传输速率大大增长。2003 年, 10-Gbit/秒的以太网(10GE)进入数据中心、存储网络以及城域网。从历史来看,当芯片制造商能以三倍的价格提供速度为前一代以太网10倍的芯片之际,就是新一代更快的以太网开始占据市场之时。富士通公司去年夏天推出了一个 12 端口的 10GE 单片交换机。以前的 10GE 交换机是板级模块,价格在 2 万美元左右,系统价格则高达 25 万美元;而富士通的芯片价格只有 200 美元,整体系统的价格也不超过 5000美元。
新的高速传输技术走进数据中心,前一代传输技术就会进入台式机领域甚至家庭。目前,客户机正在向千兆以太网转移。所有的新型英特尔主板都带有一个千兆网卡接口。六个月以后,桌面的 10/100M 的以太网设备将走到其生命周期的尽头。
无线网络业在 2003 年的发展势头强劲,802.11(Wi-Fi)无线局域网更是成为热门。手机芯片厂商和运营商都在设法支持 Wi-Fi 与手机网络之间的互连互通。用不了多久,所有的智能手机和连网 PDA 都将支持 Wi-Fi 和手机数据连接,Wi-Fi 将成为永久在线连接的一种选择。
DVD 、PVR、等消费电子近来销售势头良好,而数码摄像机也跌入 200 美元以内。所有这些产品都对网络带宽和数据存储容量有更庞大的需求。特别值得一提的是,内容拥有者通过网络提供数字媒体内容,也成为拉动电子消费的主力军。
技术融合 前景不明(Bill Schweber,EDN 的执行编辑)
过去几年,市场饱和、最终用户购买疲软,人们期待出现能让消费者有购买欲望的产品。而家庭电子设备的“融合”(即“数字家庭”)可能带来这样的商机。融合谈了多年,但是由于内容、成本、支付能力、等问题,以及技术兼容、标准不统一等各种因素影响了其应用。现在,业界不同领域的技术聚集在一起,可能会使梦想得以实现。其中关键的技术是 DVD、CD、PC、多媒体软硬件、数字音频、大屏幕、电视、互联网、宽带接入,以及更好的电缆机顶盒等等。把这些技术联系在一起的是高速无线连接,既802.11x 技术的应用。当然,在家庭联网时可以使用以太网,但以太网要面临布线、接入点固定以及基础设施投入的问题。
现在还不十分清楚这种“融合”能给最终用户带来什么。很多有关新技术和相关产品为什么和何时被大众市场接受以及接受程度的研究表明,新产品必须能提供确实有用并且易用的功能。而目前围绕标准与易用性方面仍有一些技术难题,费用/效果比仍不明朗,家庭影院还不是即插即用式的,尽管它正在朝这个方向努力。
“融合”潮流也将重组供应商,即常说的 OEM。“融合”产品所用 IC 的复杂性和定制特性意味着需要越来越高的产量来分摊这些器件的设计、开发和配置的成本。与此同时,多数这类元器件更加专用化 。这显示出业界的下一个趋势:从通用器件进一步转向更专用的器件。这对有晶圆厂和无晶圆厂的公司都将产生深远的影响。
这种“融合”还有其它意义。像戴尔这样依靠供应链和制造专业知识而成长的公司,在产品规格制定和开发方面不具备优势。但在“融合”的世界里,没有一套像 Wintel 架构那样的标准占统治地位,而是可以用不同的软、硬件方法来实现一个给定的标准。因此如果一个公司不能设定和推行标准,而只靠低制造成本打拼,它的日子会很难过。那些有自己研发机构以及相应的制造部门的公司将会在标准的制定方面更具发言权,其它公司很难取代其专家地位。制定主要“融合”标准的大型IC 供应商们都有紧密的技术与产品开发联盟,包括系统厂商和标准持有者。他们密切合作,建立标准、时间表和限制规则。当然,戴尔模式也有成功的可能,因为消费者已经习惯于降价,而且低档产品的性能与可靠性并不亚于高价产品。只是低档产品有的缺少某些附带功能,但大多数人并不想知道这些功能的用途,更别说用它们或为其买单了。
这种“融合”还对品牌的营销带来挑战。降低价格的持续压力是否会使厂家感到维护品牌没有意义?随着高技术产品越来越快地成为日常商品,消费者是否会接受任何品牌的产品?如果几乎所有的消费产品都在中国的一家工厂制造,甚至都是基于一个公共参考设计而进行的,那么品牌的意义到底是什么呢?
或许,应用试试采用“剃须刀与刀片策略”——硬件只是一个诱饵,剃须刀厂商主要靠不断交换的刀片挣钱。OEM 厂家不再重放产品的研发设计,而或为产品规格的制定人和营销人。也许惠普就是看清了未来趋势,所以几个月前隆重地推出了一百种新的消费产品,包括照相机、扫描仪、PDA 以及照片打印机等,而戴尔也已经推出了大屏幕电视,指望靠提供服务、刺激消费赚钱。
对工程设计界的冲击现在还难以判断。以前工程师们是用一组通用元件设计出不同的产品。而今天的工程师要为一种大批量、灵活性有限的应用去选择(或设计)IC。这实际上是将全部信心寄托于设计工程师和 IC 供应商,设计出的部件必须真正满足系统级和订制式的规格要求,并且运行良好,然后由市场去产生订单。而对工程师来说,将某一片热门IC应用在A设计中的技能对B设计可能完全没有用。这使设计工程师更像一个高级的 IC 积木装配工,只是用专用软件把它们粘到一起。
EDA市场 低速增长(Gabe Moretti,EDN技术编辑)
EDA在 2004 年将有小而稳定的增长。半导体工业是 EDA 行业增长的主要推动力量。消费者对照相彩屏手机之类无线设备的需求为增长提供了动力。同时,PC 和消费电子供应商也在降低价格以吸引消费者的购买力。
上市的 EDA 公司的投资者们都获得了不错的收益。Magma 设计自动化公司的股票价格翻了一番多,Mentor Graphics 和 Synplicity 的股票也涨了 50% 以上。但是,测试平台和相关的工具市场相对疲软。
从技术层面说,可以使设计者用较低的开发成本设计ASIC器件的“结构化ASIC”概念在2003 年开始流行,但是其代价是要放弃在器件上各单元布局与布线的一些自由度。结构化ASIC可以用来提高产量,减少设计者要完成的分析与验证工作量,其结果是器件每单位区域中含有的晶体管数量少于全定制 ASIC。结构化ASIC器件是 EDA工业发生转变的显著标志之一,2003年在业界激起了小小波澜, 2004 年将成为主流。随着制造工艺进入 0.13 微米以下水平,原来在 0.18 微米工艺中居于次要地位的物理效应现在上升到首位。逻辑设计师们发现原来学习的东西已经不能解决这些问题了。工程师们必须在功能开发阶段就考虑最终器件的拓扑结构。
更复杂的是,最终产品的物理特性还会影响到产量,尤其是那些含有模拟电路的器件。万幸的是,如果工程师掌握了 0.13 微米设计的复杂性,那么 90 纳米工艺结点的设计只是在原有基础上收缩,而不是一个全新的过程。
用于 FPGA 开发的 EDA 工具价格还需要大幅上升,因为现在开发 FPGA 产品几乎同开发一片 ASIC 一样困难。目前FPGA 供应商还在为客户提供低价入门级工具,而 EDA 公司则以较高价格但性能更好的工具进入这一市场。
对 FPGA 供应商而言,现在是考虑退出 EDA 市场的时候了。由于需要解决的问题日益复杂,开发支持产品软件的成本愈加昂贵。多数情况下,FPGA 供应商为EDA做的努力是赔钱的,而且客户还要为购买的每一块芯片付软件开发费用,即使他们根本不用这些软件工具。FPGA 供应商必须清楚,客户是根据 FPGA 器件自身的价值来选购,而不是因为有便宜的软件才来购买。
2004 年可望增长的另一个市场领域是模拟工具、混合信号工具、射频工具以及能提高产量的工具。如果没有外部因素干扰的话,所有上述这些因素结合,将使全行业保持一个适度的增长,速度大概为 2%-3%。
制成技术 进入新的时代(Peter Singer, Semiconductor International主编)
分析家预测,2004 年所有半导体市场领域都有显著的增长,整个市场可望增长 19.4%,达到约 1950 亿。引领这一增长的将是 DVD 消费市场(增长30%)、服务器市场(15%)、个人电脑(11%),数码相机(14%),以及手机(10%)。目标市场是多样性的,而非10年前只有PC一枝独秀。
当然,半导体业也面临着诸多挑战。除了技术挑战以外,还要应付一些经济问题,如生产能力、器件价格、晶圆厂的高昂建厂成本(一个先进的晶圆厂投资要 60 亿美元),以及投资回报率(ROI)等。半导体行业的发展仍然遵循摩尔定律,但有些人已经开始置疑这种做法是否有经济意义。转向新的技术工艺需要巨额的研发与设备投资,但却几乎没有时间获得这些投资的回报。
业界从 200 毫米晶圆向 300 毫米晶圆的过渡使产能可以提高两倍,而设备和工厂的投资增加不多。这样就可以显著地节约成本,每片晶圆大约能节省 30%。所以投资于 300 毫米晶圆厂成为一种趋势。现在全球约有 20 多家晶圆厂在用 300毫米晶圆生产器件,另有 15 家正在计划建设。到 2010 年时,预计所有半导体制造能力的 20% 是由 300 毫米晶圆完成的。2005年时,40% 的 300 毫米晶圆厂将建在台湾。
从技术角度看,最令人瞩目的进展就是近来由摩托罗拉研发人员宣布的新型分裂栅(split-gate)鳍式场效应晶体管(fin-FET)。它将栅分割成两个部分可以单独施加偏压,从根本上改变了空闲状态下晶体管的阈值电压。晶体管从原来的三脚器件变成了四脚器件,但由于省去了其它晶体管,因此设计的复杂度是降低了。
在半导体工业中,最大的进步几乎都来自新型材料。业界已广泛地用铜代替铝作为片上互连材料。研究人员正在使用应变硅、SiGe 层、绝缘硅(SOI),甚至混合基材等方法来提高芯片性能。金属栅(可能与一个高 k 值门电介质结合)也是受到广泛研究的主题。分立元件的集成也是半导体工业中的一个重要研究领域。未来的芯片将可能使用光、电信号进行通信。
测试市场 机会多多(Martin Rowe,Test&Measurement World高级技术编辑)
一般来说,测试设备市场要滞后半导体市场一年左右。何时测试设备行业才会看到成长?什么样的技术能刺激对新测试设备的需求,从而推动这种成长呢?
2004 年的测试设备市场应当会重新振作起来,但不会重复上个世纪 90 年代中后期电信与互联网繁荣期时的“杀手级应用”。取而代之的将是多种化产品对更多测试设备的需求。机械式产品的不断电子化使得测试设备市场进一步发展,而且新技术会驱使市场采用更快、更精密的测试设备。
消费电子产品、计算机和其它无线设备也将促进这一进程,同样还有白色家电。所有这些产品都需要电子测试设备去验证其工作状态。
无线设备是另一种推动测试需求的产品。无线局域网的应用范围已经超出了办公室网络的范畴,手机包括了许多附加的功能,因此需要更多的集成电路,以分别完成模拟和数字功能。这些系统芯片的应用为测试业展现出了新的挑战和机会。频率测量与射频测量现在被提前到了制造过程的前期。
军用电子市场和安全产品市场、企业计算的升级换代为测试业带来新的机会。PCI Express、串行 ATA 以及其它使用串行数据流的总线都需要专用的测试设备,因为它们对测试提出了许多新的挑战。高速串行总线的引入,也使工程师们需要诸如高带宽示波器、误码率测试仪、波形发生器、抖动分析仪、协议分析仪以及时域反射计等仪器等新的测试设备。
随着复苏的进展,未利用的测试能力将会减少。总而言之2004 年将比 2003 年更好。
创新封装 复苏秘诀(Greg Reed,Semiconductor International执行编辑)
后端半导体制造经过两年的低落迎来了复苏。在衰退期开发的新的封装技术成为行业复苏先锋。相对于前端晶圆制造,半导体封装经常不为众人注目,然而却在 2003 年后半年上演了一出“灰姑娘”的好戏——几乎所有半导体厂下半年的封装与测试业务都超过了预期。
成功的部分原因归功于业界在最凄凉的两年里对研发的专注投入。进入2004 年景气回升时,新技术和新工艺的开发立刻显示出其重要性。
半导体封装业的最佳创新,要数对现有技术的不断精雕细琢。传统的封装供应商在完善那些久经考验的技术方面具有卓越的表现。
这些企业意识到,诸如SOIC、TSOP、QFP、PLCC等许多封装形式已经不能支持最新的小体积、多功能的便携产品。即使在BGA、CSP、FC等先进的封装形式出现以后,很多现有封装也采用了新的材料,并对其产品采用最新的设计、装配和测试。
另一个创新是三维或堆叠式封装(以及堆叠式内核),主要用于增长迅速的小体积、多功能便携式应用。尽管三维封装超出了单片 BGA、CSP 和 FC 封装的范畴,但仍能从 BGA 和 CSP 设备及工艺过程获得益处。通过将已有的架构与最新的晶圆薄化技术(可以显著降低芯片内核的厚度)相结合,三维封装可以在一个结构里提供 2、3、4 甚至更多层的堆叠封装,而外形尺寸与原来的单内核封装相差无几。
多芯片封装(MCP)是半导体封装领域另一种创新方法。无线应用中高性能、低功耗、空间紧凑等要求,促进了 MCP 的产生。MCP 将使用倒装芯片、卷带自动接合(TAB)或打线互连方法,可以在传统尺寸的高密度基板上包含多个裸核心。
MCP 技术的进一步发展就是系统封装(SiP)。SiP 可以在传统阵列封装大小的廉价基板上封装几个裸芯片,并且可以使用现有设备进行组装。在集成异种元件方面,SiP 提供了最大的灵活性,可以在一个成本适当的组合中装进不同尺寸的芯片、无源器件、天线、屏蔽以及滤波器等。
最具创新性的当属晶圆级封装(WLP)。WLP为半导体制造的前、后端提供了一个技术桥梁。与传统封装形式相比,WLP可以节省大量的劳动,提高产量。WLP封装尺寸最小,由于连接较短而具有更好的电气性能,取消了不必要的工艺步骤,还有利于更有效地使用测试资源。因为市场急需更小、性能更强的便携产品,半导体封装厂都对 WLP 感兴趣,并且在付诸行动。随着 WLP 的发展,我们将看到半导体晶圆加工业与封装业之间进一步的整合。
还有两个趋势必须提到:推动无铅封装发展的力量仍然很强;越来越多有关制造业和基础设备向中国转移。全球的半导体封装厂商都希望能服务于中国不断增长的消费市场,从而获得可观的回报。
半导体业 资源重组(Ed Sperling,Electronic News主编)
2001 年开始的衰退使电子业各方“势力” 开始转移,出现了一些新的势力集团,一些集团的地位得以巩固,同时也为业界巨头的争斗搭好舞台。正在进行中的势力转移使某些公司的影响力极大地增长。这些转移已远不止局限于公司的范畴,甚至涉及不同地理位置以及整个行业。
以无晶圆厂(fabless)市场为例。长期以来一直被Intel 和 TI 这些工业设计公司(IDM)视为弃儿的这部分市场,已经形成一个具有自己特点的势力集团。
代工厂已经占据该领域的中心地位,控制着最佳 EDA 设计工作流程,验证不同种类的知识产权(IP)芯核,有时甚至开发自己的 IP。而且随着晶圆厂投资攀升至几十亿美元,代工厂也获得了越来越多的加工业务。简言之,晶圆厂的影响力远不止芯片生产这么简单。
台积电(TSMC)已经膨胀为一个市场巨兽。去年夏天,台积电建立了一个基于 Cadence 和 Synopsys 设计系统的设计工作流程,飞利浦半导体也向台积电进行了巨额投资。而IBM 也与其伙伴 Chartered 半导体一起悄悄进入代工领域。IBM既是 IDM 又是代工厂。与 Chartered 半导体的交易是为了给所有IBM产品提供第二个生产资源。
IBM 技术集团的首席技术官 Bernie Meyerson 说:“IDM的优势是它有远光灯。这使我们能看到五至十年以后的情况。如果看到五年后有条沟,我们可以小心地退回来,然后飞越过去。如果只能看到一年后的远景,意味着你想踩刹车的时候已经撞上墙了”
Cypress 半导体公司的总裁兼 CEO TJ Rodgers也认为在缺乏工艺控制以及相关创新的情况下,代工厂和无晶圆公司要想跟上IDM的脚步就要付出艰苦的努力。而且他也表示,在极其复杂的行业里,创新是生存之根本。创新的需求以及开发成本的上升都迫使许多公司进行协同设计。
协同现象并不仅限于代工厂业务。飞利浦、摩托罗拉和意法半导体联合在法国 Crolles 建立了一个 300 毫米晶圆厂,以开发下一代 90 纳米以下工艺的 CMOS 技术,目的就是分担开发成本。中国政府也在极力促成这种联合,地方政府通过提供补贴、培训以及税收优惠来建立设计公司。当大多数的注意力被中国的增长和市场机会所吸引时,韩国和台湾则在复杂设计方面取得了显著的进步。与此同时,台湾则向原始设计制造商(ODM)模式发展。
分销市场销量就是权力。销售量越高,对供应商的影响力就越大。有影响力的可以直接销售,而缺乏影响力的只好依赖全球分销商。这些巨头能向全球输送巨量的货物,因此比中国那些采用低库存、低批量、快周转模式的企业更具优势。
(插入块)
1、消费者拉动(pull)信息流增长,而网络和通信市场作为推动(push)一方,也终于开始前行。
2、“融合”产品所用 IC 的复杂性和定制特性意味着需要越来越高的产量来分摊这些器件的设计、开发和配置的成本。
3、除了技术挑战以外,半导体业还要应付一些诸如生产能力、器件价格、晶圆厂的高昂建厂成本以及投资回报率等经济问题。
4、创新的需求以及开发成本的上升都迫使许多公司进行协同设计。





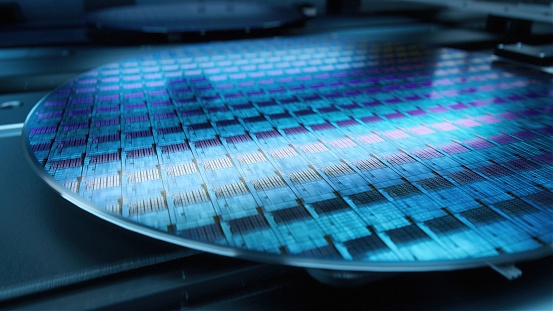
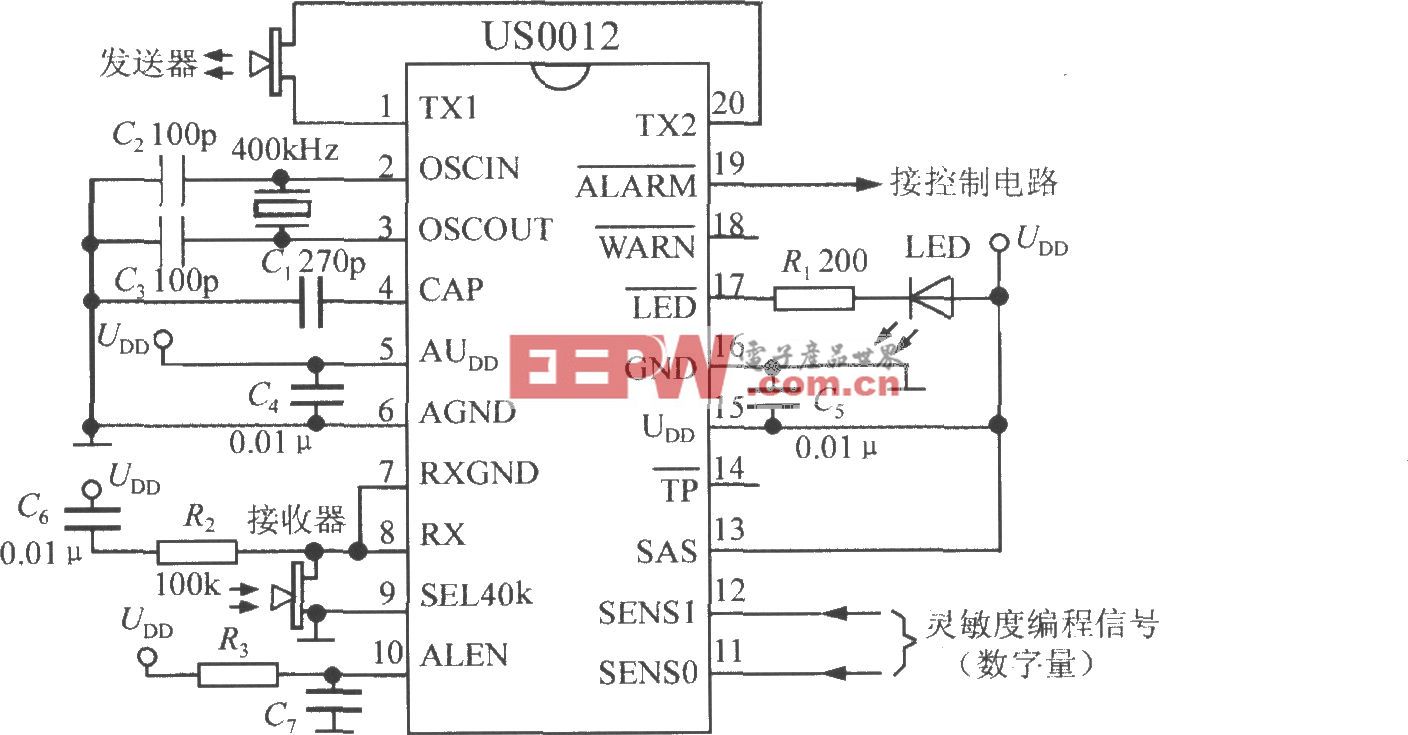
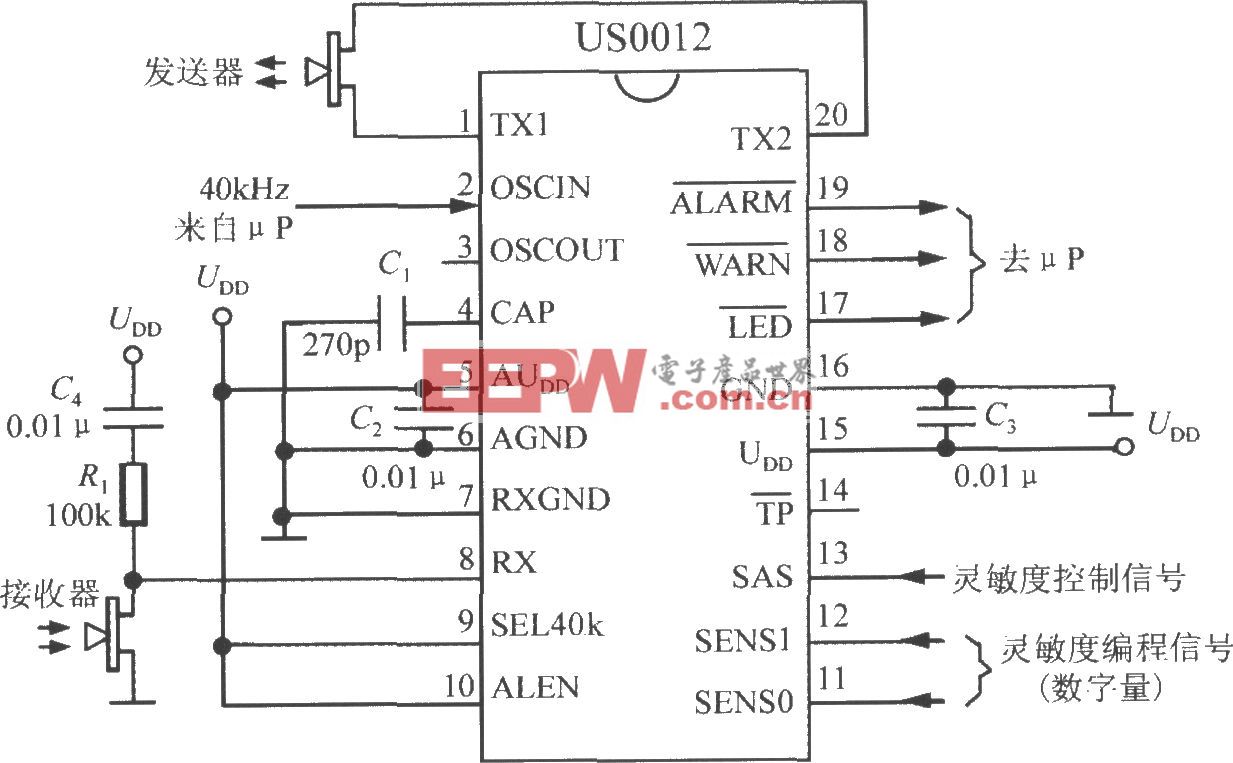




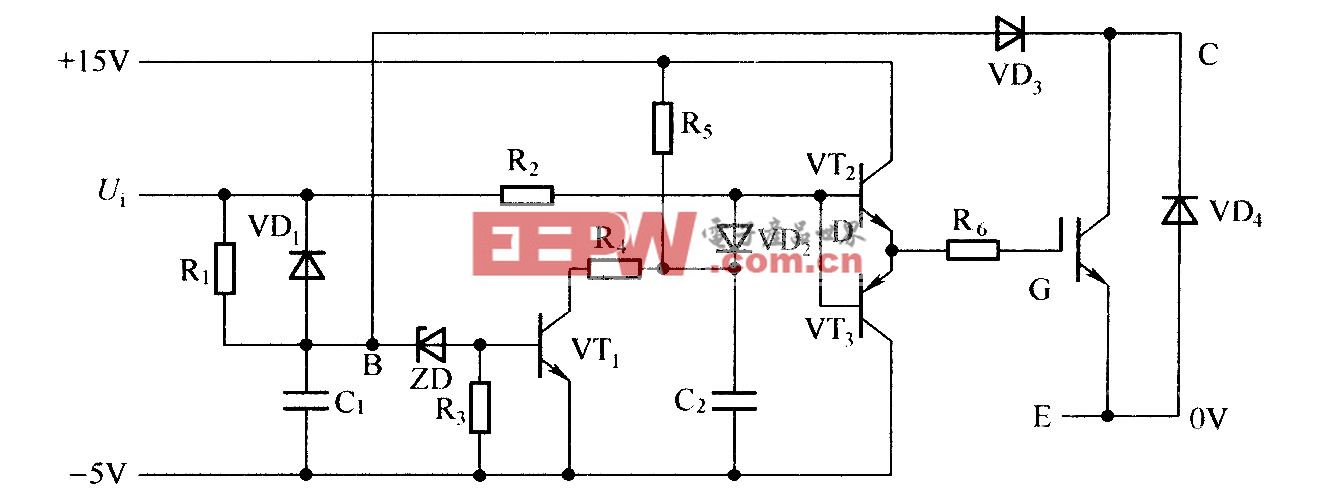
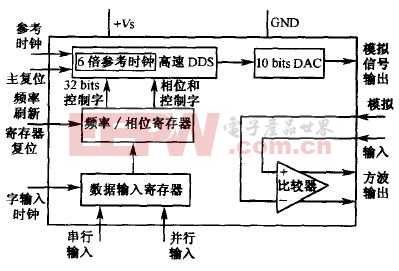

评论