新一代层叠封装(PoP)的发展趋势及翘曲控制
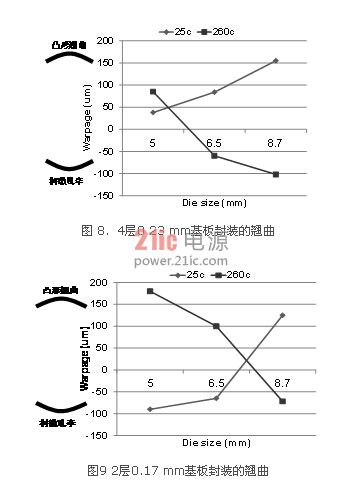
从图中数据我们可以得出一些很重要的结论:
封装超薄化后,翘曲对芯片大小非常敏感。不同尺寸的芯片封装后翘曲相差非常大,甚至翘曲的方向都会改变,例如图8中在回流温度260℃时的翘曲,当芯片为5 mm时翘曲方向是凸形正90μm(正值),而芯片为8.7 mm时翘曲变成了凹形负100μm(负值)。
对于大芯片(8.7 mm),超薄化后的封装翘曲非常大,超过了一般要求的翘曲水平(100μm以下)。所以,大芯片超薄封装的翘曲极具挑战性。另一方面,也不是说芯片越小翘曲就会越小,如设计或材料选择搭配不当,小芯片封装会比大芯片封装的翘曲更大。例如图9中所示,5 mm芯片比6.5 mm及8.7 mm芯片的翘曲都大。原因是不同大小的芯片翘曲方向有可能不同。
通常所说的采用低CTE的基板和高CTE的塑封组合有利于降低翘曲,是针对封装大芯片时当翘曲方向在室温下是凸形而高温下是凹形时才成立。而当使用小芯片时,翘曲方向有可能反过来,此时上述观点将不再成立,而必须使用高CTE的基板配低CTE的塑封组合,才能降低翘曲。
图中数据显示,同一套材料组合及设计很难适用于各种不同大小的芯片。
综上所述,新一代超薄封装将会使翘曲大小和方向出现各种可能,而且相当敏感,难以只凭经验预估。所以,必须定制优化,并在设计时使用相关的计算机有限元翘曲模型模拟仿真,以帮助预估最后封装的翘曲及改善的方案例如各层厚度和材料的选择搭配。
5 基板薄化对翘曲的影响
在基板设计时,可选择采用不同的层数和厚度。除了对基板电性能的考虑之外,这些因素对封装的翘曲也有影响。图10显示了使用4层板和2层板的封装在翘曲上的差别。对大芯片封装而言,使用4层基板的封装翘曲比2层基板的会更大。这是因为4层基板含更多的金属层和绝缘层,这些材料具有相当高的CTE,从而使得4层基板的整个基板有效CTE值要比2层基板的大,翘曲也就相应增大。相对而言,基板层数越多,或者基板核越薄,基板核所起的作用就越小,翘曲就会加大。以此类推,采用最新出现的无核基板(Coreless Substrate)的封装翘曲将会是更大的挑战。

基板变薄后带来的另一个问题是基板设计公差的影响增大。传统基板使用很厚的核,核在整个基板的机械性能上起主导作用,所以设计公差的影响并不明显。但当基板变薄后,核的主导作用变弱,各层厚度的设计公差所带来的成品基板差异就不能再忽略了。图11显示了一例基板设计时公差控制的影响。第一组数据采用标准设计共差,结果封装的翘曲在回流高温时为96μm,超过客户指标(90μm)。第二组数据为改进版,对基板各层厚度的公差做了进一步控制,尤其是金属层(信号层)。结果这一组的翘曲得到改善,降低了12μm,达到了客户指标要求。这说明当基板变薄后必须加强对公差的控制,同时,当封装产品开发已进入最后阶段,其它各种参数都已定型的情况下,也还有可能通过对基板各层的厚度公差进行优化控制,以进一步改善翘曲,达到客户指标。

基于类似的原因,我们发现,基板变薄后,不同基板厂商生产流程控制差异所造成的成品基板差异也变得更加明显,必须加以更严格的控制[6]。尤其是在现代的商业模式下,同一基板总是从几家不同供应商进货。图12显示了一例同一设计但来自不同供应商的基板对最后封装翘曲的影响。数据表明,使用三个供应商的基板进行封装的翘曲都不同,相差达20μm。其中供应商B和C的基板封装的翘曲最后都超标。而即使是同一供应商A,不同的生产流程控制也会造成翘曲差异。

进一步研究造成基板差异的根源,我们也测量了这些基板在封装之前裸基板每个单元本身的翘曲。图 13 显示的是来自不同供应商的裸基板在封装之前其自身的翘曲比较。可以看出,基板薄化后,不再像传统的厚基板那样平整,裸基板本身就会产生很大的翘曲(可达100-200μm),而且翘曲随不同的供应商,不同的生产流程控制而不同。另一个发现是,裸基板本身的翘曲可随不同的基板核材料而呈现完全不同的状态。
裸基板本身的翘曲除了会影响最后封装的翘曲之外,还会影响封装过程的可制造性(manufacturability)。例如在芯片倒装过程中,如果裸基板的翘曲过大,会使芯片倒装无法实施。
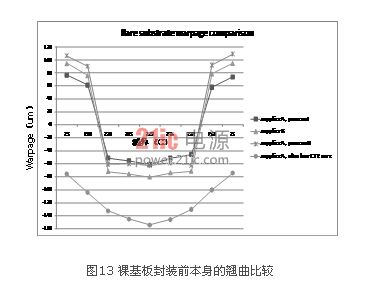
封装薄化之后,基板对设计公差及供应商生产流程的差异都变得更加敏感。因此,必须采用更严格的公差控制和供应链的控制,才能更好地控制最后封装的翘曲。
6 超薄裸芯片的翘曲
芯片本身也在不断薄化,从100μm降至80μm,60μm,甚至50μm以下,而芯片本身的翘曲问题也开始出现。图14显示的是一颗厚度为50μm ,大小为8 mm×8 mm的裸芯片在不同温度下的翘曲。图中数据表明50μm厚的芯片本身的翘曲可以由室温下的正50μm (凸形)变为高温260℃下的负40μm (凹形),这种程度的翘曲还是很显著的。需要说明的是,芯片本身的翘曲也会因不同的设计和制造过程而不同,不能一概而论。
超薄芯片本身的翘曲主要是由于硅晶和随后一层一层的低k电路(low k layer, BEOL)之间不同的热膨胀系数引起的。当芯片厚时,由于硅晶的钢性很高,不易变形,但当芯片很薄时,钢性显著降低,翘曲也随之显著增大。
芯片本身的翘曲会增加组装过程中的困难,及芯片倒装过程的良率,也会对最后整个封装的翘曲产生影响。
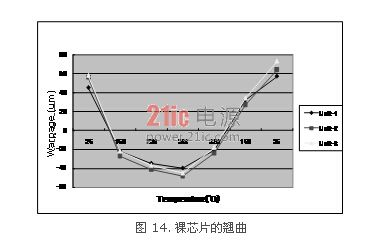
本文论述了新一代叠层封装(PoP)的发展趋势。主要表现在芯片/封装比增大,倒装芯片及铜柱技术的应用,上下封装层互连间距缩小,以及封装超薄化。为此新的PoP技术例如穿塑孔TMV等因应而生,新一代超低CTE基板和超高CTE塑封材料等也开发迅猛,以降低因超薄化引起的封装翘曲。文章进一步讨论了封装翘曲这个已成为阻碍新一代PoP发展的瓶颈问题和面临的挑战。基于收集的生产实验数据,可以得出如下结论:
超薄化后的封装翘曲对芯片尺寸大小相当敏感。
封装的各层厚度设计以及封装材料的选取必须根据不同应用,不同芯片的大小进行定制优化,采用不同的组合才能控制好翘曲。很难再使用传统的同一材料配置适用于不同产品设计的开发模式。
超薄化后基板的设计公差以及不同供应商的生产流程差异对封装翘曲的影响变得更加显著,因此有必要采取更严格的公差控制以及供应链的控制。
芯片超薄化后也会使裸芯片本身出现显著的翘曲问题。




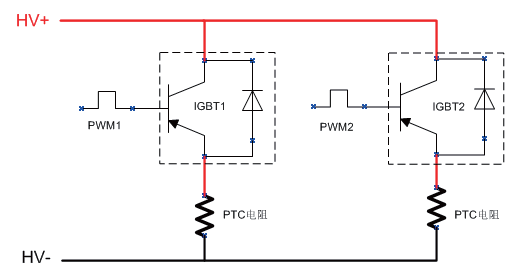




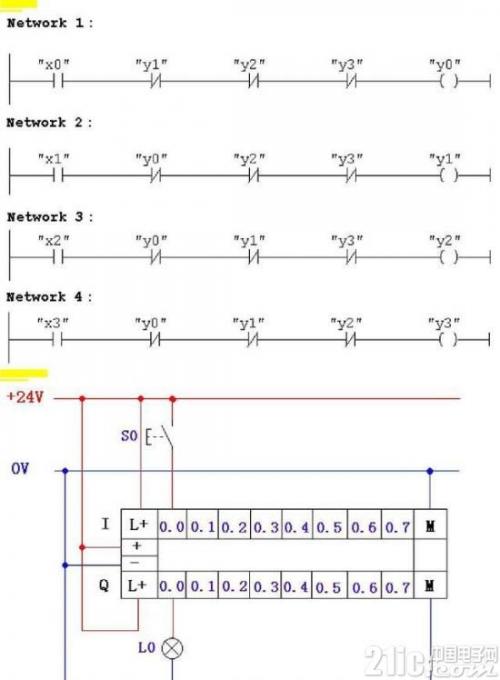










评论