详解TSV(硅通孔技术)封装技术
硅通孔技术(Through Silicon Via, TSV)技术是一项高密度封装技术,正在逐渐取代目前工艺比较成熟的引线键合技术,被认为是第四代封装技术。TSV技术通过铜、钨、多晶硅等导电物质的填充,实现硅通孔的垂直电气互连。硅通孔技术可以通过垂直互连减小互联长度,减小信号延迟,降低电容/电感,实现芯片间的低功耗,高速通讯,增加宽带和实现器件集成的小型化。基于TSV技术的3D封装主要有以下几个方面优势:
本文引用地址:https://www.eepw.com.cn/article/201710/366252.htm1)更好的电气互连性能,
2)更宽的带宽,
3)更高的互连密度,
4)更低的功耗,
5)更小的尺寸,
6)更轻的质量。

图1 未来TSV封装器件示意图
TSV工艺主要包括深硅刻蚀形成微孔,绝缘层/阻挡层/种子层的沉积,深孔填充,化学机械抛光,减薄、pad的制备及再分布线制备等工艺技术。主要工艺包括几个部分:
(1)通孔的形成;
(2)绝缘层、阻挡层和种子层的淀积;
(3)铜的填充(电镀)、去除和再分布引线(RDL)电镀;
(4)晶圆减薄;
(5)晶圆/芯片对准、键合与切片。
TSV深孔的填充技术是3D集成的关键技术,也是难度较大的一个环节,TSV填充效果直接关系到集成技术的可靠性和良率等问题,而高的可靠性和良率对于3D TSV 堆叠集成实用化是至关重要的。另外一个方面为在基片减薄过程中保持良好的完整性,避免裂纹扩展是TSV工艺过程中的另一个难点。目前主要的技术难点分为几个方面:
(1)通孔的刻蚀——激光刻蚀、深反应离子刻蚀;
(2)通孔的填充——材料(多晶硅、铜、钨和高分子导体等)和技术(电镀、化学气相沉积、高分子涂布等);
(3)工艺流程——先通孔或后通孔技术;
(4)堆叠形式——晶圆到晶圆、芯片到晶圆或芯片到芯片;
(5)键合方式——直接Cu-Cu键合、粘接、直接熔合、焊接和混合等;
(6)超薄晶圆的处理——是否使用载体。
目前,3D-TSV系统封装技术主要应用于图像传感器、转接板、存储器、逻辑处理器+存储器、移动电话RF模组、MEMS晶圆级三维封装等。
表1 TSV三维封装应用领域
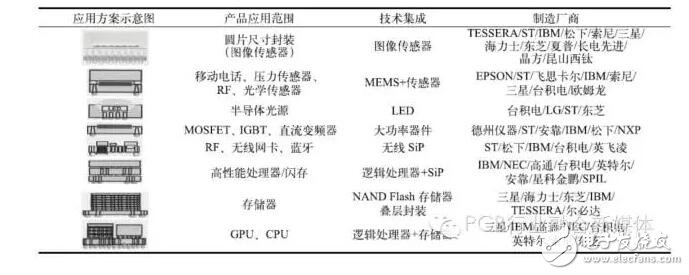
经过数年研发,目前形成具有高良率、不同深宽比结构、高密度微孔、高导通率的3D封装硅基转接板,可以广泛应用于射频、存储等芯片的三维封装领域。
针对目前TSV工艺中的技术难点,采用复合刻蚀技术实现高深宽比结构的微孔制备,采用独特的薄膜沉积技术构建均匀致密的绝缘层,通过精密电沉积技术进行金属互连微通道填充,可以有效控制互连微通道的形貌,以有效解决高密度互连中的散热问题。并通过综合性减薄技术,有效实现超薄TSV转接板的加工,解决在TSV三维封装中减薄工艺容易裂片的问题,实现TSV三维封装的产业化迈开坚实的步伐。
上海环芯TSV主要技术参数
深宽比:1:1-20:1
孔径大小:50 -200μm
硅基底厚度:200 -300μm
填充状态:实孔、侧孔
填充材料:铜、钨
通孔良率:》95%
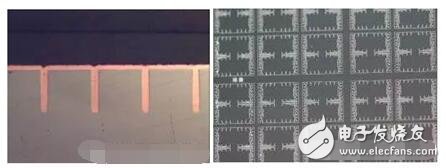
图2 TSV封装结构图



评论