离子注入机失效检测新方法
随着器件线宽和层厚的缩小,离子注入计量设备对硅片上杂质分布均匀性进行直接监测的能力已经开始受到限制。同时,特征尺寸的缩小和参数性能的要求,使关键注入参数的工艺窗口不断变窄,而离子束电流和硅片尺寸却在不断增大。这样一来,就使得通过测量平均偏差与标准偏差(SD,或分布展宽)来量化硅片上注入掺杂均匀性的传统方法,缺乏所需的统计信息来监测离子注入工艺。
本文引用地址:https://www.eepw.com.cn/article/193846.htmNational Semiconductor公司的Kendra Gurcan与来自QC Solutions的合作者们一起,通过研究中等电流离子注入机扫描臂系统的失效机理1,解决了这个问题。这个中等电流离子注入机已经通过常规的工具认证,可以在中等扫描速度下完成测试硅片的离子注入,然后在该公司的ICT300系统上进行测量。使用现有认证的离子注入条件,可以通过在不同的机械扫描速度下进行测试——中等vs.快速扫描——来使扫描臂系统的问题变得更严重,进而在离子注入后的测量中凸显出来。该小组采用基于表面光伏响应(SPV)的高分辨率制图(mapping)技术,从而可以辨别出传统的平均统计与SD统计方法所无法分辨的2-D空间均匀性,并能够观测硅片图上的 空间分布状况。硅片图能显示出垂直于硅片机械扫描方向的条状区域的分布。
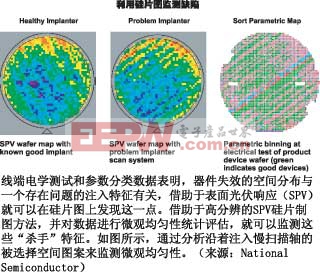
下一步就是确定检测该问题的定量方法。这需要开发出新的测试流程和测量图案,通过测量穿过硅片中心的条状区域来获得截面的非均匀性。“这些平均偏差与中心偏差状况被用做报告出现任何扫描系统失效的基础,” Gurcan说。“线端电学测试和参数分类数据表明,器件失效的空间分布与一个存在问题的注入特征有关,借助于SPV就可以在硅片图上分辨出这一点。”可以用高分辨率SPV硅片制图方法来实时监测这些缺陷,并对数据进行微观均匀性统计评估,以便分析沿着注入慢扫描轴(如图所示)的被选择空间图案。这种分析,连同高分辨率的硅片制图(>1750点/硅片)一起,使得我们能够在线端电学测试或分类参数制图之前,对已知的注入失效模式进行日常监测。这种测试流程不是在产品硅片上进行的,而是在测试硅片上。它可成为制造人员的日常工作基础之一,以便对设备的性能进行监测。
到目前为止,还没有其它方法能够探测这种失效模式。除QCS 离子注入机认证以外,也可以使用一种标准的电阻率认证,但是后者无法探测到扫描系统的失效。在获得最终概念之前,它大约需要两个月的时间来完成多种测试方案。第一步是确定对于从离子注入机扫描系统的失效来观测非均匀性而言,哪种扫描速度最佳。第二步是确定一种定量的方式,当出现这类问题时能够提供一个信号,而不只是硅片上的一个空间图案。定量的测量或计算值能够在生产现场发出警报,表明离子注入机出现问题,需要处理。
这种新型测量流程已经被用于检测中等电流离子注入机的扫描系统失效,解决以前测试遗留下来的问题。
参考文献
1. K. Gurcan, A. Bertuch and K. Steeples, Real-Time High Resolution Wafer Mapping for Advanced Ion Implant Process Control, Frontiers of Characterization and Metrology for Nanoelectronics Intl. Conf., 2007.





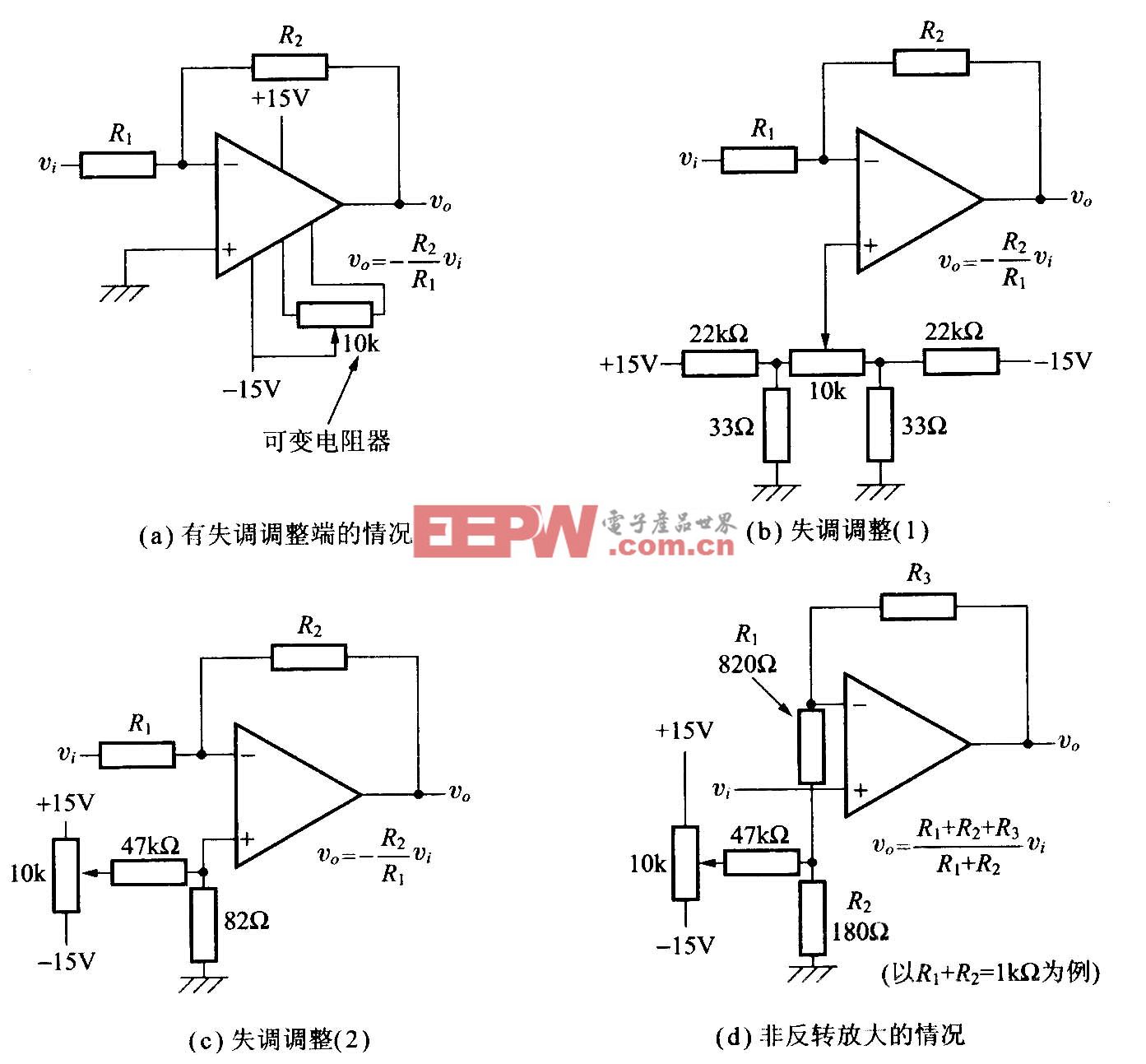



评论