集成电路封装与器件测试设备介绍
电子封装是一个富于挑战、引人入胜的领域。它是集成电路芯片生产完成后不可缺少的一道工序,是器件到系统的桥梁。封装这一生产环节对微电子产品的质量和竞争力都有极大的影响。按目前国际上流行的看法认为,在微电子器件的总体成本中,设计占了三分之一,芯片生产占了三分之一,而封装和测试也占了三分之一,真可谓三分天下有其一。封装研究在全球范围的发展是如此迅猛,而它所面临的挑战和机遇也是自电子产品问世以来所从未遇到过的;封装所涉及的问题之多之广,也是其它许多领域中少见的,它需要从材料到工艺、从无机到聚合物、从大型生产设备到计算力学等等许许多多似乎毫不关连的专家的协同努力,是一门综合性非常强的新型高科技学科。
本文引用地址:https://www.eepw.com.cn/article/193507.htm封装与器件测试回流焊,模拟焊接与实焊测试分析!力锋M系列器件测试回流焊

什么是电子封装 (electronic packaging)? 封装最初的定义是:保护电路芯片免受周围环境的影响(包括物理、化学的影响)。所以,在最初的微电子封装中,是用金属罐 (metal can) 作为外壳,用与外界完全隔离的、气密的方法,来保护脆弱的电子元件。但是,随着集成电路技术的发展,尤其是芯片钝化层技术的不断改进,封装的功能也在慢慢异化。通常认为,封装主要有四大功能,即功率分配、信号分配、散热及包装保护,它的作用是从集成电路器件到系统之间的连接,包括电学连接和物理连接。目前,集成电路芯片的I/O线越来越多,它们的电源供应和信号传送都是要通过封装来实现与系统的连接;芯片的速度越来越快,功率也越来越大,使得芯片的散热问题日趋严重;由于芯片钝化层质量的提高,封装用以保护电路功能的作用其重要性正在下降。电子封装的类型也很复杂。
从使用的包装材料来分,我们可以将封装划分为金属封装、陶瓷封装和塑料封装;从成型工艺来分,我们又可以将封装划分为预成型封装(pre-mold)和后成型封装(post-mold);至于从封装外型来讲,则有SIP(single in-line package)、DIP(dual in-line package)、PLCC(plastic-leaded chip carrier)、PQFP(plastic quad flat pack)、SOP(small-outline package)、TSOP(thin small-outline package)、PPGA(plastic pin grid array)、PBGA(plastic ball grid array)、CSP (chip scale package)等等;若按第一级连接到第二级连接的方式来分,则可以划分为PTH(pin-through-hole)和SMT(surface-mount-technology)二大类,即通常所称的插孔式(或通孔式)和表面贴装式。金属封装是半导体器件封装的最原始的形式,它将分立器件或集成电路置于一个金属容器中,用镍作封盖并镀上金。金属圆形外壳采用由可伐合金材料冲制成的金属底座,借助封接玻璃,在氮气保护气氛下将可伐合金引线按照规定的布线方式熔装在金属底座上,经过引线端头的切平和磨光后,再镀镍、金等惰性金属给与保护。在底座中心进行芯片安装和在引线端头用铝硅丝进行键合。组装完成后,用10号钢带所冲制成的镀镍封帽进行封装,构成气密的、坚固的封装结构。金属封装的优点是气密性好,不受外界环境因素的影响。它的缺点是价格昂贵,外型灵活性小,不能满足半导体器件日益快速发展的需要。
现在,金属封装所占的市场份额已越来越小,几乎已没有商品化的产品。少量产品用于特殊性能要求的军事或航空航天技术中。陶瓷封装是继金属封装后发展起来的一种封装形式,它象金属封装一样,也是气密性的,但价格低于金属封装,而且,经过几十年的不断改进,陶瓷封装的性能越来越好,尤其是陶瓷流延技术的发展,使得陶瓷封装在外型、功能方面的灵活性有了较大的发展。目前,IBM的陶瓷基板技术已经达到100多层布线,可以将无源器件如电阻、电容、电感等都集成在陶瓷基板上,实现高密度封装。陶瓷封装由于它的卓越性能,在航空航天、军事及许多大型计算机方面都有广泛的应用,占据了约10%左右的封装市场(从器件数量来计)。陶瓷封装除了有气密性好的优点之外,还可实现多信号、地和电源层结构,并具有对复杂的器件进行一体化封装的能力。它的散热性也很好。缺点是烧结装配时尺寸精度差、介电系数高(不适用于高频电路),价格昂贵,一般主要应用于一些高端产品中。相对而言,塑料封装自七十年代以来发展更为迅猛,已占据了90%(封装数量)以上的封装市场份额,而且,由于塑料封装在材料和工艺方面的进一步改进,这个份额还在不断上升。
塑料封装最大的优点是价格便宜,其性能价格比十分优越。随着芯片钝化层技术和塑料封装技术的不断进步,尤其是在八十年代以来,半导体技术有了革命性的改进,芯片钝化层质量有了根本的提高,使得塑料封装尽管仍是非气密性的,但其抵抗潮气侵入而引起电子器件失效的能力已大大提高了,因此,一些以前使用金属或陶瓷封装的应用,也已渐渐被塑料封装所替代。SIP是从封装体的一边引出管脚。通常,它们是通孔式的,管脚插入印刷电路板的金属孔内。这种形式的一种变化是锯齿型单列式封装(ZIP),它的管脚仍是从封装体的一边伸出,但排列成锯齿型。这样,在一个给定的长度范围内,提高了管脚密度。SIP的吸引人之处在于它们占据最少的电路板空间,但在许多体系中,封闭式的电路板限制了SIP的高度和应用。
DIP封装的管脚从封装体的两端直线式引出。DIP的外形通常是长方形的,管脚从长的一边伸出。绝大部分的DIP是通孔式,但亦可是表面贴装式。对DIP来说,其管脚数通常在8至64(8、14、16、18、20、22、24、28、40、48、52和64)之间,其中,24至40管脚数的器件最常用于逻辑器件和处理器,而14至20管脚的多用于记忆器件,主要取决于记忆体的尺寸和外形。当器件的管脚数超过48时,DIP结构变得不实用并且浪费电路板空间。称为芯片载体(chip carrier)或quad的封装,四边都有管脚,对高引脚数器件来说,是较好的选择。之所以称之为芯片载体,可能是由于早期为保护多引脚封装的四边引脚,绝大多数模块是封装在预成型载体中。而后成型技术的进步及塑料封装可靠性的提高,已使高引脚数四边封装成为常规封装技术。其它一些缩写字可以区分是否有引脚或焊盘的互连,或是塑料封装还是陶瓷封装体。诸如LLC(lead chip carrier),LLCC(leadless chip carrier)用于区分管脚类型。PLCC(plastic leaded chip carrier)是最常见的四边封装。PLCC的管脚间距是0.050英寸,与DIP相比,其优势是显而易见的。PLCC的引脚数通常在20至84之间(20、28、32、44、52、68和84)。还有一种划分封装类型的参数是封装体的紧凑程度。小外形封装通常称为SO,SOP或SOIC。









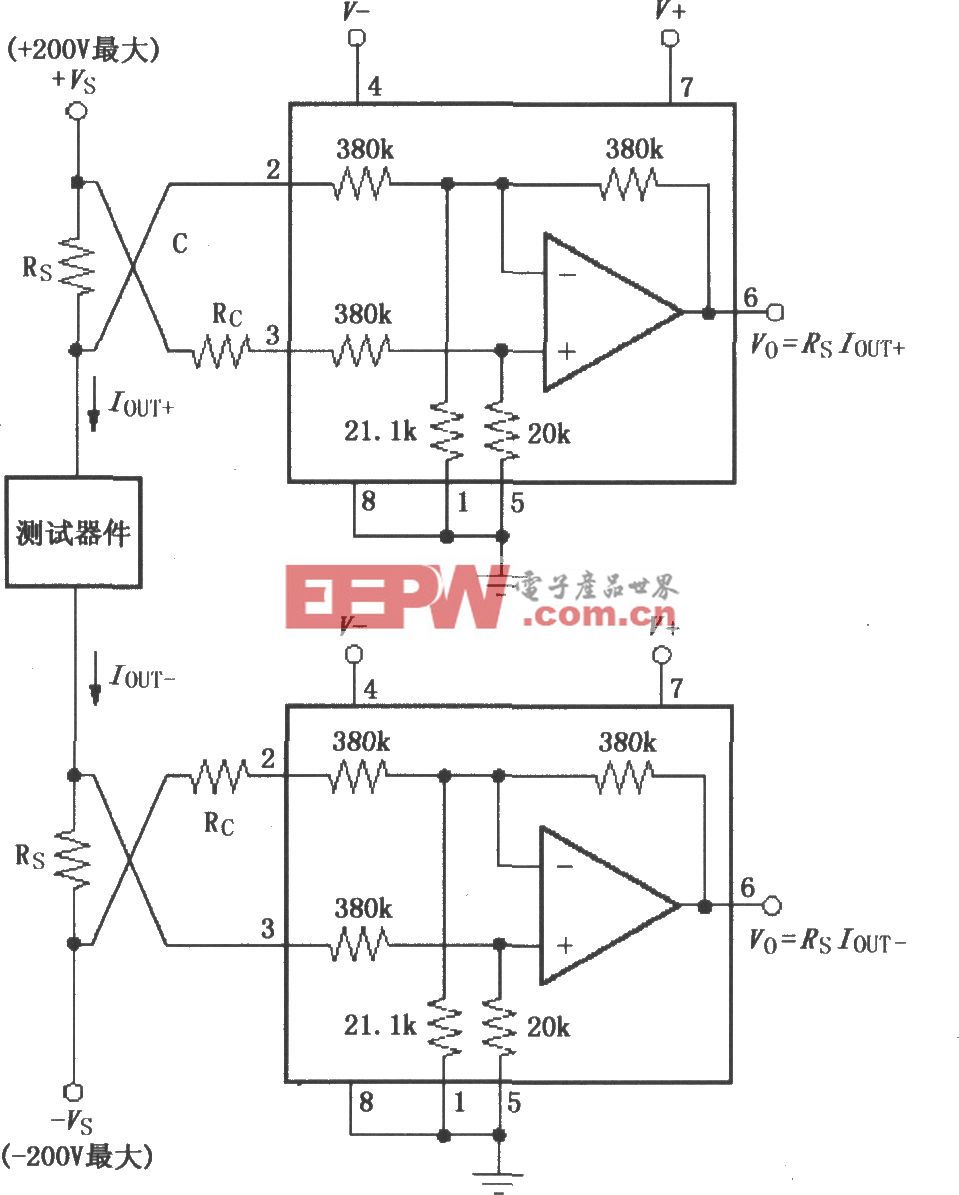

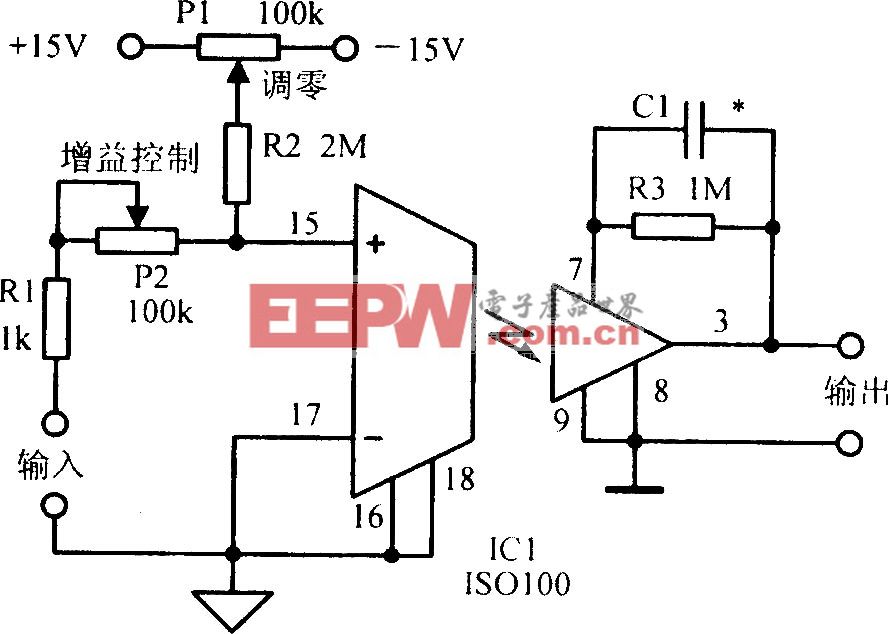

评论