低压超级接面结构优化MOSFET性能
QOSS=5.45×COSS(Vm)×(Vm+0.7)1/2¨¨(公式2)
最终的目标是确保MOSFET不会因为电容性电流流过闸漏电容(CGD)而导致寄生性导通,当快速VDS瞬变电流产生时,CGD会向CGS电容器充电,致使其电压超过阈值。闸极回跳比率(Gate-bounce Ratio, GBr)即用于此目标;其本质在于,当漏极电压升至输入电压电平时,如果所有流经CGD电容器的电容性电流都流入MOSFET的CGS,这时,CGS电容器的电压仍必须低于电压阈值。此一比例可利用QGD1和QGS1的值从闸极电荷曲线中轻易取得,其中,QGD1是VDS=VIN(CGD彻底充电)和VDS=VGS(CGD已放电)之间的QGD部分,QGS1为VGS=0至电压阈值之间的QGS部分。
对于控制FET方面而言,由于现代功率MOSFET的高增益特性,其电流升降时间由电路和源极电感决定,因此其余能耗则由电压升降时间决定,而这些时间则取决于QGD FOM。因此,单独为控制FET定义一个FOM组合并无实际益处。虽然CWS FOM可达成最佳化以应用于同步FET,也可用于判定COSS、CGD和CGS之间由于装置结构所产生的不利影响,但是要注意的是,由于现代元件的QGD相当低,因此,QGD不再是控制FET中功耗的主要因素。另外,由于控制FET的体积相对较小,基本上面积限制晶片尺寸的问题已不复存在,因此,采用面积受到限制的FOM亦无法增加优势。
功率MOSFET结构各有优劣
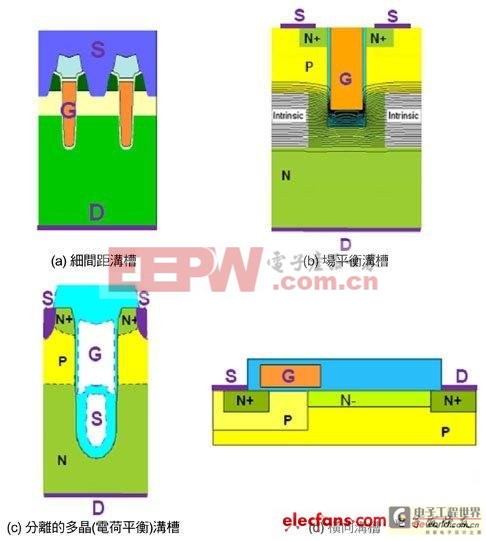
图1标示出目前常用的多种功率MOSFET元件结构。图1a中所示的高密度沟槽结构采用较低的Sp.RDS(on),但QG和QGD较高,因为此两个参数与单元密度成正比。此种结构通常用于开关损耗较无重要性的应用中(如电池保护)。可透过加大单元间距、于沟槽底部加上厚氧化膜以改善此结构的开关性能。
图1 功率MOSFET结构
因单元间距加大而导致的Sp.RDS(on)上升的问题,可针对MOSFET漂移区进行设计处理以解决,如图1b所示的场平衡结构。目前最常采用的结构为分裂闸极(或电荷平衡)沟槽MOSFET,如图1c所示。此种结构闸极的正下方采用一个连接源极的遮罩电极,既可降低QGD,且透过应用降低表面电场(RESURF)原理,漂移区的电阻降至最低。当然,此结构也有其缺点,其需要较高的单元密度(因此闸极电容较高)以获得RESURF状态;另外,采用连接源极的遮罩电极将产生额外的QG和QOSS,并增加制程的复杂程度。
相反地,和沟槽结构相比,横向MOSFET结构(图1d)由于可采用RESURF技术且毋须增加单元密度,因此,可达成出色的QG和QGD FOM。但由于横向结构须要将漂移区纳入单元间距中,因此,可达成的单元密度较低,导致Sp.RDS(on)较低,进而影响到在小面积封装中为同步FET提供所需低RDS(on)的能力。
为了克服现有功率MOSFET结构的缺点,目前已经开发出一种采用超级接面概念的新型结构。低压超级接面MOSFET元件的结构如图2所示,此结构采用N-type和P-type矽区域交替形成一个多重RESURF结构,换言之,相当于将横向MOSFET结构先平行放置后,再垂直摆放,进而获得RESURF结构。这种结构克服横向结构的单元间距限制,同时,在漂移区内达成RESURF无需如同以往分裂闸结构必须依赖增加单元密度,和在每个沟槽闸下方增加CDS和CGD电容器。完成真正为DC-DC转换量身打造的元件结构。
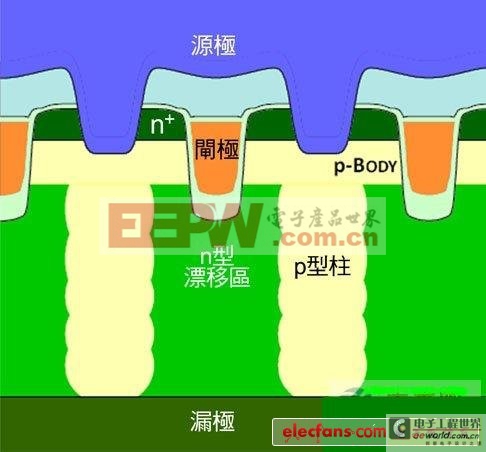
横向/分裂闸/超级接面FOM比较
采用QOSS与QG加权组合作为性能指标的优点如图3所示,其中QG、QOSS及其组合分别针对三个不同的30伏特功率MOSFET结构产生RDS(on)函数。趋势线的斜率反映不同的FOM。请注意:由于数据来自于资料手册,因此数值包含封装电阻。由图3可知,相较于超级接面和分裂闸沟槽技术,横向技术的QG更佳。由于超级接面结构在元件闸极和连接源极的漏极遮罩电极间增加了CGS,因此QG值低于分裂闸技术。
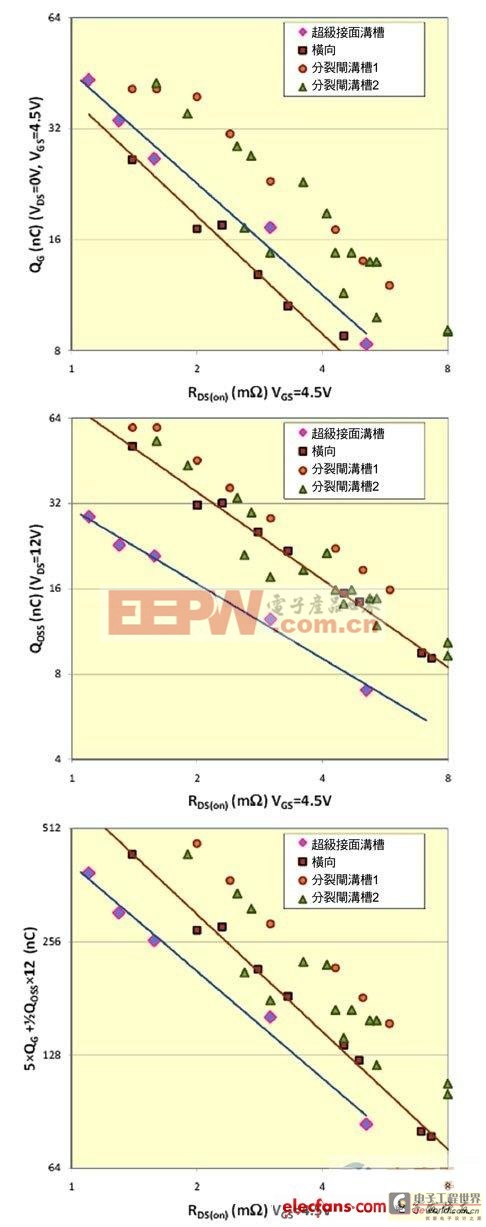
图3 针对横向/分裂闸/超级接面30V功率MOSEFT结构的QG、QOSS和QG与QOSS加权组合(CWS FOM)的比较。
相较于采用表面漏极触点的横向元件而言,横向结构的基板与漏极连接,并在元件主体和基板间增加CDS元件,可产生较高的QOSS结构。分裂闸结构的QOSS值亦较高,因为其依赖漏源极电容的产生以遮罩闸极电极,达到低QGD和RDS(on)。而超级接面结构毋须增加额外的CDS元件,因此可达成三种结构中最低的QOSS值。
选择功率MOSFET结构的重要因素,在于考量该结构是否有助于提高元件性能。若选用横向或分裂闸结构,须考虑在低侧元件应用中,是否值得为获得低QGD和QG而牺牲QOSS性能。这些达成最佳化的结果如图3下半部分所示,QOSS和QG使用5伏特闸极驱动电压和12伏特转换电压进行组合。显然对于同步FET而言,超级接面结构因其固有的低QOSS而具备最佳的综合性能。此结果表明,仅藉由达成最佳化已不足以获得最低QG和QGD FOM。这种情况更足以证明,沟槽结构中闸极电荷已降至相当低,QG不再扮演低侧元件开关损耗的主要因素。








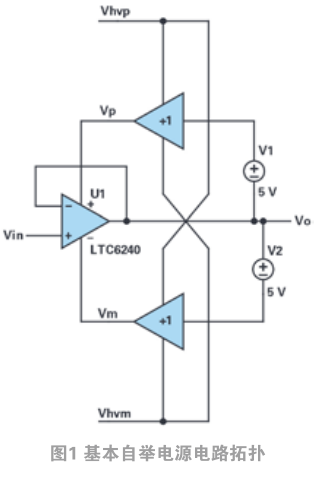

评论