日立高新技术公司部宣布推出其GT2000高精度电子束测量系统
日立高新技术公司宣布推出其GT2000高精度电子束测量系统。GT2000利用日立高新技术在CD-SEM*1方面的技术和专业知识,在那里占有最大的市场份额。
GT2000配备了用于尖端3D半导体器件的新型检测系统。它还利用低损伤高速多点测量功能用于high-NA EUV*2抗蚀剂晶片成像,以最小化抗蚀剂损伤并提高批量生产的产率。
日立高新技术(Hitachi High-Tech)GT2000 CD-SEM将能够实现高级半导体器件制造过程中的高精度、高速测量和检测,这些半导体器件正变得越来越小型化和复杂化,并有助于提高研发和大规模生产中的客户收益率。
*1.CD-SEM(特征尺寸扫描电子显微镜):一种高精度测量的设备,用于检测晶片上形成的精细半导体电路图案的尺寸。
*2.High-NA EUV(高数值孔径极紫外光刻):与传统设备相比具有改进的数值孔径的极端紫外线(13.5nm波长)光刻设备。
发展背景
随着半导体器件制造工艺的发展,N2(2纳米生成节点)和A14(14埃生成节点)的研发正在进行中。除了在现有技术的器件中应用High-NA EUV光刻之外,预期器件结构的复杂性将增加,例如GAA*3和CFET*4结构。
因此,在广泛的测量条件下,高速数据采集以测量各种材料和结构、稳定的操作,以及在尖端半导体器件工艺开发的研究阶段和批量生产中改进工具到工具匹配的需求正在进一步增加。
*3.GAA(Gate All Around):全环绕栅极晶体管。
*4. 垂直堆叠互补场效应晶体管技术(CFET):堆叠互补晶体管,其中n-型和p-型器件被堆叠。
关键技术
1.用于High-NA EUV工艺的100V超低加速电压和超高速多点测量功能
在High-NA EUV光刻工艺中,所使用的抗蚀剂更薄,因此,为了以高精度测量抗蚀剂,计量工具必须尽可能少地对抗蚀剂造成损坏。GT2000通过将开创性的100V超低加速电压与我们专有的高速扫描功能相结合,实现了低损伤和高精度测量。此外,配备超高速多点测量模式,可快速确定制造工艺条件,检测研发阶段的异常情况。
2.用于3D器件结构的高灵敏度检测系统
具有诸如GAA、CFET和3D存储器等结构的3D设备除了传统的CD测量之外,还需要测量图案的深度、孔洞和沟槽的底部。GT2000配备了一个新的高度灵敏的检测系统,能够有效地检测背散射电子,能够实现越来越复杂的设备结构的高精度成像,并扩大了新测量应用的可能性。
3.新的平台和新的电子光学系统,以提高工具对工具的匹配
负责过程监控的CD-SEEM最重要的性能要求之一是多个工具之间测量值的差异很小。GT2000新平台和电子光学系统经过重新设计,以消除任何导致测量值差异的因素,从而改进工具到工具的匹配。
日立高新技术公司通过提供GT2000以及使用电子束技术的测量系统和光学晶片检测系统,努力满足客户在半导体制造过程中的各种加工、测量和检测需求。将继续为产品提供创新和数字增强的解决方案,以应对未来的技术挑战,并与客户一起创造新的价值,同时为尖端制造做出贡献。



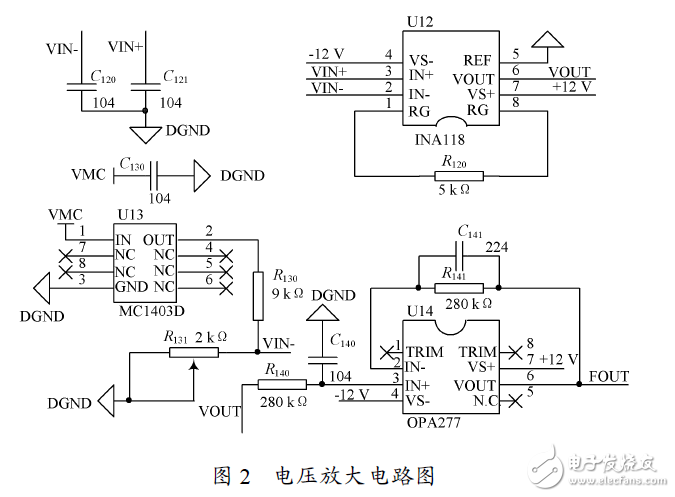


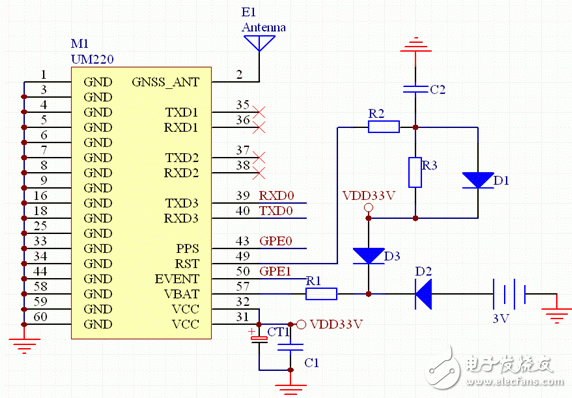



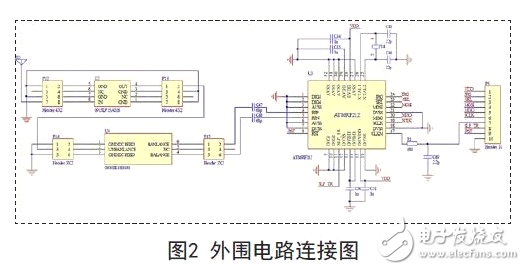
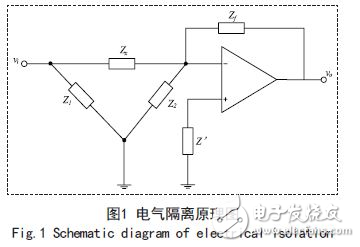
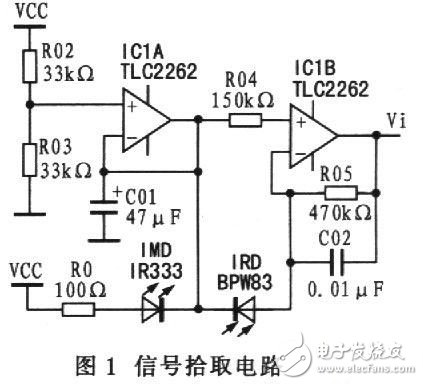
评论