如何解决CSP封装的散热难题?
什么是CSP?
本文引用地址:https://www.eepw.com.cn/article/201807/383758.htmCSP(chip scale package)封装是指一种封装自身的体积大小不超过芯片自身大小的20%的封装技术(下一代技术为衬底级别封装,其封装大小与芯片相同)。为了达成这一目的,制造商尽可能的减少不必要的结构,比如采用标准高功率LED、去除陶瓷散热基板和连接线、金属化P和N极和直接在LED上方覆盖荧光层。
根据Yole Développement 统计,CSP封装将在2020年占到高功率的34%。
为什么CSP封装面临散热挑战?
CSP封装被设计成通过金属化的P和N极直接焊接在印刷电路板(PCB)上。在某一方面来看的确是一件好事,这种设计减少了LED基底和PCB之间的热阻。
但是,由于CSP封装移除了作为散热器件的陶瓷基板,这使得热量直接从LED基底传递到PCB板从而变成了强烈的点热源。这时,对于CSP的散热挑战从“一级(LED基底层面)”转变成了“二级(整个模块层面)”。
针对于这种情况,模块的设计者开始使用金属覆盖印刷电路板(MCPCB)来应对CSP封装。
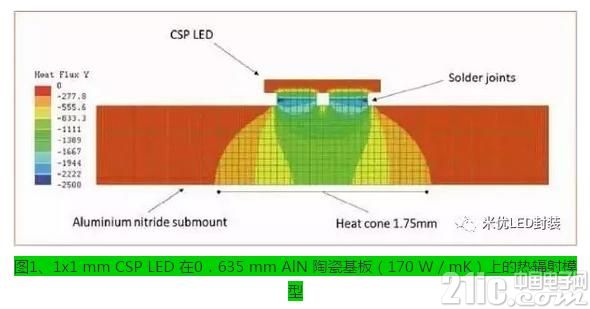
图1、1x1 mm CSP LED 在0.635 mm AlN 陶瓷基板(170 W/mK)上的热辐射模型
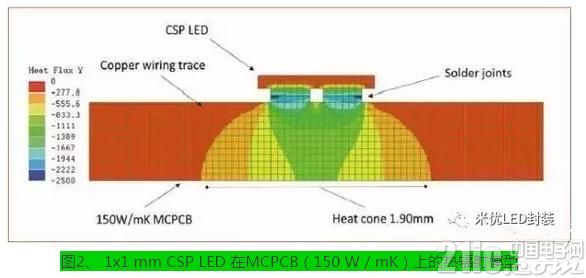
从图1、 2中可以看出 ,研究人员针对MCPCB和氮化铝(AlN)陶瓷进行了一系列的热辐射模拟试验,由于CSP封装的结构,热通量仅仅通过面积很小的焊点传递,大部分热量均集中在中心部位,这会导致使用寿命减少,光质量降低,甚至LED失效。
MCPCB的理想散热模型
通常大多数的MCPCB的结构:金属表面镀上一层大约30微米的表面覆铜。同时,这个金属表面还有一层含有导热陶瓷颗粒的树脂介质层覆盖。但是过多的导热陶瓷颗粒会影响整个MCPCB的性能和可靠性。
同时,对于导热介质层,总是存在性能与可靠性之间的权衡。
根据研究人员的分析,为了更好的散热效果,MCPCB需要降低介质层的厚度。由于热阻(R)等于厚度(L)除以热传导率(k)(R= L/(kA)),而热传导率只由介质的本身属性决定,因此厚度是唯一的变量。
但是由于介质层因为生产工艺的限制和使用寿命的考虑无法无限制的减少厚度,因此研究人员需要一种新的材料来解决这个问题。
纳米陶瓷如何变成MCPCB的最佳方案?
研究人员发现一种电化学氧化过程(ECO)可以在铝表面上生成一层几十微米的氧化铝陶瓷(Al2O3),同时这种氧化铝陶瓷拥有良好的强度和相对较低的热传导率(大约7.3 W/mK)。但是由于氧化膜在电化学氧化过程中自动与铝原子键合,从而降低了两种材料之间的热阻,而且还拥有一定的结构强度。
同时,研究人员将纳米陶瓷与覆铜结合,让这种复合结构的整体厚度在非常低的情况下还拥有较高的总热传导率(大约115W/mK)。因此,这种材料很适合CSP封装的需求。
结论
当设计者继续探索寻找合适CSP封装的材料时,往往发现他们的需求已经超过了现有技术。散热问题导致纳米陶瓷技术的催生,这种纳米材料介质层能够填补传统MCPCB与AlN陶瓷的空隙。从而推动设计者推出更加小型化,清洁高效的光源。














评论