可降低下一代IC测试成本的确定性逻辑内置自测技术
1. 常规DBIST测试模式——内部扫描链路数据来自于PRPG,扫描链路输出到MISR。
2. 常规扫描测试模式——内部扫描链路绕过DBIST控制器,重新设置为数量更少直接连到芯片引脚的扫描链路,该模式对于小型扫描测试很有用,如IDDQ和路径延迟方案。
3. DBIST控制器测试模式——DBIST控制器里的状态元件重新设置为直接连接到芯片引脚的扫描链,允许DBIST控制器高覆盖范围测试。
4. DBIST诊断模式——内部扫描链路数据来自于PRPG,但是扫描链路输出绕过MISR功能,这样捕捉的数据能直接卸载并在MISR输出端取样。
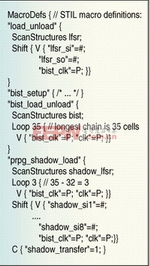
创建完整带有DBIST设计的最后一步很容易被忽视,但它与前面的步骤一样重要。在这一步中,DFT Compiler为所有DBIST控制器测试模式创建DBIST测试协议。这些协议为TetraMAX生成的DBIST方案提供全面控制和时序信息,同时要求能识别DBIST测试结构和正确实施全面的顶级DBIST DRC。图3是采用IEEE标准测试接口语言(STIL)句法做成的DBIST测试协议文本样本。
可预测高测试覆盖率
正如DFT Compiler可以确定提供带DBIST的设计一样,TetraMAX ATPG可以确定生成有效的DBIST测试方案,提供和扫描一样高的覆盖率,这样的范围只能通过赋予PRPG状态初始化外部数值才能可靠实现。和扫描测试方案一样,TetraMAX ATPG关注多种故障,并只设定所需的关注数据位(care bit)来检测这些故障。与用随机数填满剩余非关注位的扫描方案不同的是,DBIST方案的非关注位来自于PRPG,关注位用于计算PRPG晶种。
只要DBIST方案的关注位少于PRPG状态位,就能解线性方程以找到PRPG外部值,这样就能生成带有全部所需关照位集的方案。从一些用户电路收集到的数据表明,在256和512比特之间的PRPG生成方案与扫描相比覆盖范围没有缩小。与扫描一样,TetraMAX将用故障模拟PRPG生成的全部DBIST方案,反映非确定值附加测试覆盖范围。TetraMAX Verilog模拟测试台完全支持针对正常芯片模式的DBIST方案验证。
该技术不仅适用于粘着性故障测试,而且适用于确定性转换故障方案。DBIST结构允许两个没有ATE外部信号变化的全速周期,不用最后位移发射和捕捉时钟脉冲。这种试验比传统扫描或逻辑BIST试验具有更高深亚微米缺陷覆盖率,而且不会使全速逻辑BIST耗用太多功率。DBIST形成的巨大空间保证了以最少附加成本也能应用高覆盖范围转换故障方案。
减少测试数据量和测试时间
确定性逻辑BIST PRPG晶种不仅能够提供确定范围,还有一种更加有效的方法存储和传输ATPG激励。例如100K扫描单元大型设计要求每个扫描方案有100K输入数据位,但每个DBIST方案却只需不到500个输入数据位即可,输出端数据减少得更多,因为不用为每个扫描方案存储100K~200K预期输出数据,这些比特在与预计反应比较之前,先被压缩到多个方案的128位符号中。
减少测试时间依靠两个基本技术,第一个是DBIST结构只用很少外接测试引脚的大量并行内部扫描链路。增加传统扫描并行扫描链路数成本很高,因为每增加一个扫描链路需要增加两个测试引脚和ATE通道。在默认情况下,DBIST使用512个内部扫描链,虽然支持的数量有些不同。对于缺省配置,大约需要20个外接测试引脚,尽管DBIST控制器可以专门配置为只使用6个外接引脚。
第二个技术是对PRPG并行重新赋值。如果内部扫描链路转换要等待PRPG赋值后才能完成,那么测试时间和扫描相比不会缩短多少,可在当前方案转换到内部扫描链路的同时把下一值赋予PRPG并行阴影寄存器里,测试时间是最长内部扫描链路长度的函数。
失效诊断
如果没有准确的失效诊断,DBIST就不是一个完整的制造测试解决方案。诊断逻辑BIST测试一个不可避免的问题是,捕捉到的反应被压缩到一个只包括通过/失败信息的符号寄存器里。尽管失效扫描方案也能显示哪个扫描单元与期望值不匹配,但失效DBIST方案需要更为复杂的分析。与其它DBIST特性一样,DBIST诊断法支持TetraMAX中准确扫描诊断的现有特性。当数据失配的DBIST失效被隔离到内部扫描单元后,也能同样采用发现失败扫描方案缺陷位置的技术。
由于内部扫描单元预期反应数据不包含在DBIST方案里,所以必须收集一组DBIST方案的未压缩反应,然后使用TetraMAX模拟这些方案并判别失配的扫描单元。为整组DBIST方案收集未压缩反应在很多标准ATE上是不实际的,幸运的是,多数缺陷只需采用几个失效方案失配就可准确隔离。
为有效鉴别失效方案,DBIST方案组织成带间隔的形式,在每次间隔结束时比较MISR符号差。缺省条件下,DBIST间隔之间有32个方案(32个内部扫描负载和捕捉),所以DBIST诊断采用的是两次通过流程。在第一次通过时失效的符号差鉴别出失效间隔,在第二次通过时,电路设置为DBIST诊断模式,重新运行一个或更多失效间隔,未压缩的反应收集到ATE上让TetraMAX处理。这种数据收集不需要ATE有特殊性能,只要有足够存储32个方案的扫描单元数据捕捉存储器即可。
本文结论
目前的设计人员和测试工程师被迫在设计流程和制造成本之间进行权衡,改善一个可能会牺牲另一个。应用确定性逻辑BIST后,DFT Compiler SoCBIST可把减少测试成本的技术集成到业界熟悉设计流程中,使得以最低成本获得最高测试质量,并对设计人员的影响最小。


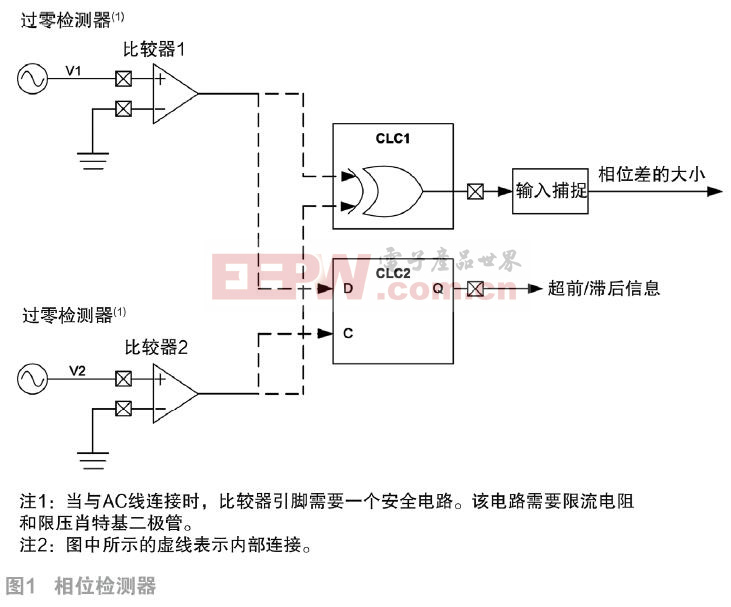









评论