基于FPGA的SRAM自测试研究
引言
SRAM有高速和不用刷新等优点,被广泛用于高性能的计算机系统。由于半导体工艺技术的提高以及存储系统多方面的需要,存储器件日益向高速、高集成方向发展,在使系统功能强大的同时,也增加了系统的复杂性,给电路的故障诊断带来了不小的困难[12]。由于存储器功能和结构的复杂性,设计者为了正确地处理数据和正常地运行用户的程序,必须保证SRAM单元的寻址、取指令以及计算正确,对程序或数据存储单元的正确操作是很重要的方面,因此保证存储器的正常、稳定工作是系统稳定工作的前提。本文主要是通过对常见的SRAM故障问题的分析,运用March C算法,以FPGA构建成的SRAM自检测试电路对SRAM系统进行故障检测与修复。
1 故障模型
所谓故障模型,是指为了研究故障对电路或系统的影响,诊断(定位)故障的位置,对故障作一些分类并选择最典型故障的过程。SRAM系统可抽象为一组互联的功能模块,故障在各个模块均可发生。Van de Goor等人[3]将其简化为地址译码器、读写逻辑、存储器单元阵列3部分,并证明前两者与后者的故障在功能上是等价的,所以只需要检测存储单元阵列故障。常见的SRAM故障模型主要分为以下几个类型[4]:
① 固定故障(StuckAt Faults, SAF)。阵列中的一个或多个单元的一位或多位固定为0或固定为1。
② 开路故障(Open Faults, OF)。阵列中的一个或多个单元开路到0或开路到1。
③ 耦合故障(Coupling Faults, CF)。存储单元中某些位的跳变导致其他位的逻辑值发生非预期的变化,既可以发生在不同单元之间。也可以发生在同一单元的不同位之间。将发生在两个不同单元之间的耦合故障记为第一类耦合故障,将发生在同一单元不同位之间的耦合故障记为第二类耦合故障。
第一类耦合故障又可分为翻转耦合故障、幂等耦合故障以及状态耦合故障等。翻转耦合故障是存储器Ci单元(称耦合单元)中的跳变引起被耦合单元Cj中的逻辑值发生翻转的故障。若用“”表示逻辑值(0→1)的跳变,用“ ”表示逻辑值(1→0)的跳变,而用“ ”表示逻辑值的翻转,则这类故障可描述为眩华>或裕华>;幂等耦合故障是指在Ci中的值跳变时将Cj中的值固定为0或1,可描述为;0>、眩1>或裕0>、裕1>[5];而状态耦合故障则是在耦合单元处于一特定状态时,被耦合单元被迫处于0或1,即0;0>、0;1>或1;0>、1;1>状态。
第二类耦合故障即同一单元不同位间的耦合也有类似的情况,但当写信号很强时,同一单元不同位间的耦合就可能被淹没,只呈现出写入的信息。
④ 跳变故障(Transition Faults,TF)。阵列中的一个或多个单元的一位或多位无法在预期的时间内完成数据从0到1或从1到0的跳变,记为;0>或;1>。这种故障看似可归为固定故障,实质则有所不同。它的状态并非任何时刻都不跳变,当有翻转耦合故障影响它时就会完成原本不能完成的跳变。
⑤ 由地址译码错误引起的单元阵列故障(Address Decoder Fault,AF)。它包括某地址不能访问任何单元、某单元不能被任何地址访问、某个地址可以访问多个单元、某个单元可被多个地址访问。
2 SRAM测试方法
SRAM的测试方法主要有以下3种。
(1) 直接存取测试
直接存取测试是产生一种测试结构来允许对SRAM阵列的直接访问。它通常利用自动测试设备进行测试,可以从封装引脚直接对嵌入式存储器进行访问,或者可以从封装引脚对测试状态逻辑以及对一些为存储器提供数据的流水线结构中的串行状态进行访问,能够轻易实现多种高质量测试算法。其缺点是:在ATE机上实现的算法越复杂,对ATE机存储器的容量要求越高;在ATE机上不易实现对嵌入式存储器的“全速”测试,测试时钟的工作频率越高,测试成本越高;由于芯片外围引脚的限制,对芯片内大容量SRAM进行直接测试往往不大现实。
(2) 利用嵌入微处理器来间接测试存储器
在这种测试方法中,通过嵌入式微处理器对存储器进行读/写操作,测试向量是一系列微处理器的程序代码。这些代码可以放在程序存储器中,在嵌入式芯片接口处施加代码,测试存储器的过程就是微处理器执行测试程序的过程。其优点是不需要对硬件设计做任何修改,而且测试算法的修改与实现可以通过灵活修改微处理器代码予以完成。
(3) 存储器内建自测试(MBIST)
存储器内建自测试技术(Memory BuildIn Self Test, MBIST)的工作原理是在存储器外围产生一整套控制电路,包括数据发生、地址发生、控制产生以及结果比较等电路,实现芯片内置存储器测试模式的自动产生以及测试结果的自动判别。芯片外部的控制可以让芯片自动进入内部存储器测试模式,MBIST不仅可以自动产生内部测试模式,而且也可以实现并行测试。由于需要增加额外的逻辑电路,所以MBIST技术的缺点在于增加了芯片面积,并有可能影响芯片的时序特性。对于不同容量的存储器,MBIST电路的规模基本相同。因此,随着存储器容量的增加,这种方法所增加的芯片面积所占的比例相对较小,而且这种测试技术还有很多其他技术优势。
本文研究的是计算机内的SRAM测试方法,由于待测SRAM位于计算机系统内部,是该系统的关键部分,因此本文采用FPGA作为计算机系统与SRAM之间通信的桥梁,通过接收计算机发出的控制信号,自动产生一套SRAM自测试电路。
3 March C算法
针对存储器中的各种故障模型开发了多种存储器测试算法,如March算法、Walking算法、Galloping算法等。其中March算法是较简单的测试算法之一,具有较高的故障覆盖率和较小的时间复杂度,所以March算法是最常用的存储器测试算法。该算法经过多次改进,出现了很多变种,如MATS、MATS+、March X、March C、March C等算法[6]。
March C算法是由March元素构成的序列,其基本原理是利用有限状态机,反复对每一个地址进行读/写0或1操作,保证每两个字节之间的测试码出现00、01、10、11四种情况,至少各一次;并且为了检查高低地址读/写顺序故障,分别进行地址递增和地址递减两种操作。通过对存储器不断地读写,能够检测几乎所有的存储器故障。
在诸多的March C算法中,综合考虑算法的故障覆盖率及测试成本等因素,本文选用能够有效检测大多数存储器简化故障的March C算法。March C算法的具体描述如下[7]:
其中,“”表示地址的升序,“”表示地址的降序,“ ”表示两种顺序都可以;r0、w0、r1和w1分别表示读0、写0、读1和写1。M0~M5分别表示一个March单元,March C算法能够有效检测出 SAF、TF、CF、AF等故障。其中,SAF故障可由 M0、M1单元和 M1、M2单元检测出;TF故障中0→1故障可由M3、M4单元检测出,1→0故障可由M2、M3单元检测出;在CF故障中,1→0故障可由M2、M3单元和M4、M5单元检测出,0→1故障可由M1、M2单元和M3、M4单元检测出,置1故障可由M2、M3单元和M4、M5单元检测出,置0故障可由M1、M2单元和M2、M3单元检测出;AF故障可以在March单元的连续升序/降序中得到检测。




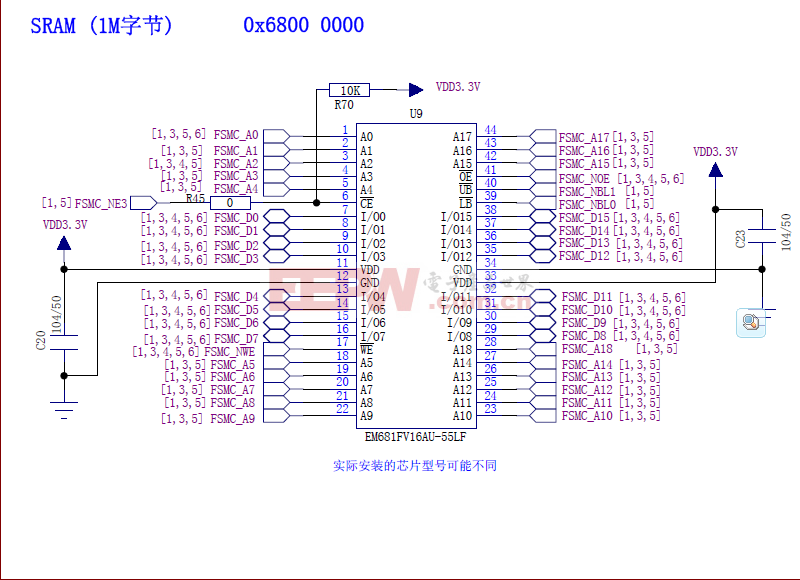








评论