直流和脉冲电镀Cu互连线的性能比较
随着芯片集成度的不断提高,Cu已经取代A1成为超大规模集成电路互连中的主流互连材料。在目前的芯片制造中,芯片的布线和互连几乎全部是采用直流电镀的方法获得Cu镀层。在直流电镀中,由于金属离子趋近阴极不断被沉积,因而不可避免地造成浓差极化。而脉冲电镀在电流导通时,接近阴极的金属离子被充分地沉积;当电流关断时,阴极周围的放电离子又重新恢复到初始浓度。脉冲电镀的主要优点有:降低浓差极化,提高了阴极电流密度和电镀效率;改善镀层物理性能;所得镀层具有较好的防护性;能获得致密的低电阻率金属沉积层。
脉冲电镀理论20世纪初就已被提出。近几年来,国外陆续发表了一些关于脉冲电镀在集成电路Cu互连应用中的研究。目前国内,针对脉冲电镀Cu的研究主要集中在冶金级电镀和印刷电路板(PCB)布线方面,几乎没有关于脉冲电镀应用于集成电路Cu互连的文献报道。而在集成电路(IC)制造采用的是成熟的直流电镀工艺。PCB中线路的特征尺寸约为几十微米,而芯片中Cu互连的特征尺寸是1μm,因此对亚微米级厚度Cu镀层的性能研究显得尤为必要。本文将针对集成电路芯片Cu互连技术,研究分别用脉冲电镀和直流电镀沉积得到的Cu镀层性能。
1 实验
采用200 mm p型(100)Si片,首先在Si片上PECVD(concept one 200 mm dielectric system,Novellus)淀积800 nm SiO2介质层。接着用PVD(Invoa 200,Novellus)溅射25 nm的TaN/Ta扩散阻挡层,然后用PVD溅射50 nm的Cu籽晶层。在电解槽中,阳极为高纯度的Cu棒,外面包裹一层过滤膜,其作用是电镀时阻止固态不溶性杂质颗粒进入Cu镀层,影响镀层性能。将经PVD溅射好Cu籽晶层的200 mm Si片切片后的小矩形片作为阴极(5 cm×2 cm)。电解槽底部靠近阴极处有一个磁力搅拌子,电镀时置于电解槽下面的磁力搅拌仪产生磁场,驱动搅拌子匀速转动,转速设定为400r/min,这可以使电镀过程中阴极附近电解液中的Cu离子浓度保持正常,降低浓差极化和提高阴极电流密度,加快沉积速度。
电镀液成分为Cu2+17.5 g/L,H2S04 175 g/L,Cl一50 mg/L,加速剂2 mL/L,抑制剂8 mL/L和平整剂1.5 mL/L(添加剂均来自美国Enthone公司)。Cl一能提高镀层光亮度和平整性,降低镀层的内应力,增强抑制剂的吸附。加速剂通常是含S或其他官能团的有机物,包括硫脲及其衍生物,它的作用是促进Cu的成核,使各晶面生长速度趋于均匀。抑制剂包括聚乙二醇(PEG)、聚丙烯二醇和聚乙二醇的共聚物等,它的作用是和Cl一一起在阴极表面上形成一层连续膜以阻止Cu的沉积。平整剂通常是杂环化合物,一般含有N原子,它的作用是降低镀层表面粗糙度。
对于脉冲电镀,考虑到镀层与电解液界面间存在电位差,会在镀层表面形成一个双电层,其作用等效于一个电容,脉冲频率如果太大,双电层电容在脉宽和脉间内来不及充放电,此时的脉冲电流将接近于直流电流。但如果脉冲频率太小,电流效率就会变得很低,因此脉宽和脉间的时间一般都选在毫秒级。根据文献的研究结果,固定ton=8ms,toff=2ms,研究不同平均电流密度的影响。实验中通过设置不同的电流密度以及相对应的电镀时间,将Cu镀层厚度都较严格地控制在1μm。实验中使用方波脉冲,测量的Cu镀层薄膜参数包括电阻率、XRD、SEM和AFM。
2 结果和讨论
2.1 电阻率测量结果
图1是电沉积Cu层电阻率与电流密度之间的关系。可见,脉冲电镀得到的Cu镀层电阻率小于相同电流密度下的直流镀层。在小电流密度时(2 A/dm2),直流镀层和脉冲镀层的电阻率都较大。

2.2 XRD测量结果
在XRD测量中,以晶面(hkl)的织构系数TC(texture coefficient)来表征晶面择优程度。

式中:I(hkl)、I0(hkl)分别表示沉积层试样和标准试样(hkl)晶面的衍射线强度;n为衍射峰个数。当各衍射面的TC值相同时,晶面取向是无序的,如果某个(hkl)面的TC值大于平均值,则该晶面为择优取向。晶面的TC值越大,其择优程度越高。
图2中(a)和(b)分别为直流镀层和脉冲镀层织构系数与电流密度的关系。(111)晶面抗电迁移的能力是(200)晶面的4倍,因此(111)晶面更有利于互连。两张图的变化趋势类似,主要晶面都是(111)和(200),但直流镀层中(111)的择优程度较脉冲镀层稍好。通过对Cu种籽层进行XRD后发现,籽晶Cu中(200)晶面呈现绝对择优。因此,XRD的结果表明,直流电镀的晶面抗电迁移的能力要优于脉冲电镀。由于1 μm的Cu电镀层太薄,镀层受到较强基体效应的影响,电沉积条件对晶面的影响很小,因此籽晶层的晶面在很大程度上决定了镀层的晶面情况。有文献报道,当Cu镀层超过4 μm后,就基本不受基体外延的影响,而主要由电沉积条件决定,形成绝对优势的择优晶面取向。



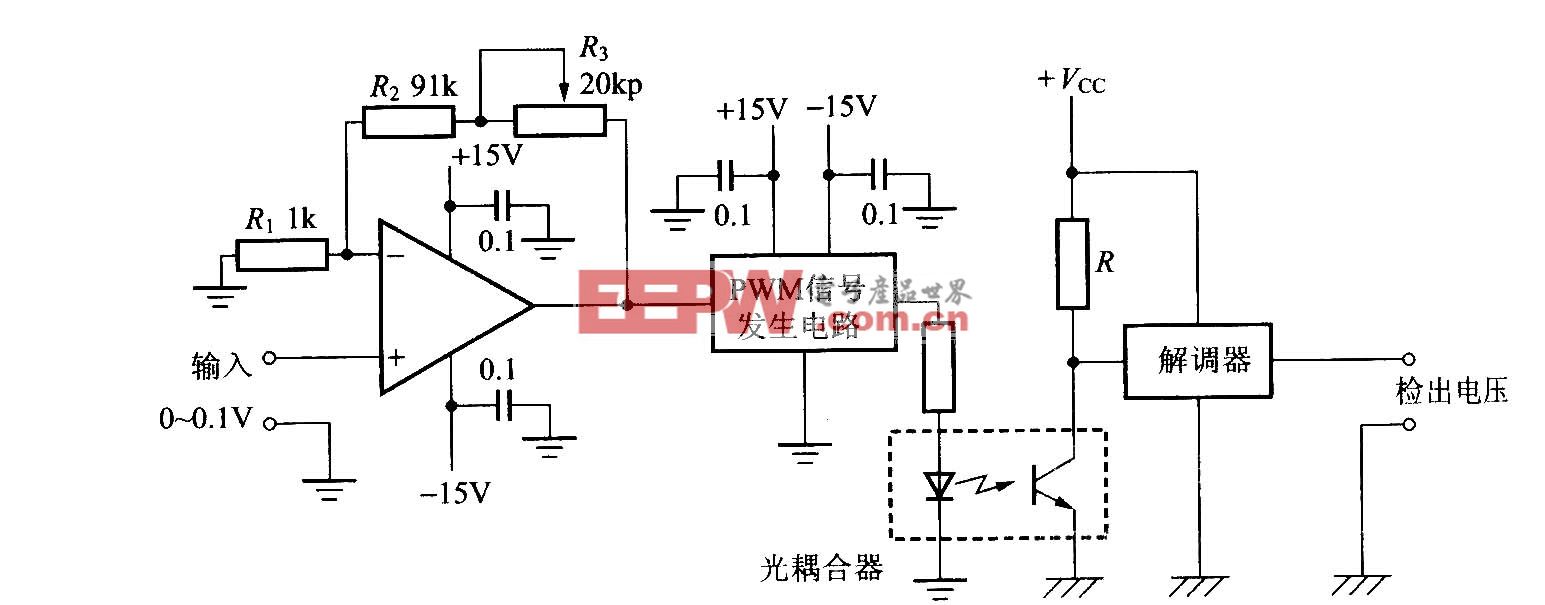


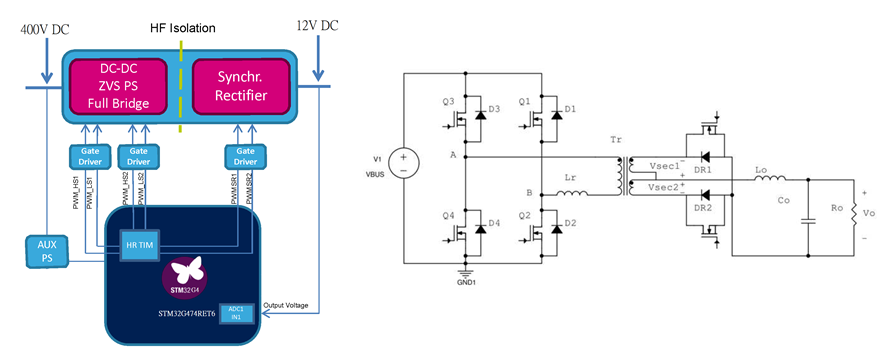


评论