大口径高精度方形平面光学元件研制技术
1.前言
本文引用地址:https://www.eepw.com.cn/article/187108.htm为了满足大型光学系统对大口径高精度平面光学元部件的需要,环行抛光技术越来越广泛地应用到实际光学元部件的生产中。采用环行抛光技术(本文中主要涉及大玻璃校正盘修磨的单环行抛光机)加工的光学元部件可以获得较高的面形精度。对于圆形光学元部件来说,使用环行抛光技术可以得到λ/8(P-V),有多年光学加工经验的加工者可以加工到λ/20~λ/40。环形抛光技术在加工大口径高精度平面光学元部件中,同传统的加工方法相比,可以获得更好的面形精度或波前精度,在加工异形光学元部件中更有优势。
2.大玻璃校正盘修磨的单环行抛光机环行抛光原理
在原理上,环行抛光运转特性与传统盘相同。任何两个工件表面如能在任一部分任一方向上向彼此都能均匀接触,其表面形状必定是球面,其曲率可以是正、负或零。当校正盘沿着径向向外移动时,转动力矩增大,使沥青胶盘变凸;当校正盘沿着径向向内移动时,转动力矩减小,使沥青胶盘变凹。
假设一个工件以角速度ω旋转,以Ω旋转的磨盘中心到工件旋转中心距离为R,距工件旋转中心距离为r,并相对磨盘中心和工件中心连线的角度为θ。磨盘的相对速度为V(r,θ)=.[R2Ω2+(Ω-ω)2+2rR(Ω-ω)cosθ]1/2.(1).当Ω等于ω时,磨盘与工件之间的速度关系在任意位置都是一个常数。由于在环抛加工时加工件及校正盘处于自由状态压力均匀,从而使整个表面均匀磨削;当Ω不等于ω.时,会产生一个径向的磨损变化,使表面的磨削不均匀。
整个表面磨削量dh/dt.可由Preston.方程表示为:dh/dt=kPv=kP(ds/dt)。
式中,k为比例常数,它与被抛光材料、抛光膜层材料、抛光粉种类、抛光液浓度、PH值及抛光温度等参数有关;P为局部压力;V为相对速度,等于在dt.时间内的行程ds的比值。
3.工艺实验
3.1.环抛设备简介
成都精密光学工程研究中心目前配备了三台一米,三台二米和一台二点五米的环形平面抛光机,其中一米的设备主要加工Ф330毫米以内的平面光学元部件,二米的设备主要加工Ф600毫米以内的平面光学元部件,二点五米环抛设备主要用于Ф800毫米以内的平面光学元部件。并且一米、二米的环抛设备均按照3台一个机组配置,这样的机组培植比单台培植更有利于光学元部件面形的控制,使面形修正精度达到了用户的要求,提高了工作效率,缩短了加工周期。
一米环抛设备和二米环抛设备主要由变频器控制的调速电机、蜗轮蜗杆减速箱、基座、安放在平面轴承上的托盘、大理石及上面的抛光膜、校正盘、夹持用辅助工装及可以检查的正盘面形的带翻转装置的翻转机构组成。机床主轴转速为0.3~3r/min。;该设备调整校正盘比较方便,视野开阔,上下被加工元件也比较方便,夹持器调整范围比较大,翻转机构可以方便校正盘面形的检测及在设备休整或停机时存放校正盘。由于校正盘夹持器较长,夹持器在工作中尤其是校正盘与抛光胶盘面形不吻合的时候容易出现颤抖,影响胶盘的修正及被加工件的加工。
2.5m环抛设备主要由调速电机、齿轮减速箱、基座、安放在大齿圈上的托盘、大理石及抛光膜、校正盘及夹持校正盘和工件的横梁支撑结构及其他辅助工装组成。机床主轴转速为0~4r/min。该设备设计时将主机部分与横梁支撑结构分离,减少了主机与衡量结构相互间的互相影响,同时采用横梁支撑结构增大了校正盘的刚性。但校正盘和工件的调整比较烦琐,在调整过程中脏东西容易掉在抛光胶盘上,使被加工件出现道子。在光学加工中尤其是精抛光时最忌讳被加工件出现道子,这将直接影响到加工质量、效率及加工单位的信誉。
3.2.工艺实验
(1)方形元件的精细研磨。将方形元件用胶条或专用工装上盘进行精细研磨。一般大口径光学元部件的精细研磨最后一道砂用W14金刚砂研磨,研磨时必须将两面磨透,并将等厚控制在0.01以内,面形微凹一些,有利于基板的抛光修面形精度。观察表面砂眼粗细均匀,没有新的道子及外伤。
(2)方形元件的初抛光。可将方形元件用点胶上盘进行初抛光。刚开始时应该勤加抛光粉,抛光粉的浓度要大一些,以降低光学表面粗糙度和提高抛光效率,并在将光学元部件基板抛亮的过程中逐步修正面形精度,最终将面形控制在1.5λ左右,表面疵病控制在Ⅲ级。
(3)方形元件的环行精抛光。大口径方形元件的精抛光采用环形抛光技术加工。在环形抛光过程中,首先需要胶盘的面形要良好,在上抛光工件之前就应该将抛光胶盘修正到一定的精度,并且希望在加工过程中胶盘一直保持这种良好状态,直到光学元部件达到所要求的精度为止。在实际加工的整个过程中,保持一致状态是不太现实的,需要根据胶盘面形及工件面形的实际情况而定。通过调整校正盘的位置状态,让胶盘尽可能保持所需要的面形,以便高效地加工相应的工件。
在实际的环行抛光加工过程中,总是将3台一组的环抛机群中的一台胶盘面形保持微凹,一台胶盘面形保持微凸,一台用作最后的面形修正。这样可以针对不同初抛光的不同加工件的不同面形状况选择相应的环行抛光机,节约修正胶盘面形的时间,提高工件的加工效率。
在加工工件的过程中,最重要的尽可能保证胶盘面形良好。在精抛光过程中,调整校正盘的位置时,调整幅度尽可能小一些,有利于胶盘与校正盘的面形相互磨合。当校正盘的调节量较大时容易出现校正盘颤动现象,影响胶盘的修正,同时校正的面形难以保证,容易出现带差,导致修整胶盘的时间比较多,真正加工工件的时间少,降低了加工效率。
在加工大口径方形元件的过程中容易出现四个角踏或翘的现象。为了克服加工过程中的边缘效应,在实际加工过程中通过对专用工装进行改进,同时在加工过程中有意识地控制被加工件的工作位置状态,可以大大缓减大口径方形元件加工塌边或翘边问题。
被加工的方形元件在加工过程中容易出现对角塌角现象,笔者认为是被加工件面形与胶盘面形不吻合或专用工装设计上存在的一些不足引起的,通过改进专用工装,比较好地解决了这一问题。
环抛大口径高精度光学元部件时,加工精度达到0.8λ(P-V,λ=0.6328um)左右是容易的,收敛速度也比较快。当精度越往上加工难度就越大,甚至出现加工精度反复。当加工精度达到λ/2(P-V,λ=0.6328um)左右时,工件单次加工时间就越来越短,检测的频率就更快,以便保证被加工件的收敛趋势及精度。
用环行抛光技术加工,需在投射波前要求的高精度光学元部件透射两面的面形精度及材料参数所引起的波前误差,因此在加工透射波前所要求的光学部件时,在实际加工中常将方形元件的单面面形精度控制在λ/3左右。然后进行第二面精度的修正,在第二面精度达到负λ/3左右时进行透射波前检验,并进行小量的修正,知道加工精度单次透射波前达到λ/6(P-V,λ=0.6328um)。加工反射波前所要求的光学元部件相对难度就要难度大一些,加工过程中主要解决塌角或翘角(主要是塌角)现象,只要将塌角或翘角控制在一定范围及精度内,则整个表面的反射波前达到λ/4(P-V,λ=0.6328um)是可能的。所加工的320×320×48mm和320×320×35mmUBK7材料的光学样件经24''相移干涉仪检测。
4.结论
虽然笔者在大型环抛机加工方面有了一定的加工经验,但还存在许多不足的地方。2m、2.5m环抛机加工工艺还不成熟,还有很多细节需要进一步的研究。1m环抛技术与2m环抛技术虽然在抛光原理上是一样的,但直接将1m环抛上的加工经验移植到2m环抛机上进行加工又不太适宜,而且2m环抛机对环境的要求比1m环抛机对环境的要求要严格得多。
加工设备性能不稳定。由于2m及2.5m环抛机在国内都属于新研制的大型光学加工设备,设备制造厂商缺少实际加工大口径光学元部件设备的经验,有一些地方需要作进一步的改进。
环抛加工受环境影响较大,对环境温度及其波动大小、湿度、环境清洁都有较高的要求。下一步准备进一步净化环抛加工环境,提高环抛设备加工的环境条件。
透射电镜相关文章:透射电镜原理


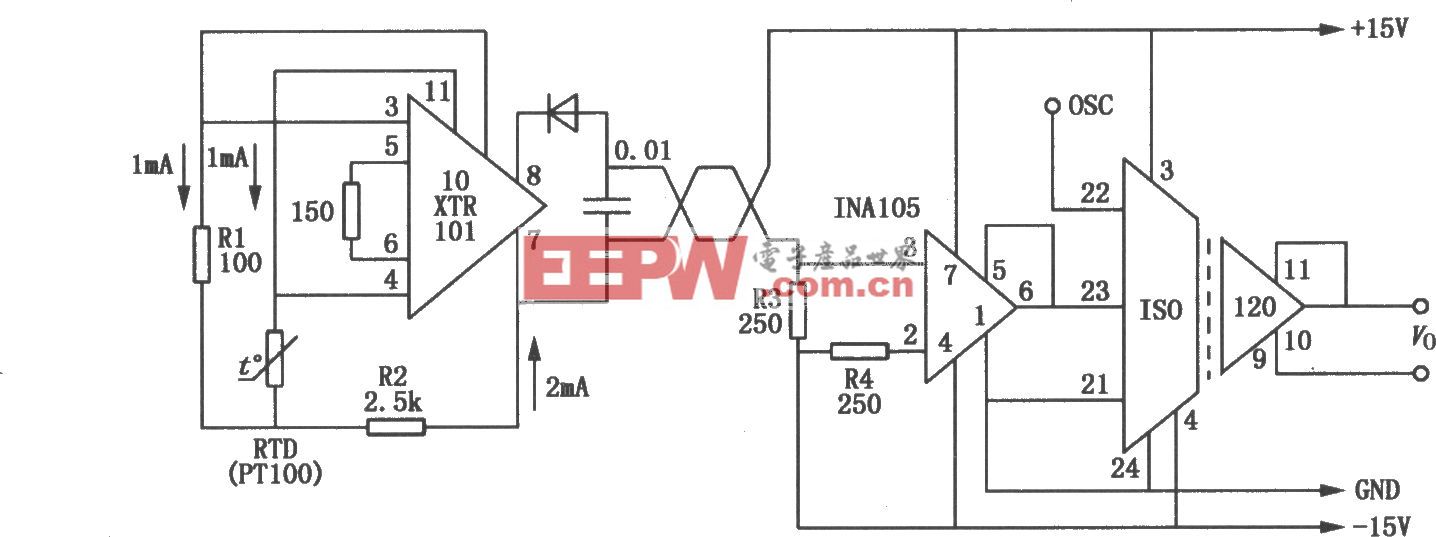

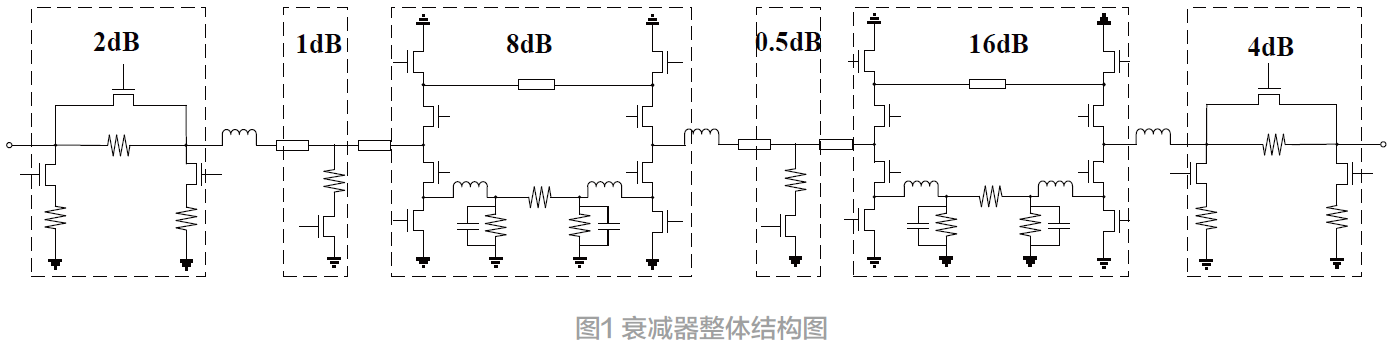
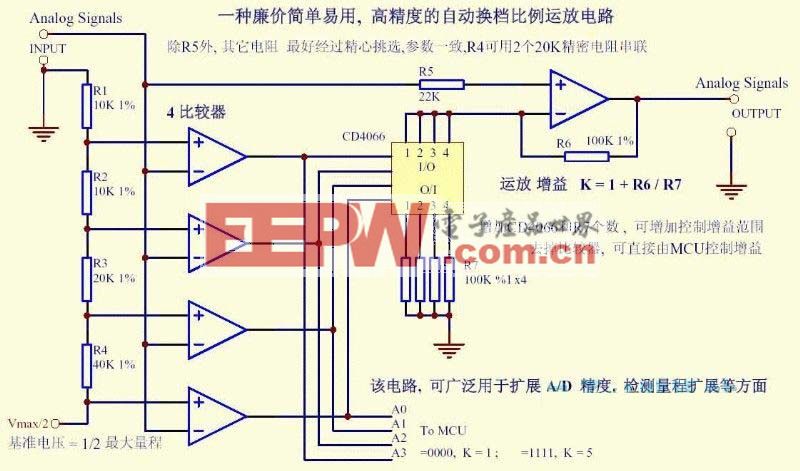

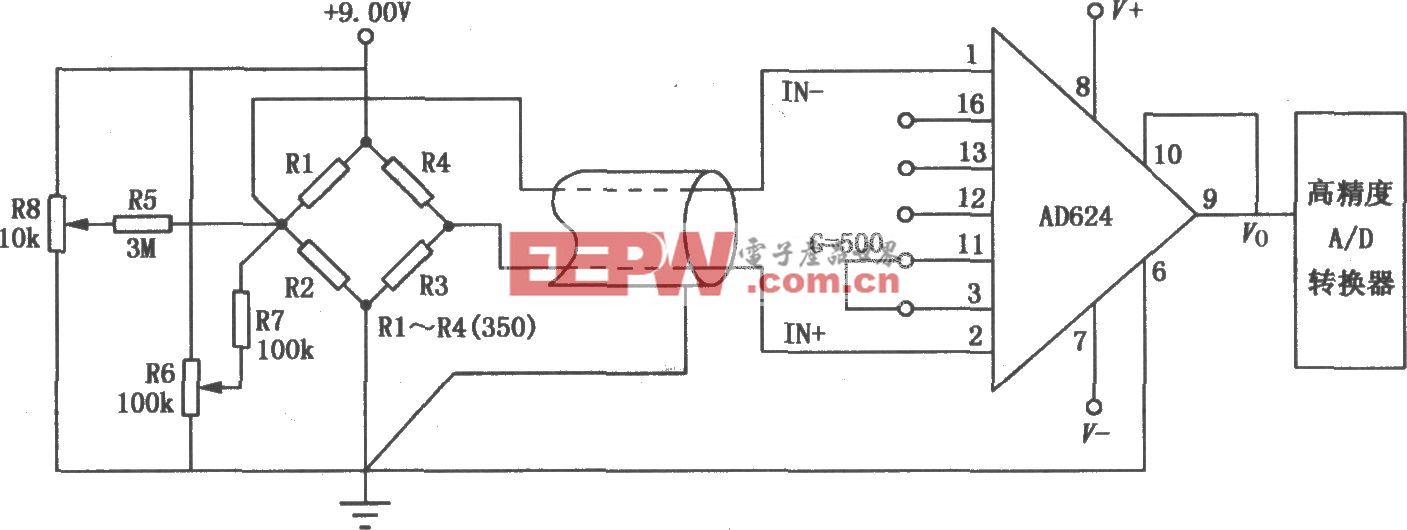


评论