一文了解半导体环氧塑封料
来源:艾邦半导体网

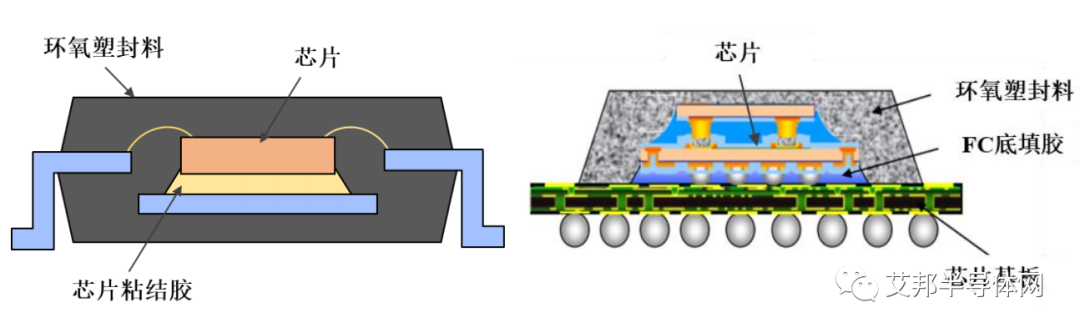
封装技术发展阶段 | 对应封装形式 | 环氧塑封料性能要求 |
第一阶段 | TO、DIP 等 | 重点考察环氧塑封料的热性能与电性能,要求在配方设计中关注固化时间、Tg、CTE、导热系数、离子含量、气孔率等因素 |
第二阶段 | SOT、SOP 等 | 重点考察环氧塑封料的可靠性、连续模塑性等性能,要求在配方设计中关注冲丝率、固化时间、流动性、离子含量、吸水率、粘接力、弯曲强度、弯曲模量等因素 |
第三阶段 | QFN、BGA 等 | 重点考察环氧塑封料的翘曲、可靠性、气孔等性能,要求在配方设计中关注流动性、粘度、弯曲强度、弯曲模量、Tg、CTE、应力、吸水率、粘接力等因素 |
第四、第五阶段 | SiP、FOWLP 等 | 对环氧塑封料的翘曲、可靠性、气孔提出了更高的要求,部分产品以颗粒状或液态形式呈现,要求在配方设计中关注粘度、粘接力、吸水率、弯曲强度、弯曲模量、Tg、CTE、离子含量、颗粒状材料的大小等因素 |
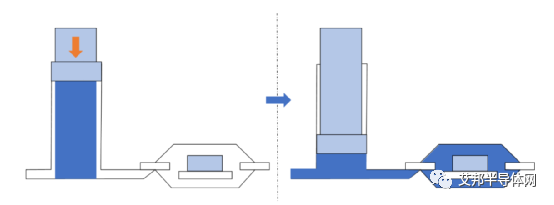 图 环氧塑封料模塑成型的简要工艺流程图
图 环氧塑封料模塑成型的简要工艺流程图 环氧塑封料生产的主要环节包括预处理、配料、高搅、磁选、挤出、粉碎、后混合、打饼等生产工艺环节。环氧塑封料的技术难度主要体现在:
(1)配方体系复杂
环氧塑封料的配方体系较为复杂。在配方开发过程中,需在众多化合物中筛选出数十种原材料(包括主料及添加剂)进行复配,确定合适的添加比例,并充分考虑成本等因素以满足量产的需求。由于配方中任一原材料的种类或比例变动都可能导致在优化某一性能指标时,对其它性能指标产生不利影响(例如,通过添加填料提升填充性的同时会使流动性下降),因此,产品配方需要充分考虑各原材料由于种类或比例不同对各项性能造成的相互影响,并在多项性能需求间实现有效平衡,以保证产品的可靠性。
(2)定制化需求
由于不同客户或同一客户不同产品的封装形式、生产设备选型、工艺控制、前道材料选用、可靠性考核要求及终端应用场景等方面存在差异,对环氧塑封料的各项性能指标都有独特的要求,下游封装厂商对环氧塑封料的需求呈现定制化特征。
(3)匹配封装技术
由于历代封装技术及不同的应用领域对环氧塑封料的性能要求均存在差异,环氧塑封料厂商需以下游技术的发展为导向,持续开发在理化性能、工艺性能以及应用性能等方面与历代封装技术相匹配的新产品,故而业内呈现出“一代封装,一代材料”的特点。
封装技术的持续演进对环氧塑封料提出了更多、更严苛的性能要求。其中,先进封装中的QFN/BGA、FOWLP/FOPLP等因其不对称封装形式而增加了对环氧塑封料的翘曲控制要求,同时要求环氧塑封料在经过更严苛的可靠性考核后仍不出现任何分层且保持芯片的电性能良好。

*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。











