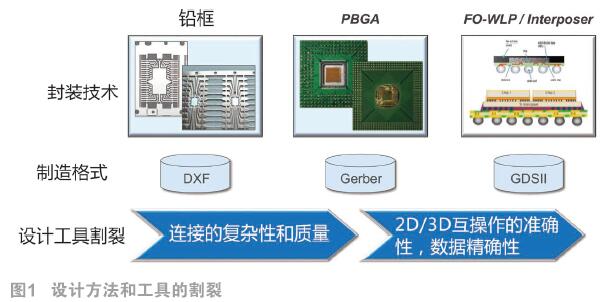
- 作者 王莹HDAP的挑战 有人认为摩尔定律在IC制程上已接近极限,但如果在封装上继续创新,例如利用叠层芯片封装,摩尔定律还可以继续走下去。因此,扩张式的摩尔定律会在封装上实现,包括手机、通信、智能设备(诸如无人机等)、自动驾驶汽车、安全(security)、网络、硬盘存储器、服务器等,都将受益于HDAP(高密度先进封装)的创新。 传统封装在基板上有引脚,现在基板上的引脚数量越来越多,诞生了各种新型封装,诸如TSMC的扇出晶圆级封装(FOWLP),interposer-based(基于中间层的) 封装(
- 关键字:
HDAP Mentor IC设计和封装 FOWLP 201708
ic设计和封装介绍
您好,目前还没有人创建词条ic设计和封装!
欢迎您创建该词条,阐述对ic设计和封装的理解,并与今后在此搜索ic设计和封装的朋友们分享。
创建词条
关于我们 -
广告服务 -
企业会员服务 -
网站地图 -
联系我们 -
征稿 -
友情链接 -
手机EEPW
Copyright ©2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《电子产品世界》杂志社 版权所有 北京东晓国际技术信息咨询有限公司

京ICP备12027778号-2 北京市公安局备案:1101082052 京公网安备11010802012473