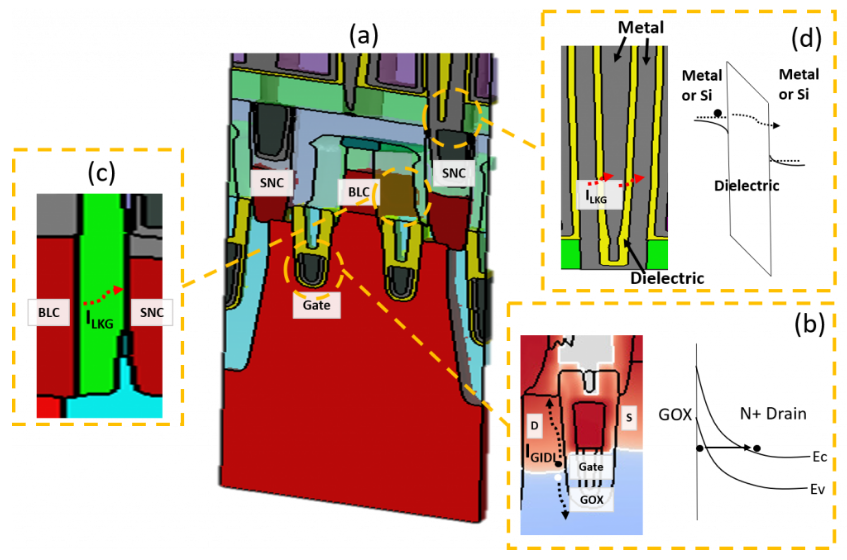
- 从20nm技术节点开始,漏电流一直都是动态随机存取存储器(DRAM)设计中引起器件故障的主要原因。即使底层器件未出现明显的结构异常,DRAM设计中漏电流造成的问题也会导致可靠性下降。漏电流已成为DRAM器件设计中至关重要的一个考虑因素。图1. (a) DRAM存储单元;(b)单元晶体管中的栅诱导漏极泄漏电流 (GIDL);(c)位线接触 (BLC) 与存储节点接触 (SNC) 之间的电介质泄漏;(d) DRAM电容处的电介质泄漏。DRAM存储单元(图1 (a))在电
- 关键字:
DRAM GIDL
gidl介绍
您好,目前还没有人创建词条gidl!
欢迎您创建该词条,阐述对gidl的理解,并与今后在此搜索gidl的朋友们分享。
创建词条
关于我们 -
广告服务 -
企业会员服务 -
网站地图 -
联系我们 -
征稿 -
友情链接 -
手机EEPW
Copyright ©2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《电子产品世界》杂志社 版权所有 北京东晓国际技术信息咨询有限公司

京ICP备12027778号-2 北京市公安局备案:1101082052 京公网安备11010802012473