TSV产值2013年可达140亿~170亿美元 渗透率达5%
国际半导体展(Semicon Taiwan 2009)的3D IC论坛近日热闹展开,日月光集团研发处总经理唐和明再次强调未来3年后3D IC技术将会进入成熟阶段,3D系统级封装(SiP)和3D系统单芯片(SoC)可望相辅相成。很多封装方式可以藉著矽穿孔(Through Silicon Via;TSV)降低成本、增加传输速度,研究机构Gartner预估TSV全球产值到2013年可望达到140亿~170亿美元,届时将有5~6%的全球装置采用。
本文引用地址:http://www.eepw.com.cn/article/98717.htm在1日的3D IC前瞻科技论坛中,现场座无虚席,显示不少业界人士对于先进的封装技术相当有兴趣。担任开场演讲的日月光集团研发处总经理唐和明表示,过去几年来,3D IC的技术发展迅速,现今3D IC的时代已经来临,包括镜头模块用影像传感器已导入3D IC,并开始量产,预期未来到2012~2015年此技术将会扩及到CPU、基频IC、手机芯片IC等领域,在此3年内3D IC的技术将会进入成熟阶段。
唐和明表示,随著消费性电子产品走向轻薄且功能复杂化,但晶粒的设计却不能无限放大。以台北信义区土地为例,在有限的土地面积上,可以兴建101的世界高楼,3D IC的设计就是立体堆叠的概念。把晶粒磨得很薄之后,在上面放上1、2颗的IC,可达到体积缩小、功能放大的效果。随著摩尔定律放缓,SoC技术会继续走下去,而SiP应用也会愈來愈多,2者会相辅相成。
随后接棒发表演说的Gartner半导体研究的首度分析师Mark Stromberg表示,有很多封装设计可以藉TSV以达到最佳电讯传输效率。结合TSV技术在晶圆厚度方向的优点,3D IC SiP封装技术不仅产品上市时间快于SoC,也可提供与SoC互相搭配的封装解决方案。
Stromberg并预估TSV到2013年的全球产值约140亿~170亿美元,占全球装置市场的比重约5~6%,其中到2013年存储器应用TSV的产值约40亿~50亿美元。目前采用TSV最大宗的装置应用为微机电(MEMS)和影像传感器,预期到2010年采用范围可以扩大至DSP、NAND Flash、DRAM、RF和通讯IC等,2011年将可延伸到绘图芯片、电源供应器和功率放大器等。
Stromberg认为,TSV目前仍面临多方挑战,包括测试、3D CAD Tools、材料、设备等,但这也是另一波的商机。他预估TSV设备2013年产值约为12亿美元。



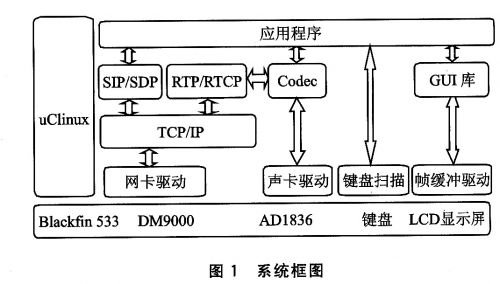


评论