SoC与SiP各有千秋 两者之争仍将继续
对生命周期相对较长的产品来说,SoC将继续作为许多产品的核心;而若对产品开发周期要求高、生命周期短、面积小、灵活性较高,则应使用SiP。
现代集成技术已经远远超越了过去40年中一直以摩尔定律发展的CMOS(互补金属氧化物半导体)工艺。人们正在为低成本无源元件集成和MEMS(微机电系统)传感器、开关和振荡器等电器元件开发新的基于硅晶的技术。这意味着与集成到传统CMOS芯片相比,可以把更多的功能放到SiP封装(系统级封装)中,这些新技术并不会替代CMOS芯片,而只是作为补充。
如果没有足够的理由使用SiP,SoC将继续作为许多产品的核心,尤其是对生命周期相对较长的产品来说。若对产品开发周期要求高、生命周期短、面积小、灵活性较高,则应使用SiP。SiP的另一个应用领域是那些采用高级CMOS不能简单实现所需功能的产品,如MEMS和传感器应用,以及要求有完整的系统解决方案的产品。
SiP缩短产品开发周期
在国际半导体技术路线图(ITRS)的推动下,摩尔定律的预言一再地被半导体行业的技术进步所印证,而CMOS工艺则一直是实现芯片晶体管时密度最高、成本最低的半导体工艺。如果产品能用CMOS工艺来制造,而且设计速度足够快,能够满足产品开发周期期限并实现大批量销售,那么系统级芯片(SoC)几乎总是最便宜、体积最小的解决方案。
例如,65nmCMOS工艺能将80万门电路封装到1mm 2的芯片上,45nm CMOS工艺则已经把160万门电路封装到1mm 2的芯片上。在成本方面,先进的 CMOSSoC,如NXP为汽车无线电或数字电视处理器开发的数字信号处理集成电路,实现了先进的多媒体功能,价格却只有几美元。
此外,CMOS不再局限于数字系统。最新的CMOSIP(半导体知识产权)库提供了广泛的系列模拟信号和混合信号功能,另外还将提供RF(射频)功能,可以把完整的RF功能集成到SoC中。
除其他因素外,数字功能、模拟功能、RF功能和存储功能是否集成到SoC中很大程度上取决于市场对产品设计周期的要求。在日新月异的移动通信市场中,产品周期短,满足产品开发周期至关重要。
在理想情况下,客户青睐于真正的即插即用元件,这些元件能得到可复制的参考设计支持,这使得SiP解决方案非常流行。根据客户的需要,客户只要改变一个或几个IC(集成电路)芯片,其他IC保持不变,就可以实现新产品。
如果要追求更低的成本,当然也可以把这些单个的IC芯片集成到SoC中,但这需要时间。将若干单独的芯片封装在一起,不仅提供了灵活性,而且降低了基板面积,因为芯片可以层叠在一起。这些功能在移动通信市场中具有重要意义。
例如,NXPNFC(近距离无线通讯技术)PN65N就是移动通信产品中使用的一种SiP。一个NFC控制器集成电路和一个安全控制器集成电路层叠在一起,中间有一个硅晶垫圈。之所以选择SiP,是基于产品开发周期、灵活性和降低面积等因素考虑。在家庭市场和汽车市场中,产品生命周期和设计周期比较长,许多产品使用SoC。大型SoC可能需要几个月的设计工时。但是,如果市场足够大,寿命足够长,那么可以持续开发SoC版本,根据客户需求来降低系统成本。
两种技术各有千秋
如果SiP解决方案比SoC解决方案便宜,那么即使家庭市场和汽车市场也会使用SiP解决方案。例如,假设一个系统包含一个CPU(中央处理器)、多个硬件加速单元和大量的DRAM(动态随机存储器),尽管仅仅通过基本的CMOS工艺就能制造DRAM,但为了有效地利用芯片面积,需要增加光刻次数,这就会明显地提高芯片制造的成本。
大型存储器通常使用优化的工艺技术制成,这意味着存储器和系统其余部分之间在生产技术方面有着明显的差异。因此,双芯片解决方案可能会变得很有吸引力,其中一个是CPU和硬件加速器芯片,另一个是DRAM芯片,使用层堆晶粒或PoP(堆叠封装)方法将这两颗芯片封装在一起。正是在这类技术划分中,理论上两种晶粒都可以在CMOS工艺中实现,所以才出现了今天的SiP与SoC之争。
系统使用SoC方案还是SiP方案,不仅取决于工艺技术的差异,而且还受到大量其他因素的影响,如成本、性能、尺寸、可靠性和设计难度。有意思的是,不一定因为系统能够在单个CMOS工艺技术中得以实现,就要使用这种技术实现这个系统,还需要考虑其他因素。
如果技术划分是所有SiP的核心,那么生产经济的高性能SiP的关键是正确实现这种技术划分,这要求在系统结构上全面了解应用,以便考察把某种功能从一种技术实现方式转到另一种方式所产生的后果。
在这里,拥有广泛工艺技术的半导体制造商有着明显的优势,因为他们可以专门设计SiP的各个元件,进而来适应选定的结构。从不同制造商采购元件的模块制造商则不可避免地会丧失这些元件设计的部分控制能力,从而使实现系统划分的难度大大提高。
如果产品开发周期要求紧,且SiP提供的解决方案比SoC便宜,最好采用SiP解决方案。更重要的是,SiP实现了完整的系统解决方案,而高集成的CMOSSoC则略逊一筹,如数字系统经常需要外部元件,如解耦电容、频率参考晶体、定时电容和静电放电保护网络。例如,集成了RF收发器的SoC可能仍需要天线开关和滤波器等外部元件,我们必须设计并把这些元件组装到印刷电路板上。而有了SiP,所有这些功能都可以集成到一个封装中,而其能否实现只是取决于最终产品中提供的空间和成本。SiP占用的空间通常比较少,但在大多数情况下成本要高于使用分立元件。
面临各自封装技术挑战
如前所述,转向SiP解决方案必须有强有力的理由,不管这些理由是缩短产品开发周期、提高集成度、提高灵活性、减少面积还是降低成本。与生活中大多数东西一样,SiP不只是拥有优势,它们也带来了许多挑战,最常被提及的一个就是其要求KGD(良裸晶)。
通过把一批IC和不同的元件安装到传统基板上实现系统,如印刷电路板,可以相对容易地确定和更换任何有问题的元件。如果把所有这些元件嵌入到SiP中,那么确定和更换问题元件则不会那么容易。也就是说,如果发现组装的SiP有问题,那么其中的所有附加值就会失效。
使这种问题减到最小的最佳方式是在组装前100%预先测试SiP的所有元件,与传统IC制造和封装相比,其带来的晶圆探测和测试负担大大提高。这是许多应用中引入堆叠封装(PoP)式SiP的原因之一,如处理器/DRAM组合,因为处理器和DRAM以一种可测试的封装形式存在,然后才把两个分立的封装熔接到一个PoP式SiP中。
在封装要求上,SoC和SiP都面临着各自的挑战。在SiP中,多个晶粒需要组合到一个封装中,可以使用的技术有并排引线键合、层叠晶粒、双倒装芯片技术或引线键合与倒装芯片互联技术相结合。具有挑战性的技术包括加工和分拣超薄晶粒、悬挂晶粒上引线键合和低环引线键合以及新的晶粒黏合技术,如引线覆膜。
除现有技术外,业内正在开发许多新技术。大多数技术进一步改善了小型化和性能,如把晶粒内嵌到模块或封装内插板中,以及带有通孔硅晶通路的3DIC技术。SoC也面临着晶粒尺寸提高和焊盘间隙下降的挑战。最大的挑战在于,由于使用超低K电介质,晶粒变得更脆、更易碎,进而需要更细的引线,在引线键合时要特别小心,以避免损坏晶粒。另外必需调整全套材料,如浇铸化合物以处理这些易碎晶粒。倒装芯片SoC的主要问题是间隙下降及大晶粒的可靠性问题。
电磁炉相关文章:电磁炉原理







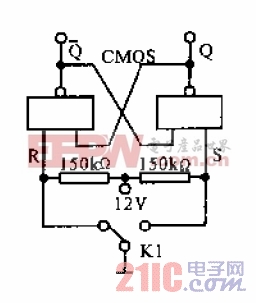

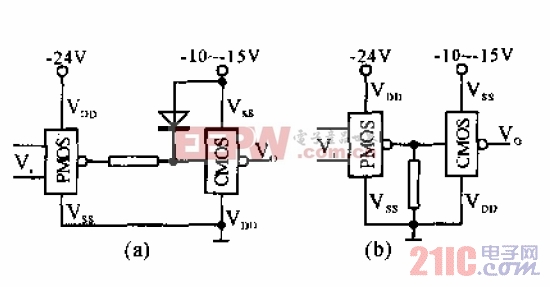

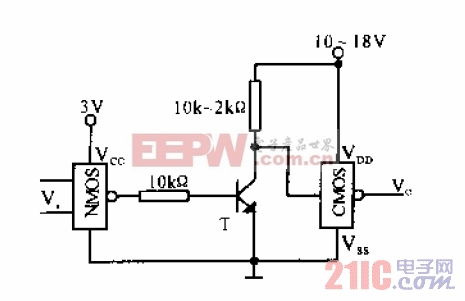

评论