KLA-Tencor 为晶片厂推出光罩检查系统的全新 TeraFab 系列
KLA-Tencor 公司推出了全新系列的光罩检查系统,为晶片厂提供更灵活的配置方式,以检验进货的光罩,并检查生产光罩是否存在会降低产能并增加生产风险的污染物。TeraFab 系统提供了三种基本配置,以满足逻辑集成电路和内存晶片厂及不同代光罩的特殊检查要求。这些配置为芯片制造商提供了极具成本效益的光罩质量控制的先进工具。
本文引用地址:http://www.eepw.com.cn/article/80083.htmKLA-Tencor 的光罩和光掩模检查部的副总裁兼总经理 Harold Lehon 表示:“在先进的晶片厂中,累积光罩污染物缺陷是一个复杂的问题,因为这些污染物有多种来源。65 纳米及更小尺寸光罩污染物的增加会造成严重的产能风险。由于提高光罩可靠性是业界关键的优先指标,我们正与全球客户一同合作开发兼具高灵敏度和成本效益的光罩污染物检查方案。我们全新的 TeraFab 光罩检查系统在检测算法技术方面取得了重要突破,可大幅降低产能损失,同时让客户能够根据其特定要求来选择正确的检测性能组合,从而获得更高的检查效率和更低的总体拥有成本。”
全新的 TeraFab 系统采用最近极成功的 STARlight2 技术上的算法突破,拓展了 KLA-Tencor 市场领先的 TeraScan 平台。STARlight2 可检测出生产光罩上的晶体生长和累积缺陷,这些缺陷是晶片产能的致命杀手,会随着时间的推移而对器件的性能和可靠性造成重大影响。全新的 STARlight2+ (SL2+) 算法改善了 STARlight 检测技术,可以顺利进行 65 纳米和 45 纳米级的生产,以及 32 纳米级的开发。
SL2+ 算法的优点可在系统的所有多像素尺寸中使用,包括让 STARlight最小最先进的 72 纳米像素, 因此能针对大范围的技术节点进行检查。与其上一代算法相比,SL2+ 算法技术可找到更大及更小的缺陷。它还允许通过基于同等灵敏度有效使用更大的像素以提高产能,在给定的应用中,它可将检查时间缩短将近一半。
TeraFab 系统系列包括:
TeraFab SLQ-1X 是 Terafab 系统中具有最低拥有成本 (CoO) 和最高易用性 (EOU) 的产品。SLQ-1X 可处理逻辑晶片厂重检应用中常用的单晶检查,并可达到较高的产能和较低的拥有成本。该系统包括最新 SL2+ 算法的诸多优点,如有必要,还可延伸至更小的像素。透过以出色的拥有成本提供快速易用的光罩重检中的通过/失败信息,芯片制造商现在可以极具成本效益的方式来实施直接光罩检查,以增加取样率,或避免未执行检查的风险。
TeraFab Q-3X 是用于多晶重检和外来原料质量控制 (IQC) 应用中的专用系统,常在内存(包括闪存)晶片厂中使用。该系统的高效运行意味着其拥有成本比以前的系统更低,且其灵敏度较高,因此能够检查 45 纳米级的内存光罩是否存在污染物。Q-3X 系统具备良好的灵敏度和性能,适合需要晶粒到晶粒范围的晶片厂使用,它可提供现有的检测性能、可扩展性和拥有成本的最佳组合。
TeraFab SLQ-2X – 此系统主要适用于逻辑集成电路客户,它包含最新及最先进的技术,采用了全新的 STARlight2+ 算法,并具有最小的像素,能达到最高灵敏度,可满足最先进晶片厂最广泛的应用系列之需。它同样适用于 IQC 或光罩重检使用案例。SLQ-2X 具备 32 纳米开发所需的灵敏度,是最灵活、最高性能的 TeraFab 系统。
TeraFab 系统目前正在日本、台湾和欧洲等领先的 45 纳米级逻辑集成电路和内存晶片厂进行 beta 测试与评估。






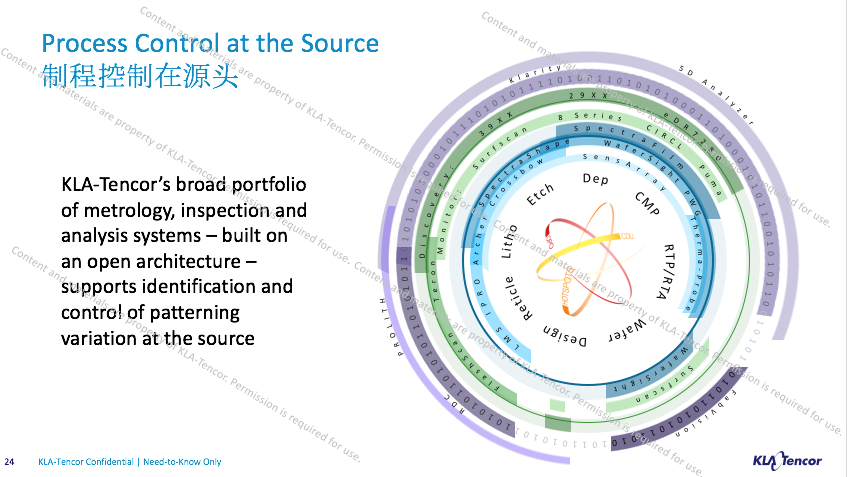

评论