应用材料公司推出全新SEMVision G4缺陷再检测系统
近日,应用材料公司推出最先进的缺陷再检测SEM(扫描电子显微镜)SEMVision™ G4系统,它将应用材料公司非常成功的SEMVision系统的技术和生产能力提升到45纳米及更小的技术节点。SEMVision G4系统的关键在于全新的SEM聚焦离子枪技术和增强的多视角SEM成像系统(MPSI),他们具有卓越的2纳米物理精度,能提供无与伦比的成像质量,其每秒一个缺陷的检测速度也设定了新的基准。
应用材料公司工艺诊断和控制事业部SEM部门总经理Ronen Benzion表示:“45纳米存储器和逻辑芯片具有深高宽比和高密集度,因此高可靠性和高生产力的缺陷再检测及分类对SEM的表现提出了前所未有的要求。SEMVision G4系统为成像质量和生产能力设定了新的标准,同时带来了新技术使客户加速缺陷根源成因分析并大幅提升成品率。”
东芝集团半导体公司四日市分公司制造工程部资深经理Tomoharu Watanabe表示:“SEMVision G4系统已于近期投入生产,我们期待它能够在线上缺陷根源成因分析的应用上起到重要的作用。
SEMVision G4系统把一些工程分析层面上先进的监测能力引入到大规模制造上。这些至关重要的分析工具使客户能够在最敏感的器件层,例如浸没式光刻胶和低K电介质层,快速地对最小达30纳米的缺陷进行分析和分类。SEMVision G4所具有的EDXtreme是一种革命性的基于EDX(能量色散X射线能谱分析)的材料分析功能,它把系统提升至能对亚50纳米的微粒作出缺陷化学特征描述。该系统全新的SEM聚焦离子枪能够旋转并同硅片形成最大为45%的夹角,提供完全的三维数据,从而实现卓越的缺陷成像和分类。此外,硅片边缘和bevel斜面分析技术进一步提高了成品率,使客户成功应对浸没式光刻相关的缺陷问题。


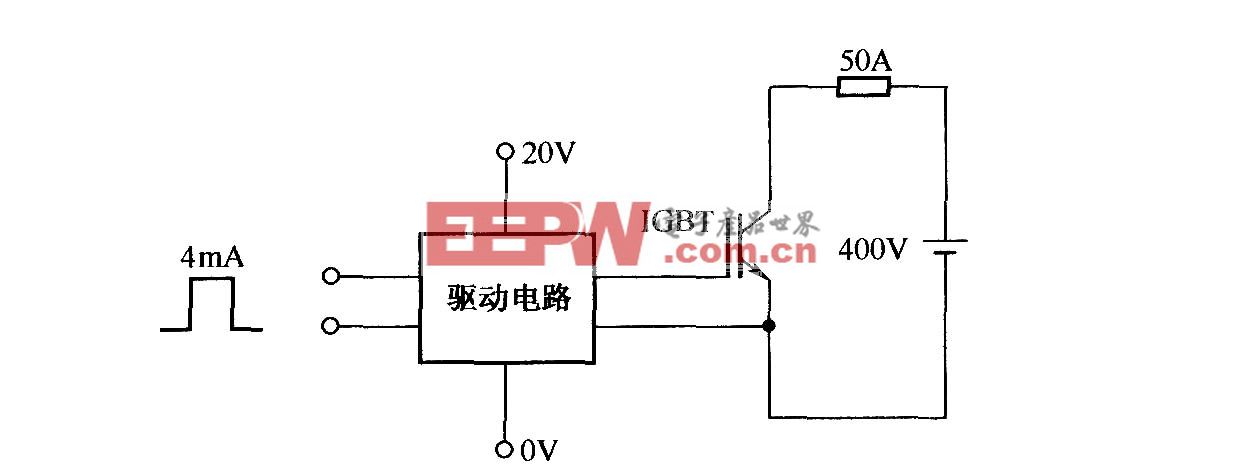


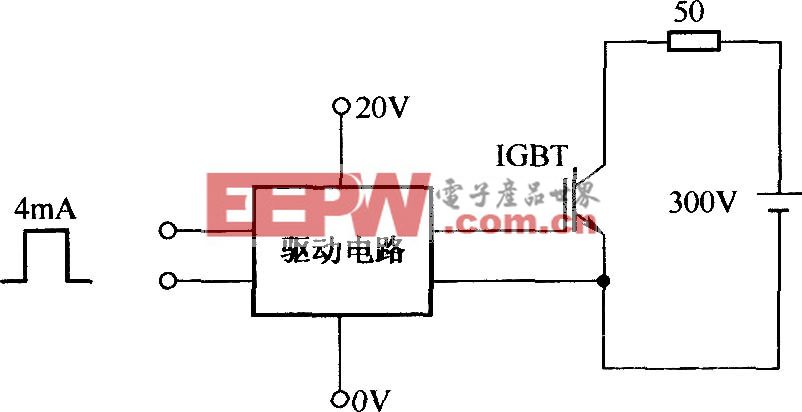








评论