应对65nm以下测量技术挑战
扫描探针显微镜(SPM)已经应用在纳米技术和纳米科学中,主要包括以结构、机械、磁性、形貌、电学、化学、生物、工程等为基础的研究和工业应用。原子力显微镜(AFM)是以显微力感应为基础的SPM家族的一个分枝。工业用AFM是一种自动的,由菜单驱动的在线生产测量机台,自动的硅片操作、对准、探针操作、位置寻找、抓图和图像数据分析等测量都被编程在菜单中,最终输出测量数据。值得一提的是,AFM作为130纳米及以下技术结点中表征刻蚀和化学机械抛光(CMP)的尺寸测量的先进几何控制方法已经被广泛应用于半导体制造业,与半导体工业工艺技术类似,光掩膜和薄膜为主的工业也采用了AFM作为工艺测量方法。
AFM可以测量表面形貌、3D尺寸和几何形状,水平表面轮廓和垂直侧壁形状轮廓。测量区域可以在很小(50μm)或很长(10cm)的范围内。采用小比例AFM模式,可测量的变量有高度或深度、线宽、线宽变化、线边缘粗糙度、间距、侧壁角度、侧壁粗糙度、横截面轮廓、和表面粗糙度。在长范围(Profiler模式),AFM用于CMP工艺总体表面形貌轮廓的测量。
AFM测量的优点
除AFM以外,CD SEM、横截面SEM(X-SEM), TEM、Dual Beam、光学散射测量、光学轮廓仪和探针轮廓仪均为已有的表征和监控工艺尺寸的测量方法。通常认为最值得信任的3D尺寸分析方法应该是X-SEM或TEM,但是X-SEM或TEM的主要障碍是样品制备、机台操作、时间以及费用。X-SEM和TEM会破坏硅片,并且只能一次性的切入特征区域。TEM不能在光刻胶上工作。CD SEM会导致光刻胶吸收电荷、收缩、甚至损伤光刻胶, CD SEM几乎无法提供3D形状信息。光学散射测量具有快速和准确的特点,但是只能在特殊设计的结构上工作,并且无法提供LER和LWR数据。为特定的薄膜结构发展一套可靠的散射测量数据库通常是非常困难并且耗时的。空间分辨率和光斑尺寸会限制X射线、光学厚度、或形貌测定仪器的应用。
由于AFM的独特特性,使得它与其它测量技术相比具有更明显的优势。AFM可以在非真空环境中工作。它是一种表面力感应的显微镜,所以它可以提供非破坏性的,直接的3D测量,胜于模拟、模型、或者推断。AFM可以快速的检查横截面轮廓或表面形貌,以便检测出尺寸是否在规格内,而不需像TEM一样破坏制品。AFM没有光斑尺寸限制,并且在CMP平坦化应用方面,它比光学或探针轮廓仪具有更高的分辨率。
AFM可以在线测量当今纳米电子工业中的任何材料样品,不管其薄膜层结构、光学特性或是组成。AFM对于最新的先进工艺和材料集成中涌现出来的新材料(SiGe、高K、金属栅和低K)并不敏感。电路图案的逼真度和尺寸取决于其附近的环境。然而,AFM测量与特征接近度或图形密度效应之间没有偏差,这些都是ITRS2005测量部分所列出的重要要求。因此,AFM在世界半导体工业赢得了广泛应用,并且其在130纳米及更小尺寸中的应用正在增加。在应用目的方面,AFM可以被用为在线监控深度、CD和轮廓,取代TEM进行横截面轮廓的工程分析,是在线散射测量和CD校准以及追踪的极好的参考。表1为自动AFM测量的典型应用。
操作原理
在一个反馈控制回路中,AFM扫描仪控制一个微小探针在X(或Y)和Z方向进行扫描,在探针和样品表面间保持紧密的接近,从而获得所有XY和Z方向的高分辨率方位数据,如图1所示。

3D形貌的原始数据是由x/y/z空间数据构造而来的。然后,离线的软件分析使探头形状不再环绕AFM图像并且提取出测量目标相关的重要几何参数,如深度、 特定区域顶部/中间/底部的线宽、 侧壁角度和轮廓形状、 或表面形貌。
STI刻蚀
浅沟槽隔离(STI)是逻辑、 DRAM和Flash等硅器件中的一种普通工艺。STI形成晶体管中的活性硅区域和隔离氧化物区域。AFM在STI刻蚀深度、线宽、CD和侧壁轮廓测量方面有着独特的应用。图2展示了与TEM横截面相比典型的AFM轮廓。从比较中可以说明,AFM在表征窄深的STI沟槽全3D几何形状方面取代了冗长和高耗费的TEM,STI沟槽在活性硅区域顶部通常有一层氮化物作为硬掩膜,CD SEM通常很难准确测量从氮化物到硅转换区域的硅的CD。高分辨率的AFM可以扫描出这个转换点,可以在转换位置编程出图象分析,从而计算氮化物底部CD和硅顶部的CD。AFM可以对整片硅片进行快速非破坏性的描绘,而X-SEM和TEM是无法做到的。沟槽侧壁角度(SWA)的微小变化会引起最终图形特征上线宽的巨大变化,AFM为高深宽比的STI沟槽提供了非破坏性及高精度的SWA表征。
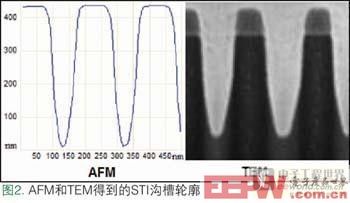
STI CMP
STI模块进行化学机械抛光(CMP)和湿法氮化物去除以后,产生了多样化的表面以及在活性区域及附近场氧化物区域的高度差(图3)。硅片内实际电路区域的局部形貌变化是一个非常关键的参数。晶体管电学失效与较大的或反向的活性硅与场氧化物之间的步高差相关,CMP形貌取决于特征尺寸和图形密度。然而,芯片内不同特征之间的步高相关性很差,这再一次证明了传统的椭偏法和散射测量法在测量划片区域里大块的测试结构以反映芯片内真实的电路形貌时已存在不足。AFM是一种在线测量技术,可以在任何需要的测试点进行快速的和非破坏性的芯片内形貌监控。
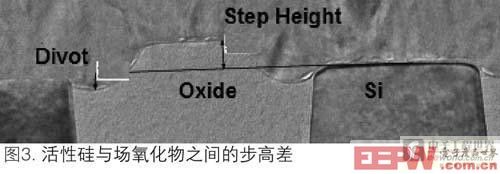
AFM可以检测和测量出由于硅片边缘不均匀的抛光速率造成的反向的硅/氧化物步高(图4),图4展示了氮化物去除后活性区域和隔离区域交界处氧化物的转换,以及何种转换会影响晶体管的阈值电压。AFM对转换轮廓非常敏感,并且转换深度可以得到监控。

多晶硅凹槽反刻
在DRAM制造的沟槽电容形成过程中,会有一个深沟槽被多晶硅填充,然后经过几次反刻形成多晶硅凹槽。凹槽深度的控制非常关键,以确保正确的器件功能。AFM是直接在存储器列单元上测量凹槽深度的首选,应用如图5所示的一种被称为“间距扫描”的方法,AFM可以对每个点的多个凹槽孔进行快速测量。芯片内AFM测量可以在小于一个小时的时间内对整片硅片进行多点扫描。凹槽底部通常会有一个具有洞状的锥形轮廓(图6)。从直到倾斜的侧壁的过渡部分被称为“肩部”,TEM和XSEM经常被用来测量过渡部分和肩部高度。AFM是取代TEM或X-SEM来测量沟槽轮廓、总体沟槽深度和肩部高度的理想选择,并且具有极高的精确度。


当DRAM技术节点达到90纳米以下时,凹槽孔变得非常浅和狭窄。这为在线光学技术提出了重大的挑战,因为在线光学技术很难得到可靠的和精确的模型和模拟。然而,更小的AFM探针可以持续的提供准确的凹槽测量。
栅刻蚀
多晶硅或金属栅的CD和轮廓控制对无缺陷和高性能晶体管来说最为关键。X-SEM和TEM非常耗时,硅片必须废弃,并且只能提供有限的统计数据。由于具有高精确度和快速的产量,光学散射测量作为栅刻蚀的首选CD测量方法赢得了广泛的使用。然而,散射测量依赖于光谱数据库中进行模拟和建模。准确度和精确度受到诸如多晶硅/外围粗糙度、薄膜组成和厚度等诸多工艺变化的影响。对于复杂的栅结构来说,建立一个散射测量数据库需要几周甚至几个月,散射测量只能测量特殊设计的光栅,而不能被用来表征诸如芯片内存储器单元或逻辑电路的任意特征。另外,散射测量不能测量诸如抗反射或硬掩膜层的非反射物质。
AFM可以提供任何材料上芯片内任意位置的无偏差和直接的测量,并且可以作为在线监控机台或进行散射测量校正和数据库优化的参考测量方法。SAFM测量方法的优点是CD和轮廓的多重关键几何测量可以直接从单独的AFM扫描图象中抽取出来,而不需建立光学模型。多晶硅栅的LER和LER数据可以帮助优化图形和刻蚀条件。另一个例子是测量p-MOS和n-MOS之间, 隔离的和密集的栅线之间核心的输入和输出之间的CD补偿值。如图7所示,AFM也可以直接扫描真实电路特征来进行SRAM存储器上非破坏性的3D几何形貌失效分析,并且很少出错。
在栅刻蚀工艺发展初期,工程师需要明白刻蚀和光刻条件对最终栅侧壁轮廓的影响。工程师们经常希望能在同一片硅片上进行连续实验,而不是将硅片废弃。AFM可以在CD扫描模式下进行非破坏性的横截面轮廓扫描,方便工程师快速地判断多晶硅轮廓和优化刻蚀或光刻工艺条件。
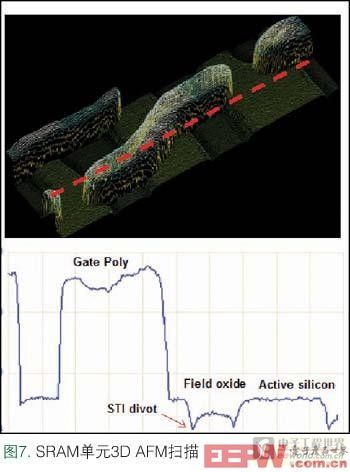
栅侧墙
栅侧墙是栅刻蚀后淀积在侧壁的氮化物或氧化物薄膜,为源漏注入提供阻挡。由于AFM特有的图形识别能力,它可以在连续的工艺步骤中精确的将针头放置于同一片硅片的同一个点,测量者运用AFM扫描栅刻蚀后和稍后的栅侧墙刻蚀后的同一处栅线,从而得到每一步工艺的CD和轮廓数据(图8)。量测的差值很方便的给出了介质侧墙的厚度和轮廓,并具有绝对精确度。因此,我们采用AFM沿栅侧墙测量薄膜厚度,以确保沿垂直的侧墙覆盖的薄膜具有连续性,这种方法可以引伸到后道铜晶仔或沟槽或通孔侧壁的原子层淀积阻挡层厚度的测量。
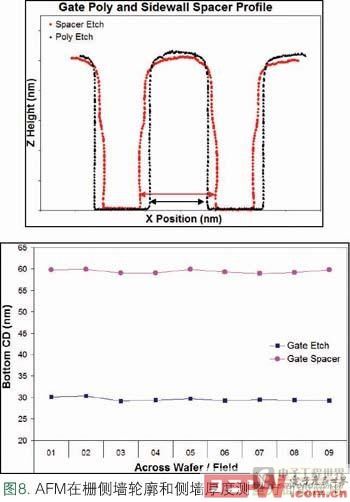
结论
65纳米及以下的集成微电子器件的尺寸测量方法是业界挑战之一。AFM为半导体(逻辑和存储器)制造中关键前道工艺监控提供了在线和参考测量方法的有益的解决方案。AFM可以扫描电路的任意区域和各种材料,对数据进行解释时不需要任何建模和臆测。在某些情况下,AFM在横截面轮廓和形状分析方面可以取代X-SEM、TEM或Dual Beam。AFM可以在多片硅片的多个点对一个特征进行多线的同时扫描,从而搜集足够的统计数据进行特征与特征间、芯片与芯片间、硅片与硅片间、以及批次与批次间的评价、它为在线工艺控制提供了直接的芯片内测量。
由于它的绝对准确性,AFM可以被用作极好的参考标准来校正其它尺寸测量方法,从而建立起追踪链和已知的不确定的预算。CD AFM经常被用作有口皆碑的CD测量方法以保持和在线光学散射测量和CD SEM之间的校准,并且可以加快散射测量数据库的发展。以AFM为基础的参考测量系统使得世界范围内的不同工厂之间的测量机台匹配得以实现,确保Fab1的30纳米确实等同于Fab2的30纳米。
特征空间大小是对AFM的一个限制,只有当空间足够大并使得探针可以伸入进行扫描时AFM才能够工作,当沟槽空间窄于探针直径时AFM无法进行扫描。随着AFM探针技术的进一步发展,已经有能够测量窄空间和很大纵宽比的更小针头出现。




评论