一文读懂晶体生长和晶圆制备
有了之前的介绍,相信大家对晶圆在半导体产业中的作用有了一个清晰的认识。那么,自然而然地,一个疑问就冒出来了:晶圆是如何生长的?又是如何制备的呢?本节小编将为大家一一道来。
本文引用地址:http://www.eepw.com.cn/article/201807/382757.htm本节的主要内容有:沙子转变为半导体级硅的制备,再将其转变成晶体和晶圆,以及生产抛光晶圆要求的工艺步骤。这其中包括了用于制造操作晶圆的不同类型的描述。生长450mm直径的晶体和450mm晶圆的制备存在的挑战性。
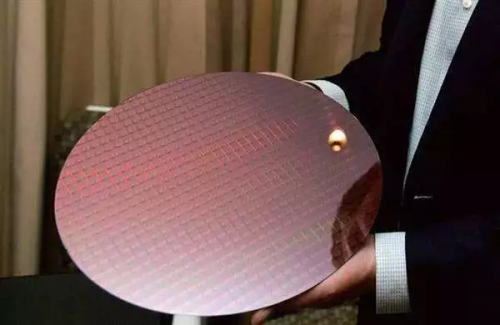
更高密度和更大尺寸芯片的发展需要更大直径的晶圆供应。在20世纪60年代开始使用的1英寸直径的晶圆。在21世纪前期业界转向300mm(12英寸)直径的晶圆而现在正转向450mm(18英寸)领域。
更大直径的晶圆是由不断降低芯片成本的要求驱动的。这对晶体制备的挑战是巨大的。在晶体生长中,晶体结构和电学性能的一致性及污染问题是一个挑战。在晶圆制备、平坦性、直径控制和晶体完整性方面都是问题。更大直径意味着更大的质量,这就需要更坚固的工艺设备,并最终完全自动化。一个直径300mm的晶圆生产坯质大约是20磅(7.5kg)并会有50万美元以上的产值。

一个450mm的晶圆质量约800kg,长210cm。这些挑战和几乎每一个参数更高的工艺规格要求共存。与挑战并进和提供更大直径晶圆是芯片制造不断进步的关键。然而,转向更大直径的晶圆是昂贵和费时的。因此,随着产业进入更大直径的晶圆,一些公司仍在使用较小直径的晶圆。
半导体硅制备
半导体器件和电路在半导体材料晶圆的表层形成,半导体材料通常是硅。这些晶圆的杂质含量必须非常低,必须掺杂到指定的电阻率水平,必须是制定的晶体结构,必须是光学的平面,并达到许多机械及清洁度的规格要求。
制造集成电路级硅晶圆分4个阶段进行:
1. 矿石到高纯度气体的转变;
2. 气体到多晶的转变;
3. 多晶到单晶、掺杂晶棒的转变;
4. 晶棒到晶圆的制备。

半导体制备的第一个阶段是从泥土中选取和提纯半导体材料的原料。提纯从化学反应开始。对于硅,化学反应是从矿石到硅化物气体,例如四氟化硅或三氯硅烷。杂质,例如其他金属,留在矿石残渣里。硅化物再和氢反应生成半导体级的硅。这样的硅纯度达99.9999999%,是地球上最纯的物质之一。它有一种称为多晶或多晶硅的晶体结构。
晶体材料
材料中原子的组织结构是导致材料不同的一种方式。有些材料,例如硅和锗,原子在整个材料里重复排列成非常固定的结构,这种材料称为晶体。

原子没有固定的周期性排列的材料被称为非晶体或无定形。塑料就是无定形材料的例子。
晶体生长
半导体晶圆是从大块的半导体材料切割而来的。这种半导体材料,或称为硅锭,是从大块的具有多晶结构和未掺杂本征材料生长得来的。把多晶转变成一个大单晶,给予正确的定向和适量的N型或P型掺杂,叫做晶体生长。
使用三种不同的方法来生长单晶:直拉法、液体掩盖直拉法和区熔法。
晶体和晶圆质量
半导体器件需要高度完美的晶体。但是即使使用了最成熟的技术,完美的晶体还是得不到的。不完美,就称为晶体缺陷,会产生不均匀的二氧化硅膜生长、差的外延膜沉积、晶圆里不均匀的掺杂层,以及其他问题而导致工艺问题。在完成的器件中,晶体缺陷会引起有害的电流漏出,可能阻止器件在正常电压下工作。有四类重要的晶体缺陷:
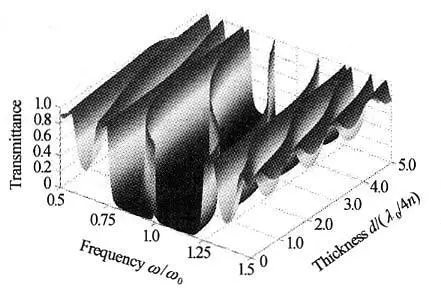
1. 点缺陷;
2. 位错;
3. 原生缺陷;
4. 杂质。
晶圆准备
晶体从单晶炉里出来以后,到最终的晶圆会经历一系列的步骤。第一步是用锯子截掉头尾。
在晶体生长过程中,整个晶体长度中直径是有偏差的。晶圆制造过程有各种各样的晶圆固定器和自动设备,需要严格的直径控制以减少晶圆翘曲和破碎。
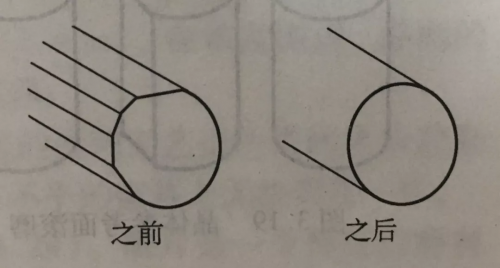
直径滚磨是在一个无中心的滚磨机上进行的机械操作。机器滚磨晶体到合适的直径,无须用一个固定的中心点夹持晶体在车床型的滚磨机上操作。
在晶体提交到下一步晶体准备前,必须要确定晶体是否达到定向和电阻率的规格要求。
切片
用有金刚石涂层的内圆刀片把晶圆从晶体上切下来。这些刀片是中心有圆孔的薄圆钢片。圆孔的内缘是切割边缘,用金刚石涂层。内圆刀片有硬度,但不用非常厚。

这些因素可减少刀口尺寸,也就减少了一定数量的晶体被切割工艺所浪费。
对于较大直径的晶圆(大于300mm),使用线切割来保证小锥度的平整表面和最小量的刀口损失。
晶圆刻号
就像我们生产好的高铁轨道一样,每一段上都要刻好工号,以对应相应的生产人,这样来保证产品的可追溯性。

同样的,大面积的晶圆在晶圆制造工艺中有很高的价值,为了保持精确的可追溯性,区别它们和防止误操作是必须的。因而使用条形码和数字矩阵码的激光刻号来区分它们。对300mm的晶圆,使用激光点是一致认同的方法。
磨片
半导体晶圆的表面要规则,且没有切割损伤,并要完全平整。第一个要求来自于很小的尺度制造器件的表面和次表面层。它们的尺寸在0.5~2um之间。为了获得半导体器件相对尺寸的概念,想象下图的剖面和房子一样高,大概8英尺(2.4m),在该范围内,晶圆的工作层都要在顶部有1~2英寸或更小的区域。
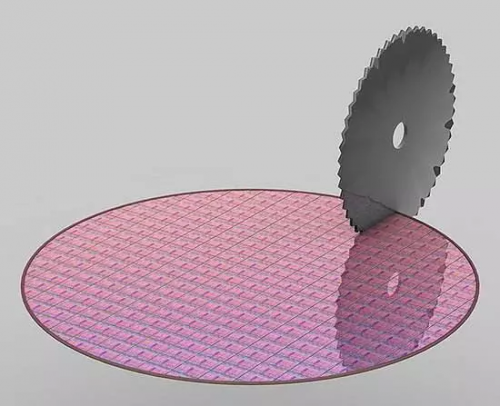
平整度是小尺寸图案绝对必要的条件。先进的光刻工艺把所需的图案投影到晶圆表面,如果表面不平,投影将会扭曲,就像电影图像在不平的荧幕上无法聚焦一样。
平整和抛光的工艺分两步:磨片和化学机械抛光。磨片是一个传统的磨料研磨工艺,精调到半导体使用的要求。磨片的主要目的是去除切片工艺残留的表面损伤。
至此,就生产出了表面平整的晶圆,但是这不是最后一步,在接下来的工序中,晶圆将会进行哪些工艺加工呢?小编将在下节为大家讲来,敬请关注!



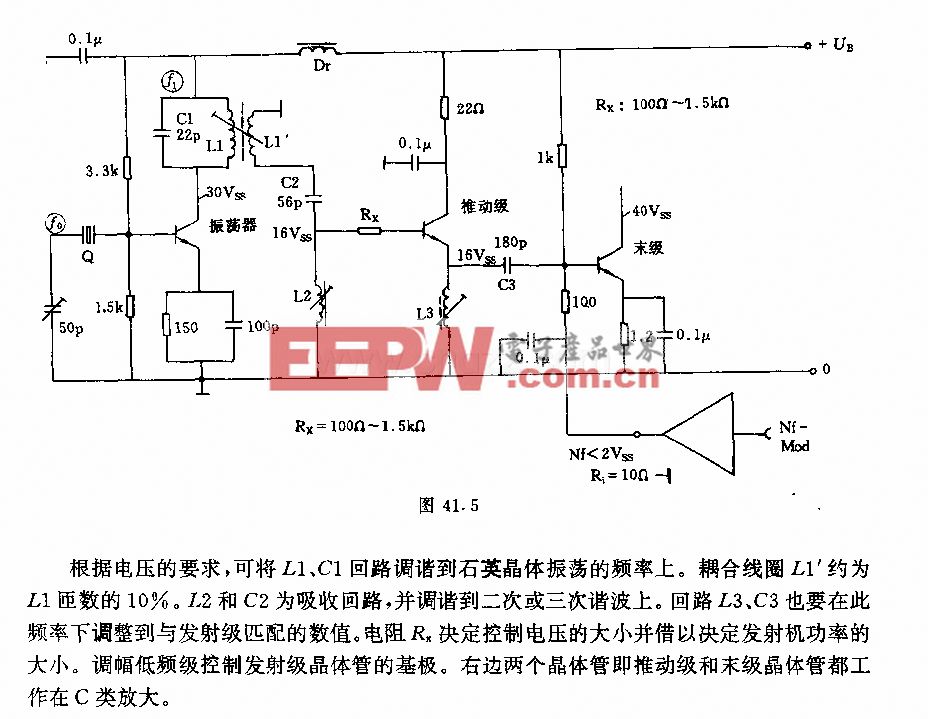


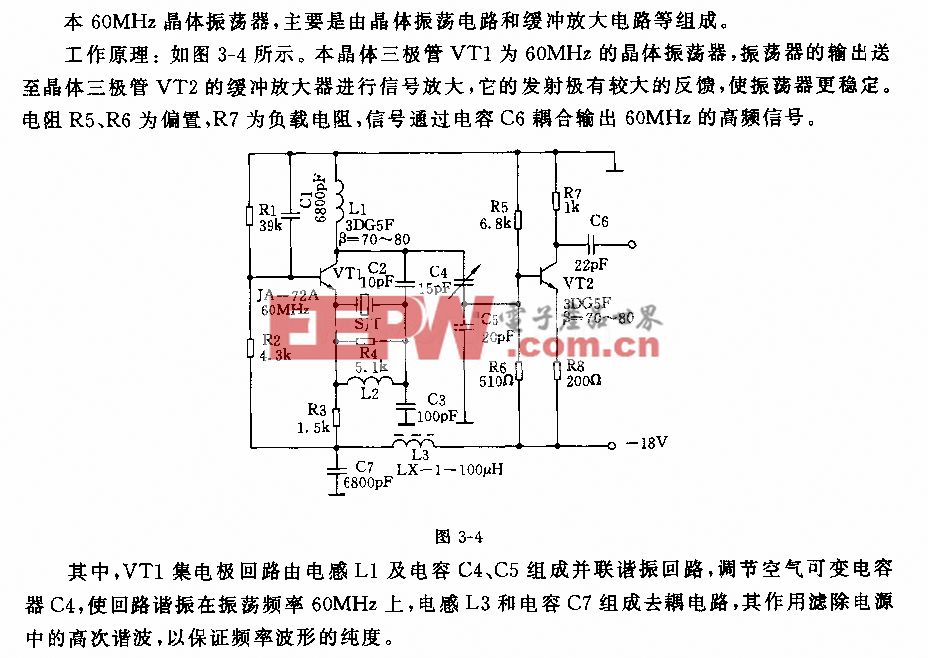

评论