基于Icepak的放大器芯片热设计与优化
摘要:针对微波电路A类放大器常用的功率放大器芯片,建立了芯片内部封装后的散热模型。基于热阻理论,在对放大器芯片等效热阻做热分析的基础上,采用Icepak对影响芯片散热的焊料层、垫盘、基板的材料和厚度进行优化,分析各个变量对芯片温度造成的影响,最后给出了高可靠性的芯片热设计结果。
本文引用地址:http://www.eepw.com.cn/article/201610/307093.htm在微波放大电路中,功率芯片是整个电路最为核心的部分。芯片中大量的半导体器件在工作时会产生大量的热量。芯片如果在封装过程中散热效率达不到要求的话,积累的热量会影响器件特性,甚至是毁坏器件造成电路失去功能。为了提高芯片的可靠性,必须进行热分析与热控制。Icepak作为一款专业的热分析软件,提供了系统级、板级到器件级不同类型的热分析平台,其求解过程基于fluent求解器,可以计算稳态和瞬态不同的过程。强大的后处理可以用云图直观地输出各个参量。相对于传统的热设计方案,基于Icepak的仿真优化设计方法可以节约成本和缩短研制修改周期,提高产品的一次成功率和提前上市时间。
文中在介绍热阻理论的基础上,详细地介绍了Icepak软件建模、网格划分、求解和后处理的过程。收集整理了改变焊层、垫板和基板的材料和厚度时芯片最高温度并分析原因,总结并给出最优化的热设计结果。
1 典型功率芯片封装结构和等效热阻模型
热流自芯片流向外部环境所受到阻碍称为热阻。也指1 W功率在传热路径上产生的温度差,其表达是表示为:
R=△T/P (1)
对于热导率为K,厚度为h,横截面积为S的物体热阻:
R=h/(K*S) (2)
图1是此功率芯片封装和散热结构示意图。芯片成品封装以后,芯片、垫板、基板和壳体通过焊料紧密连接在一起。半导体裸芯片满负荷工作时的内热阻Rjc可以由生产商提供的手册查到,本文主要通过改变焊料、垫盘和基板的材料和厚度进行优化,减小芯片的外部热阻Rout使得芯片可以适应更加复杂的热环境,以达到结构和工艺最优化的目的。

对流和辐射对于芯片产生的热量散热贡献很小,所以优化过程中我们只考虑热传导过程。芯片的边长为11,焊料层厚度为h1,垫盘厚度为h2,基板厚度为h3,由于厚度相比与横截面尺寸很小,我们取各层的上表面面积作为截面面积来计算热阻。根据式(2)我们可以得到从第一层焊料到基板底部焊料层的热阻为:

K1、K2、K3分别是焊料、垫盘和基板的导热系数。
由公式(3)我们可以得到在更换不同导热系数的材料和更改各层材料的厚度时候,都会对热阻产生影响。而通过优化使热阻达到最小可以令芯片在更高的环境温度下正常工作正是我们的目的。传统理论计算优化方法在面对复杂模型时工作量十分巨大,故本文采用ANAYS公司的Icepak软件作为优化设计工具。
2 Icepak建模
Icepak是专业的热设计软件,该软件提供了丰富的模型和材料库。并支持使用者新建材料。其提供的多变量优化计算可以对存在多个变量的模型自动优化,并可以定义多种输出函数来输出想要的结果。
图2是根据表1在Icepak中建立的简化模型并进行网格划分。由于芯片厚度Y远小于其X尺寸,所以在Y方向最小网格边长是X方向上的十分之一。

3 计算与优化
表格2给出了各个结构常用的材料和导热率。芯片热参数如下:焊料为铅锡合金,垫盘为钼铜合金,基板为铝硅碳材料。额定功率为4.5 W,内部热阻为7.8℃/W,芯片限制工作温度为150℃,所以外部热阻与芯片接触面允许达到的最高温度为:
Tcmax=150℃-7.8℃/W×4.5 W=114.9 ℃
保持焊料、垫盘和基板水平方向尺寸不发生变化,在工作环境为70℃时,通过改变厚度和材料时,Icepak优化计算结果整理如下:
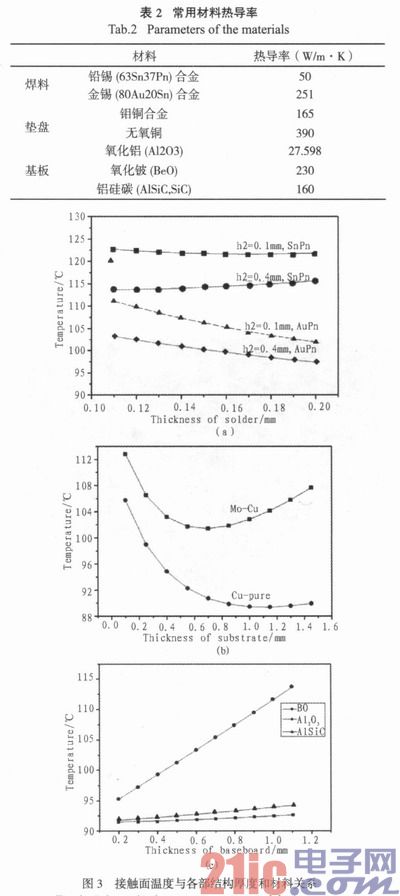
由图3(a)可知,对于金锡合金焊料,芯片温度随着焊料层厚度增加而降低,对于铅锡焊料,芯片温度随着焊料厚度增加增加。而且当铅锡焊料层厚度为0.1 mm时,芯片与接触免处温度超过115℃,相同情况采用金锡焊料芯片温度可以降低20℃;图3(b)指出其它条件不变时,温度随纯铜垫盘厚度增加而降低,铜片厚度为0.1 mm时,最低点为89 ℃,采用钼铜合金垫盘时温度随着钼铜厚度呈现先降低后升高的
情况,在钼铜厚度为0.7 mm,芯片有最低温度102℃;图3(b)可知芯片温度随着底板厚度增加温度呈上升趋势,不同类型底板上升速度不同,氧化铝型底板上升最快,铝硅碳其次,氧化钡型最慢。
4 优化结果
针对环境温度70℃恶劣工作条件,在保持原有放大器芯片水平尺寸不变时,IceDak通过优化焊料、垫盘和底板3个变量的厚度和材料得出了如下最优化结构。

图4指出在金锡焊料层厚为0.1 mm,纯铜垫盘厚度为0.8mm,底板厚度为0.5 mm时,芯片最高温度为87℃,与临界温度105℃还相差较大,芯片可在此温度高稳定性工作。
5 结束语
本次优化设计采用Icepak,在设定变量焊料、垫盘和底板的材料和变化范围之后,Icepak自动进行优化并保存了所有的计算结果,最后给出可以使芯片具有最低温度的结果。与以往芯片优化方法相比更智能,优化结果对于芯片封装厂商生产高性能芯片具有参考价值。


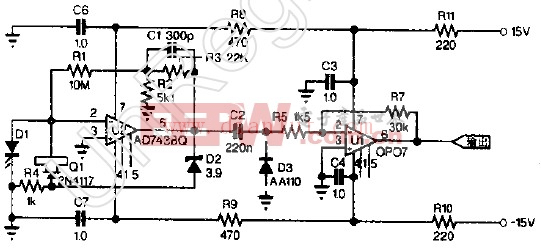
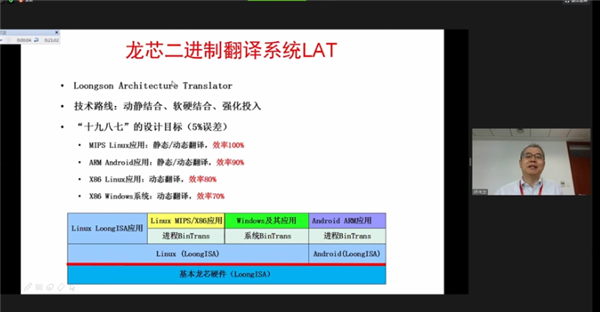




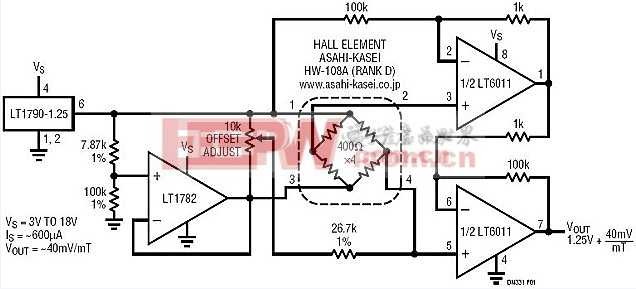

评论