流程改进提高效率IGBT为电机驱动应用
当选择的IGBT,设计者面临着一些架构选择,可以有利于IGBT的一种形式中,如对称与不对称阻塞,在另一个的。本文将回顾由不同的IGBT架构所提供的设计方案。
本文引用地址:http://www.eepw.com.cn/article/201609/303479.htm该绝缘栅双极晶体管(IGBT)是用于电机驱动应用由于其高阻断电压和低成本相比功率MOSFET具有类似额定电压的共同选择。该技术允许对可变频率的驱动器,其被视为好为节能系统的设计。
在IGBT提供需要用来驱动重要逆变器级的开关能力。通常情况下,一个600 V阻断电压等级是需要从200-240 VAC操作驱动器主电源,具有1200 V青睐于460 VAC的应用。
从功率MOSFET IGBT的结构演变在80年代期间,响应于需要增加的阻断电压。这是通过增加一个额外的PN结到MOSFET架构的漏极,形成双极晶体管结构和整体NPNP半导体实现。与目前制造大多数功率晶体管,该晶体管的结构是垂直的而不是水平的,与上述PNP双极性晶体管放置在管芯的背面侧的集电极。 AP或P +的浴盆,其中包含N掺杂阱连接的源极/发射极和栅极区。电流流经该浴池进入一个比较宽的N掺杂漂移区进入收集器。然而,因为它有一个MOSFET的绝缘栅,该装置作为一个整体保持电压控制而不是电流控制。互锁双极晶体管的增益需要被仔细控制以抑制操作作为NPNP晶闸管。
虽然它一般提供较高的电压隔离比的MOSFET,一个IGBT的架构意味着它不能切换为快,这限制了在逆变器中使用的开关频率,尽管在设备施工的最新进展已经推动有效开关频率向100千赫。效率的IGBT是由MOSFET的比低通态压降提高。此外,高电流密度可以更高的额定功率,以用更小的芯片比同等MOSET,从而提高了成本效益达到。
早期方法与IGBT包括设计的对称结构,也被称为反向阻断架构。这些同时具有正向和反向阻断能力,它们的适合于AC应用如基质(交流 - 交流)转换器或三电平逆变器。非对称结构仅保持正向阻断能力,但往往会被更广泛地采用比对称结构,因为它们通常提供比对称的IGBT低通态压降。非对称结构适合DC应用,如变速电动机控制。但是,IGBT的电机控制应用往往涉及电感性负载,并且通常硬开关,要求在IGBT并行使用与续流二极管,以允许反向电流流动在这些拓扑结构。然而,这种二极管通常会提供的性能比的等效功率MOSFET体二极管高。
另一个区别是的IGBT穿通(PT)和非穿通型(NPT)体系结构之间。在PT设计主要是用于降低隔离的电压和使用生长在P +基底和集电区的N +区域。当设备被关闭时,在N漂移变得完全耗尽载体,一个效果,即入在N +层下面,但不通过它完全到达进入收集“通过冲头”。其结果是一个非常薄的N区域,最大限度地减少接通电压。附加的N +层也改善了开关速度通过减少被注入到P +基底过量空穴的数目。当设备关闭,这些运营商正在迅速删除。
不幸的是,高掺杂引入大量需要的IGBT后取出关掉少数载流子,这增加了转换时间,并与在效率损失。这是一个主要的原因是较低的开关频率相比,功率MOSFET。 PT IGBT的也可以免受热失控受损。
该条约的开发是为了避免在PT架构的主要问题,并删除在N +缓冲层。然而,它们都经过精心设计,以避免让电场渗透一路通过向集电器。该晶体管通常由不同为PT装置。代替外延形成的N个区域上的P掺杂的衬底的顶部上的,NPT晶体管通常使用N掺杂衬底与生长在背面集电极区制成。
通过减薄晶圆,以100μm或更小,它可能使用一个非常-轻掺杂集电极区并且仍然实现低电阻和高的性能。使用更轻掺杂的减少,可以被存储在它导通时其转化为更好的开关性能,因为有较少的载波需要时,该设备被切换到被杀死器件,电荷量。
该FGP10N60和FGP15N60飞兆半导体利用NPT的技术支持一系列的电机驱动应用。他们提供短路电阻高达10微秒,在150℃下表现出约2 V的饱和电压支持高开关速度,晶体管展览刚刚超过55 ns的关断延迟时间。
制造商如国际整流器几乎十年前搬到一个沟槽结构。该沟槽结构不仅允许更高的通道密度通过降低栅极和基极区的有效直径,它增强堆积层的电荷注入,降低了寄生JFET从中旧平面设计受到的影响。对于给定的开关频率,该沟槽结构减少了传导和相对于传统的PT和NPT结构开关损耗。沟道IGBT现在是在一个大范围内许多厂商的评级可用。 IR自己的范围涵盖关键600 V和1200 V阻断电压范围。
一个典型的装置中,IRGB4060,是打包带软恢复反向二极管,并提供一个关断延迟时间缩短到95纳秒,以支持相对高的开关频率的为1.55V晶体管。
增加一个场终止区域,以一个薄晶圆NPT装置能够在性能上的几个进一步的改进。有点类似于在PT概念,该层站的电场,从而允许使用为同一高击穿电压的薄晶片。通过控制两个场阑和p +集电极层中的载流子浓度能够提高背面结的发射极效率。其结果是,场站提供具有低VCE的设备上更快的转换(饱和)成为可能,更薄的晶片。
场终止技术已经使得它更容易集成需要许多电路与IGBT本身的续流二极管。例子倒在TRENCHSTOP家庭英飞凌科技设备。许多家庭成员的形成二极管作为核心IGBT元件的一部分,通过该装置使反向电流导通。他人提供的应用,如电机控制由封装内集成二极管优化二极管技术,如IKD06N60RF,它支持的开关速度为电机控制多达30千赫。
IGBT的对TRENCHSTOP进程英飞凌演变形象

图1:IGBT的对TRENCHSTOP进程英飞凌的演变。
IXYS已开发多个系列的场站体系,最终在第3代和GEN4家庭。该GEN4架构将沟槽拓扑与“极端光穿通”的第3代的(XPT)场站设计,支持低通态电压和快速关断的组合,以最大限度地降低开关损耗。
这些装置显示出正方形反向偏置安全工作区(RBSOA)形状高达650伏的击穿电压和标称电流的两倍,在高温下,相适应他们无缓冲器硬开关应用。该设备可以被共打包带反并联二极管,设有只要10微秒,在150℃下的高温短路坚固性。
经典与IXYS XPT架构之间的差异图片
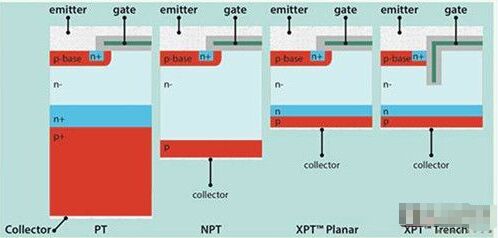


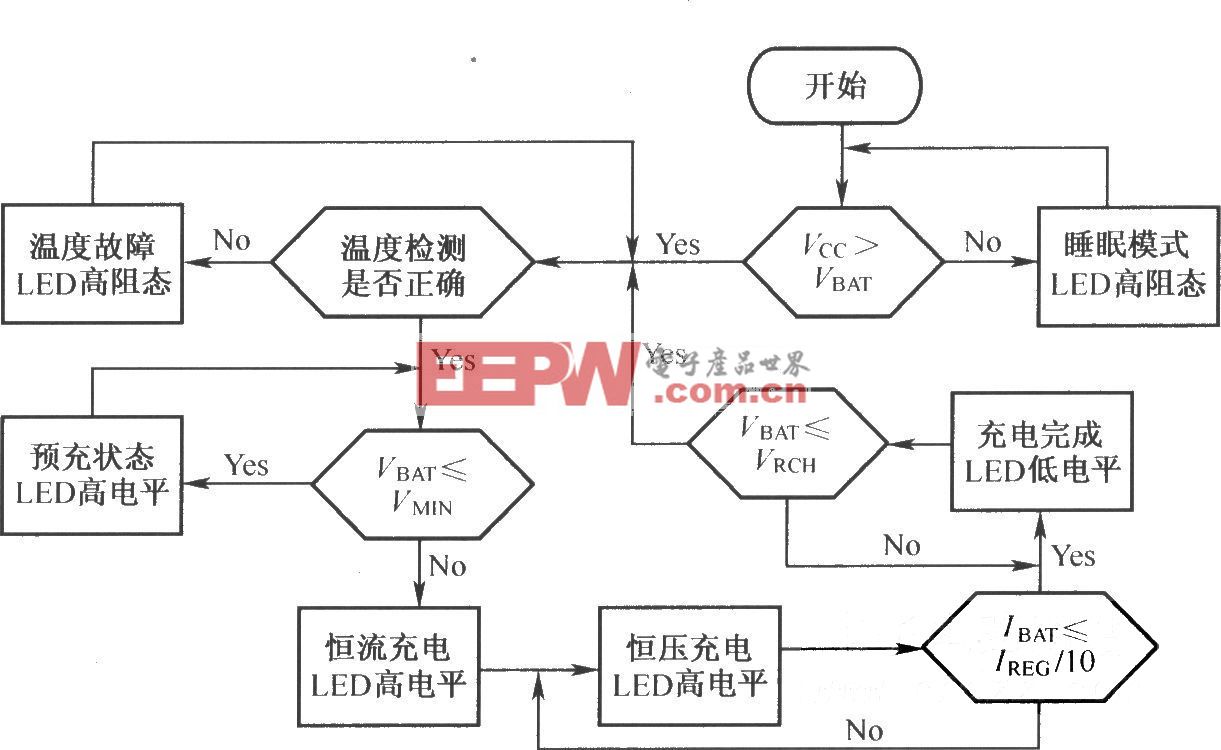










评论