散射方法测量嵌入式SiGe间隔结构
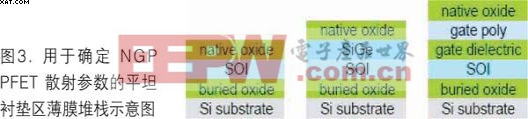
光谱灵敏度
光谱灵敏度是确定设备能否很好地测量某一给定参数的方法之一。每个波长范围(UV或DUV)均有一个与测量参数相关的灵敏度值,表示信噪比数值。灵敏度比率(DUV/UV)是一个定量指标,用于说明在测量某一给定参数时,DUV光学元件比UV光学元件更敏感的程度。测量不同芯片上同一位置的光谱信息,并把它们标识出来,是一个很好的显现光谱灵敏度的方式。
从两片晶圆的每一片中选择相同的中心芯片。每对晶圆的工艺条件都相同,只有淀积的厚度或间隔层过刻蚀量(影响过填充量)不同。图4显示了两个芯片上不同的间隔薄膜淀积条件下的光谱叠图比较。两个芯片上的散射测量样本采用TEM分析。分析表明,这两个芯片的间隔层厚度之差为4.4nm。由于波长在DUV范围内的光谱有更多的差异性,DUV光学元件对NFET间隔层厚度的改变比UV光学元件更敏感。事实上,这一灵敏度的变化发生在DUV与UV的波长跃迁处。DUV/UV的灵敏度比值为3.7,这意味着当测量这些厚度的变化时,DUV的灵敏度是UV的3.7倍。
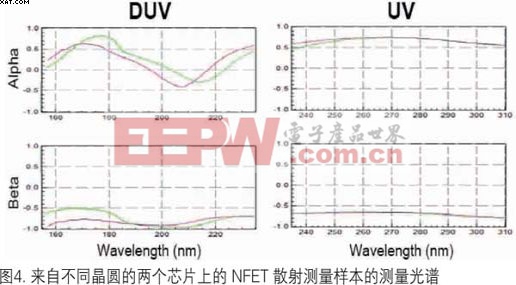
图5显示了不同淀积条件下,两个波段对PFET间隔层厚度变化的灵敏度。TEM的分析表明间隔层厚度之差为4.6nm。DUV光学元件对厚度的变化更敏感,在DUV/UV波长跃迁区,灵敏度开始再次发生变化。灵敏度比率表明,对PFET间隔层厚度的变化而言,DUV的灵敏度是UV的4.8倍。
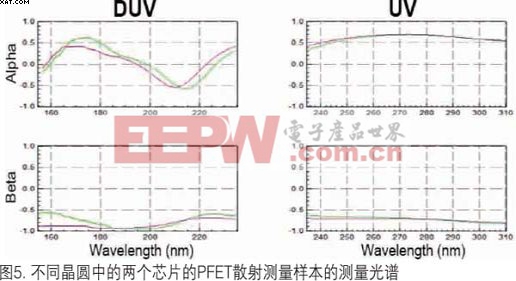
图6显示了两个芯片在不同的过刻蚀量以及不同的PFET过填充量条件下的比较。晶圆组中其它芯片的TEM结果表明,这两个芯片的过填充量差约为3nm或更少。再次证明了DUV更为敏感,其灵敏度变化大约发生在DUV与UV的波长跃迁区,灵敏度比率为1.6。
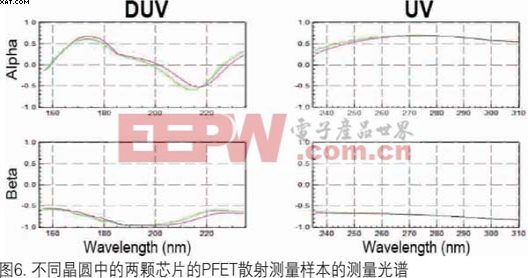
从6枚实验晶圆中收集短期动态重复性(STDR)数据。分别在每枚晶圆中选择9个芯片,并对每个芯片循环测量10次,以此来确定STDR数据。对每个芯片可进行重复性测量,其平均值便是晶圆的STDR数据,然后再将这个平均值转换成一个3σ值。图7显示了STDR的结果。结果表明,NGP间隔层测量的STDR比SCD间隔层测量的STDR约低2.5至3倍。而对于PFET过填充量,NGP的STDR较SCD约降低了2倍。

准确性
与从光谱保真度方面来评估准确性的方法不同,本实验采用总量测不确定度(TMU)分析方法,从最终测量的参数间隔层厚度和PFET过填充量方面来评估准确性,TEM作为参考测量系统 (RMS)。对于NFET结构,对每个栅极结构的TEM 图像上4个不同位置进行了间隔层厚度测量,每个



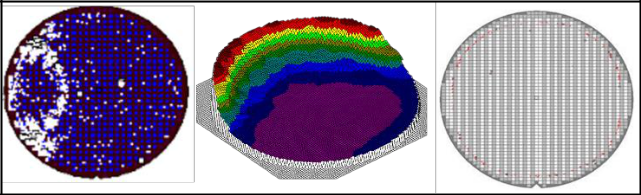






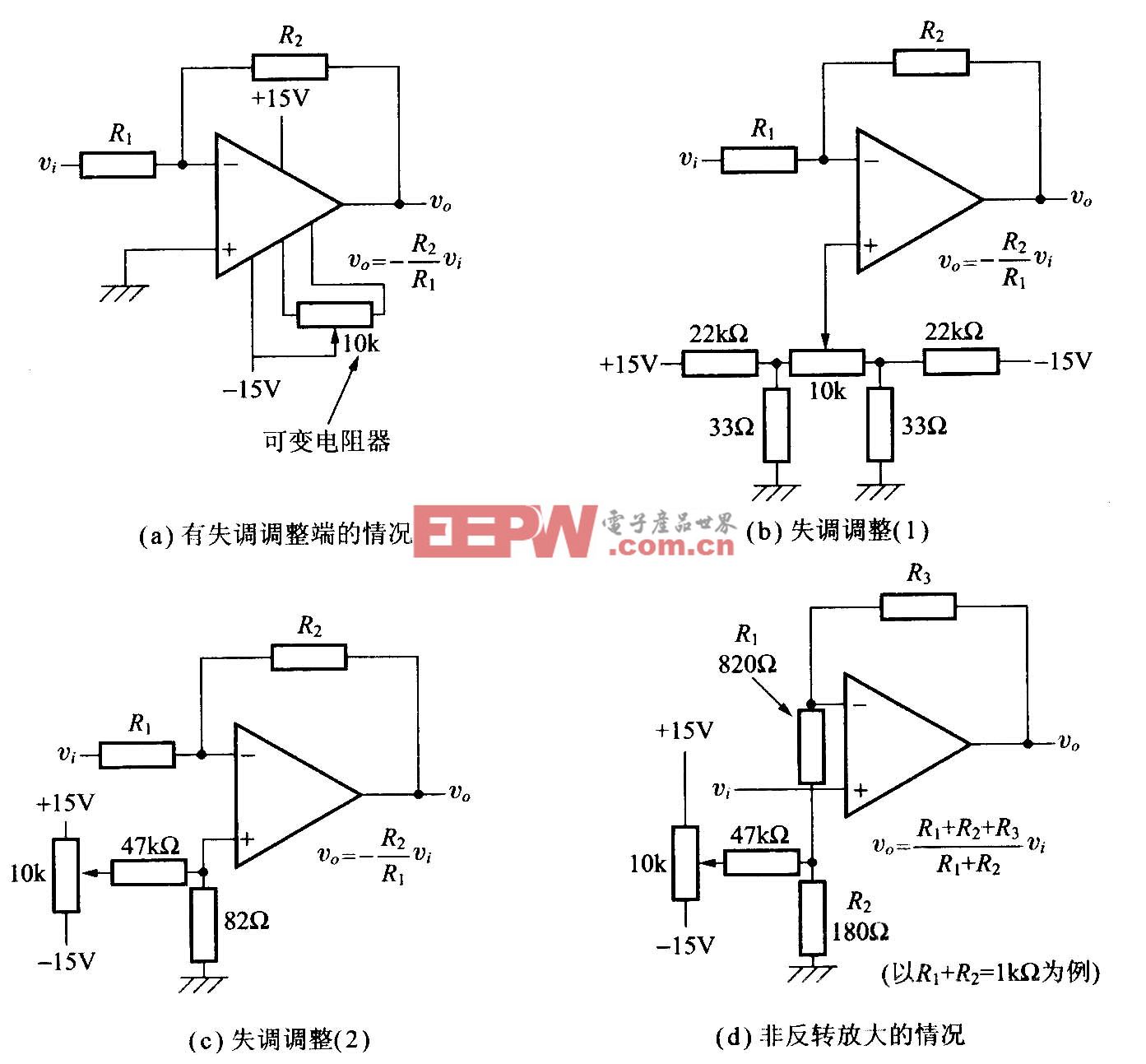







评论