热阻参数与θja 的标称差异
封装集成电路的热阻反映的是参与到散热过程中的所有部分在该几何和物理组合下的特性。以薄膜集成电路为例,其发热部分是由结、连线和半导体极化物形成的薄膜层;从这一层到封装外表面或者外部的空气,参与导热的部分包括承载这层薄膜的基底硅片、粘接剂、金属引线、填料、金属托架、引脚和封壳等等。
本文引用地址:http://www.eepw.com.cn/article/186387.htm热阻参数一般包括结到空气、结到外壳和结到基板三个热阻θja、θjc和θjb¹。
θjc和θjb是针对以外壳为主散热面和以基板为散热面加装散热器的封装的;例如顶面压装散热器的BGA封装和底面压接散热器的TO220封装。利用在散热面(封装顶面或底面)上加装高导热散热器形成恒温面和利用绝热材料限制其它方向的散热,可保证θjc和θjb测定的一致性。θja测定不能人为采取措施限制热流导向,同时温度梯度变化较大的发热点附近的微小差异都会影响热流的分配、不容易保证一致性。
θja是在开放空间内弱自然对流或风洞强制气流两种情况下测定;如果不加以说明,则指开放空间内弱自然对流条件下测定的参数。其公式表达为:
θja=(Тj-Тa)/Pd
公式中Тj为芯片的结温,Тa为环境温度,Pd为在结区的发热功率。高功率密度或者特别关注工作温度的集成电路²一般是利用设计、制作在其上的二极管直接测量结温³、进而测定θja。一般集成电路采用热测试片芯取代实际的片芯测定。测定时热测试芯片要模仿实际片芯的情况安装。θja的测定标准给出了两类测试板,分别对应高覆铜率和低覆铜率印制板的典型情况。包括外露托架在内的焊盘如何处理则是因器件和厂家而不同的,而焊盘导热路径是无散热器封装集成电路的主要散热热流路径,也是封装创新的主要着手点;其不同处理导致θja的测定值不同。
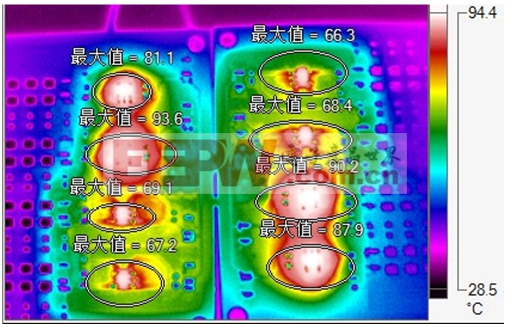
S为SGM2019,L为LP5951
图1.类似器件不同θja标称散热热像对比
SGM2019和LP5951是封装、制程、片芯尺寸和外部电路相同的两个LDO芯片,其标称θja相应为分别为260℃/W和220℃/W。为了理解这一差异,设计了元件位置和测试放置全部交错2个实验板以对比其散热特性。图1是这两个实验板的稳定热像。试验中的8个芯片的发热功率完全一致;热像上温度较低芯片的托架引脚连接的焊盘是在大面积覆铜上镂出的,散热面积大。可见单个引脚的焊盘设计差异就足以引起显著的表面温度差异。进一步详细观察可以看到器件位置的靠里、靠外也使得温度有所不同;同时,标称散热较差的SGM2019的表面温度反而更低一些。从这个实验看,这两个芯片的散热能力是非常接近,并没有如其标称热阻所反映的差异;标称差异只能来源于其测定板焊接部分的设计差异。
1网上可方便找到有关封装集成电路热阻及其测量的文章,大多包括对SEMI320-96、JEDECJESD51-4以及MIL883等标准引用可供参考。
2例如在大规模ASIC、FPGA、CPU和高可靠功率器件中。
3对二极管施加恒流偏置时,其正向压降与其结温有明确的、本征性的线性关系。通过预先刻度,可以准确确定特定恒流偏置时压降和温度的关系。
4更多介绍参考http://www.ieechina.com/upload/books/IC.pdf,刘君恺,《IC封装热阻的定义及测量技术》。
5即SEMI320-96、JEDECJESD51-4以及MIL883等标准。
6参数引用自SGM2019和LP5951的公开数据表。
7圣邦微电子公司并不因此测试调整其数据表参数。
更多资讯请关注:21ic模拟频道




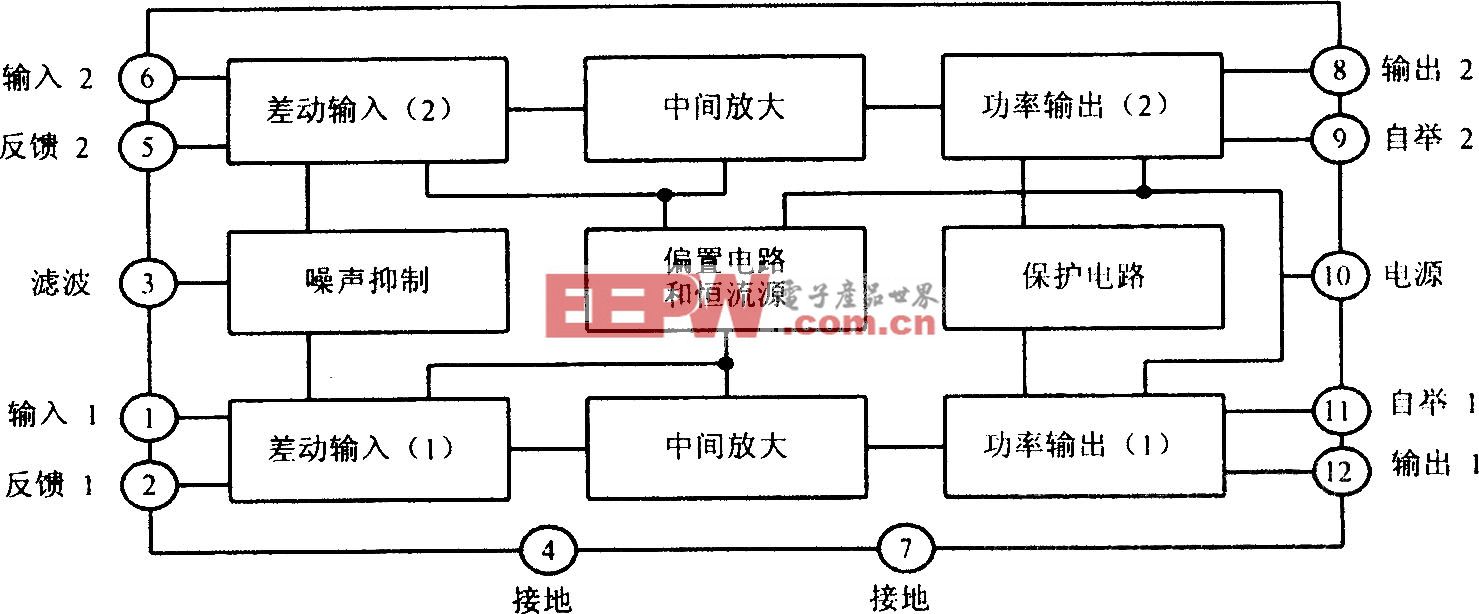



评论