ASM高级技术产品经理Mohith Verghese谈CMOS面临的关键挑战
高介电常数(High-k) 金属闸极应用于先进互补式金氧半导体(CMOS) 技术的关键挑战是什么?
本文引用地址:http://www.eepw.com.cn/article/169862.htm高介电常数/金属闸极(HKMG) 技术的引进是用来解决标准SiO2/SiON 闸极介电质缩减所存在的问题。虽然使用高介电常数介电质能够持续缩减等效氧化物厚度(EOT),整合这些材料需对NMOS及PMOS 元件采用不同的金属闸极。为了以最低临界电压(从而为最低功率)操作元件,NMOS元件必须使用低工作函数金属而PMOS 元件则必须使用高工作函数金属。即便有许多种金属可供挑选,但其中仅有少数具有稳定的高介电常数界面,并且大部份金属其工作函数会随着厚度及热预算改变而偏移。因此,业界已在使用高介电常数/金属闸极技术时,广泛选用替换闸(RPG) 工艺以紧密控制金属工作功函数以及所产生的元件临界电压。
TiN 为工作函数较高的金属,其在高介电常数介电质上稳定,因而可用来当作PMOS 的闸极。然而,对于NMOS 而言,大部份低工作函数的金属(铝、钛等)在高介电常数材料上非常不稳定,会有漏电流及可靠度的问题。迄今为止,NMOS 元件的解决方案是采用控制掺杂金属扩散,例如将铝掺入闸极介电质上的TiN 层。由于纯金属ALD 有其难度,故标准平面HKMG 技术结合ALD(HfO2、TiN、TaN)与PVD (Al、Ti) 薄膜以设定适当的元件临界电压。厚度及热预算必须严密控制以确保晶粒与晶圆有良好的可变性。随着业界转移到FinFET (鳍式场效电晶体)技术,阶梯覆盖率的需求更具挑战性。纯金属 PVD 不再列入考虑。有必要引进新的ALD 金属以确保元件临界电压可设定妥当。闸极堆叠中的ALD 金属薄膜不仅要设定正确的工作函数,同时也要有100% 的阶梯覆盖率、低电阻率以及更重要的是,在元件内妥善整合而没有可靠度衰减的问题。
在高介电常数金属闸极沉积工艺中,ALD 提供非常好的薄膜品质。但其沉积率较低。身为设备供应商,ASM 将如何改良沉积率? ALD 在薄膜品质与沉积率方面是否优于MOCVD ?
在理想的ALD 工艺里,薄膜生长完全控制于表面。前导物(precursor) 以脉冲方式送入反应器时,将与所有可用的反应位置(reactive site) 发生作用,直到反应位置耗尽。表面若无反应位置则将中止薄膜生长。因此,ALD 薄膜生长的确可一次一原子层地受到控制。这与MOCVD不同,其生长主要由前导物之浓度与流量以及沉积工艺的温度与压力所控制。仅管ALD 沉积率可能慢(一般低于每个周期1 埃),但可藉由适当的反应器及前导物递送设计而优化周期。随着适当的反应器设计,ALD 工艺的产出量确实比得上MOCVD,尤其是对于薄膜而言。对于某些薄膜,ASM 已展示高达每分钟200 埃的单一晶圆ALD沉积率。另外,藉由新批样及微批量工具设计,较低产出量的问题得以解决。然而,要注意的是,许多ALD 工艺实际运作时,在薄膜中将有CVD 成份,理由在于脉冲式补充前导物时,反应器内将存在未净化的前导物。这可能是因为ALD 反应器设计不良或为了极度缩短ALD 周期所致。通常,工艺工程师会优化ALD 工艺而混合正确的CVD与ALD成份用量,从而增加产出量,同时也保持优越的阶梯覆盖率及ALD 薄膜的薄膜品质。
反应室(chamber) 的温度及压力如何影响ALD 薄膜品质?热壁式反应室与冷壁式反应室有何不同?那一种才是 ALD 设备的未来趋向?
ALD 薄膜沉积的工艺窗口较大,前导物剂量(precursor dose),温度及压力通常受到积极控制以得到正确的薄膜品质。反应器压力有助于优化净化时间并且确保沉积反应器净化妥当。 ALD 薄膜生长及品质由前导物之间的反应动力学(kinetics of the reaction) 所决定。温度有助于于控制反应历程,然而,大部份常见的ALD 制程较不受温度影响。反应器的温度控制主要在于管理用于沉积制程的前导物分解。许多ALD 前导物对温度敏感,ALD 反应器的设计必须配合适当处理并且递送这些材料。
在热壁式反应室中,整个反应器加热到与晶圆晶座/基盘(wafer susceptor/chuck) 的温度一样。此类反应器对于ALD 沉积来说是理想选择,尤其是在所使用的前导物不易分解时。由于室壁是整个加热,净化效率得以提升因为前导物容易由反应器表面释出。在冷壁式反应室里,晶圆是在晶座/基盘上加热,伹反应器的壁面保持较冷的温度。此类反应器在使用易分解前导物时有帮助,因为前导物可以不用分解直到其接触晶圆表面。然而,冷壁式反应器会难以净化,尤其是在使用如H2O 或NH3 之「强固」式反应物时更是如此。热壁式及冷壁式反应器在ALD 中都有其应用性,但要考虑所要沉积的薄膜以及可选用的前导物小心作出正确的选择。
在45纳米节点中,人们开始用HfO2 作为闸极介电材料。在更先进的节点中,是否有采用任何新的氧化物材料?设备的新挑战又是什么?
HfO2 已是用于数代HKMG 技术的标准高介电常闸极介电质。大部份先进HKMG 元件的关键挑战在于高介电常数闸极介电质的持续缩减。 HfO2 在最新的技术节点已渐次缩减到大约12 至15 埃。由于这只代表少数单层介电材料,进一步物理缩减已不可行,闸极介电质在不远的未来将必须改用更高介电常数的替代物。然而,由于过去十年对于HfO2 已有许多整合上的学习(learning),转用完全不同的材料系统不是易事。最明显的过度是以较高介电常数掺杂基质HfO2 以增强总介电质堆叠的缩减性,同时改善漏电流及可靠度的效能。由于堆叠总EOT 有许多是由HfO2 底下SiO2 界面层的较低介电常数值所决定,故以较高介电常数材料掺杂此界面层还在努力中。本方法对于减少EOT 是最有前途的方法,但就整合观点而言也最麻烦。 SiO2 界面广为人所熟悉,去除或修改此界面一直都会导致迁移率减退以及元件可靠度降低。
若上述方式证实无法成功,闸极介电质的物理缩减将削弱,并且产业界将被迫移往新架构,如闸极遍布架构(gate all around structure) 或更高迁移率的基底,如锗(Ge) 和砷化铟镓(InGaAs),用以持续改良半导体元件的效能。


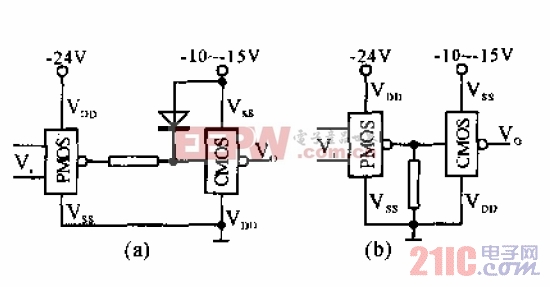



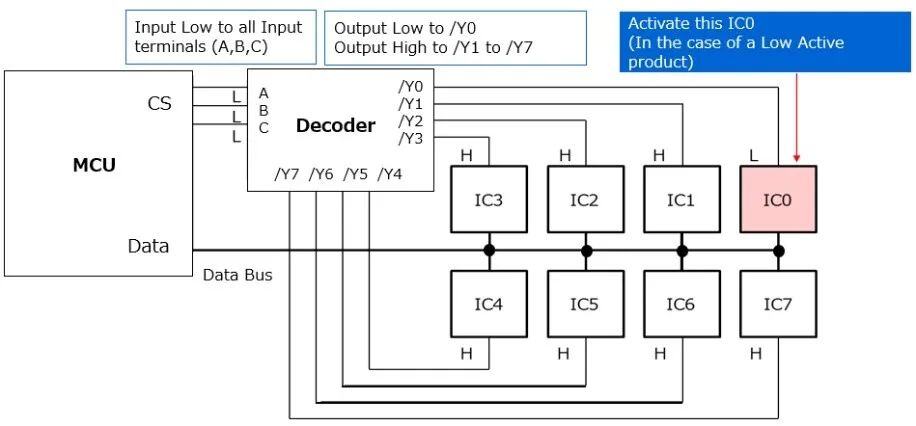
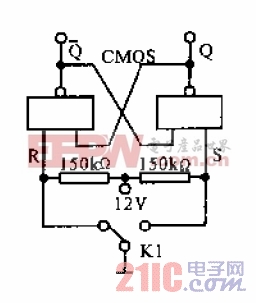
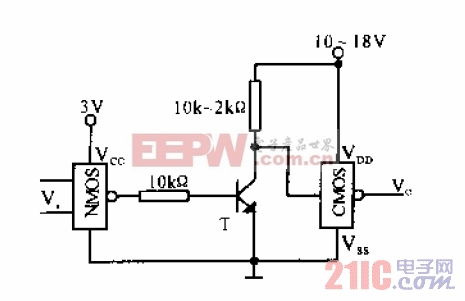






评论