手机芯片UV胶绑定可靠性问题分析
B1板切片后,主芯片焊点A17在PCB焊盘下方有开裂现象,如图6所示。
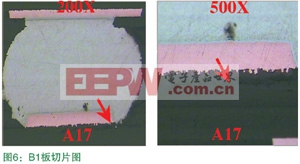
B2板切片后,主芯片焊点U17在PCB焊盘与锡球之间有开裂现象,如图7所示。
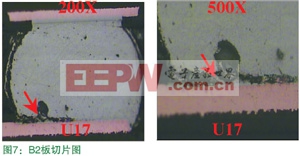
C1板切片后,主芯片焊点U1在PCB焊盘和锡球之间有开裂现象,如图8所示。
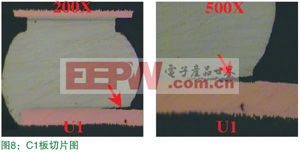
C1板切片后,主芯片焊点U1在PCB焊盘和锡球之间有开裂现象,如图9所示。
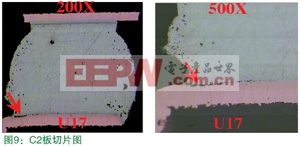
返修工艺对比
对底部填充和UV胶绑定工艺手机主板的返修情况及工艺成本进行比较(见表2),UV胶绑定芯片返修容易且没有报废。

综合胶水、人工、设备、工艺等方面粗略估算,底部填充工艺的返修成本是UV胶绑定方法的两倍以上。
小结
通过以上试验数据比较和失效分析可以得知:
1、手机主板的芯片最容易失效的部位是四个角部的焊点;
2、运用UV胶绑定或底部填充工艺,主板抗跌可靠性 要比不使用这两种工艺的产品高两倍以上;
3、底部填充工艺对焊点的保护和产品的可靠性的提高 稍优于UV胶绑定工艺,但UV胶绑定在实际应用中 可操作性强,易返修且成本低50%以上;
4、这两种不同的加强可靠性方法,设计者可以根据需要选择相应的工艺。



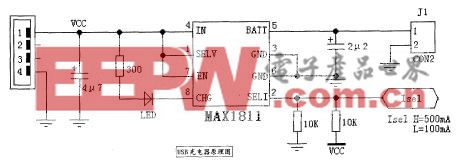








评论