基于系统级封装技术的车用压力传感器
1.金属膜片 2.金属壳体 3.TO管座 4.电路板 5.引脚 6.转接板 7.填充陶瓷片 8.扩散硅压力敏感芯片

1.金属膜片 2.金属壳体 3.引脚 4.电路板 5.填充陶瓷片 6.扩散硅压力敏感芯片
由于有两层壳体,造成压力传感器体积大,成本也不易降低,同时由于将敏感头和电路板放入外壳的过程中需要加压、卷边,将导致敏感头产生内部应力,出现零点飘移。
当应用SIP技术将敏感芯片和电路一起植入外壳中时,体积明显比传统封装工艺小,省掉一道外壳也降低了成本。只需要将膜片上的压环设计成需要的螺纹接口,同时将壳体另一端压接合适的输出和电源接头就能满足不同场合的需要。
3.2 陶瓷基板实现敏感元件和电路的一体化
封装首先在位置上要固定敏感器件,其次要能够进行必须的电路连接,常用的封装形式有TO封装、气密充油的不锈钢封装、小外形塑料封装等。
扩散硅压力芯片和玻璃载体之间的静电封接工艺是MEMS芯片封装中常用的工艺。为了避免芯片在封接时是产生大的热应力,通常选用热膨胀系数与硅相近的材料作芯片的载体。为减小压力传感器的体积,实现系统级封装,必须将扩散硅压力芯片和相关电路集成在一块电路基板上,也就是电路板本身作为扩散硅压力芯片的载体,达到此目的的首要条件是电路基板材料的热膨胀系数与硅片的热膨胀系数相近,在普通电路板所使用的基板材料中只有陶瓷基板满足要求,因此在电路板设计中选用陶瓷基板,并根据体积和结构的要求,选用0402封装的电阻、电容和电感,极大地缩小了电路系统的体积和外形尺寸,实现敏感元件和电路的一体化,绑定好压力芯片、焊接了驱动放大电路的电路板如图3所示。

图3 印刷电路板和陶瓷填充片
3.3 陶瓷填充片有效减少硅油填充量
不锈钢隔膜片封装的硅压阻压力传感器的结构为气密封装,它的结构特点非常有利于发展成系列化的、通用型的传感器。基于SIP技术的系统级封装压力传感器也采用这类基本封装形式。
这种隔离膜压力传感器头由金属基座、管壳、硅油、传感器压力芯片及不锈钢膜片组成。其主要的制造工艺为:硅芯片直接帮定在陶瓷电路基板上,与恒流原激励电路、放大电路、温度补偿电路和其他电路一起构成完整的电路基板,电路基板用胶接工艺固定在不锈钢管壳内的基座上;不锈钢隔膜与壳体采用熔焊工艺进行焊接, 焊接工艺可用激光焊接、氩弧焊接或电子束焊接等。硅油灌充工艺一般采用真空灌充技术,可基本消除残余气体对隔离测压系统的影响,提高传感器的精度及稳定性。
在保证压力传感器内部电路基板安装间隙、帮定引线安全,并且保证压力可靠有效传递的前提下,专门设计了陶瓷填充片,图4中白色物体即陶瓷填充片,它能有效减少压力传感器内部充油空间,降低传感器的飘移。
3.4 硅油的净化和真空灌注
硅油灌充工艺采用真空灌充技术,可基本消除残余气体对隔离测压系统的影响,提高传感器的精度及稳定性。
在传感器的结构设计中,利用电路板将壳体内部的空间分隔为两个部分(参见图2),不锈钢膜片1和电路板4之间的空间是硅油灌注空间,为减少硅油灌充量,在此空间安放了陶瓷环片5,同时采用先焊接不锈钢膜片后灌充硅油的工艺,将电路板和陶瓷环片放入壳体中,然后利用氩弧滚焊将压环和不锈钢膜片焊接完成,再采用真空灌充技术完成硅油的灌充。
3.5 多点温度补偿技术
压力芯片、恒流激励源、放大电路及其封装材料等不可避免的温度特性最终导致压力传感器的输出随温度的变化而有飘移,这种温度飘移如果不加补偿,将使传感器的输出随温度而变化,导致传感器输出的不确定性,从而无法使用。
硅压阻压力传感器本身有一个固有的特性,就是温度系数较大;因此需要对其进行温度误差补偿。常用的温补方式是在应变电桥上附加电阻网络,通过测试及计算其高低温特性,确定网络阻值,以达到温度补偿的目的。
车用压力传感器要求在-40℃~+125℃的超宽工作温度范围内稳定工作,常用的温度补偿方法难以实现这个目标,为此,在附加电阻网络的基础上,通过多个热敏电阻分别对应变电桥、恒流激励源、放大电路增益进行温度补偿,从而保证在-40℃~+125℃的超宽工作温度范围内的稳定工作。
由于系统采用多点温度补偿技术,相应增加了系统的复杂程度,尤其是电路的调试,针对该问题通过大量的实验、调试以及数据分析,相应设计并建立了一套完善的调试方法,批量生产中可以根据该方法设计压力传感器温度补偿测试系统,实现该工作的自动化。









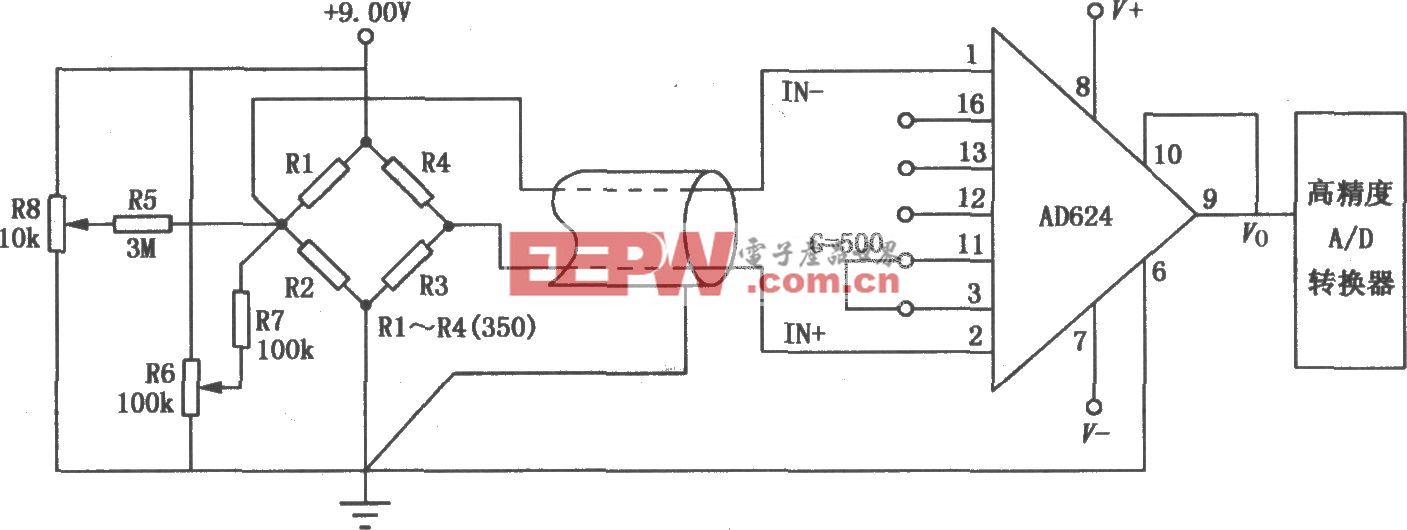



评论