联电、尔必达、力成宣布联手开发TSV 3D IC技术
随著半导体微缩制程演进,3D IC成为备受关注的新一波技术,在3D IC时代来临下,半导体龙头大厂联华电子、尔必达(Elpida)和力成科技将于21日,一起召开记者会对外宣布共同开发矽穿孔(TSV) 3D IC制程。据了解,由联电以逻辑IC堆叠的前段晶圆制程为主,尔必达则仍专注于存储器领域,而力成则提供上述2家公司所需的封测服务,成为前后段厂商在 TSV 3D IC联手合作的首宗案例。
本文引用地址:http://www.eepw.com.cn/article/110162.htm尔必达、力成和联电将于21日在联电联合大楼举行技术合作协议签订记者会。据了解,3家公司的董事长、执行长和技术长皆会亲自出席,包括尔必达社长坂本幸雄、技术长五味秀树,力成董事长蔡笃恭、总经理廖忠机和技术本部总技术长岩田隆夫,以及联电执行长孙世伟、先进开发技术副总经理简山杰等重量级人物,显见3家公司对此次记者会十分重视。
目前TSV 3D IC技术最主要应用仍为CMOS Image Sensor及部分微机电系统(MEMS)相关产品的制造。联电对于逻辑IC方面的堆叠也相当有兴趣,该公司在5月20日30周年庆时,即由简山杰对外说明该公司在特殊技术的开发成果,其中在TSV 3D IC方面,简山杰说,其优点在于运用不同的IC,使元件更小、效能更高。该公司采先钻孔(Via First)为主要开发方向,提供芯片间更短及更低电阻的导线连接技术,符合下一世代高效能IC需求。
根据统计,随著TSV加工技术进步,与加工成本下滑,采用TSV 3D IC技术的半导体产品出货量市占比重会大幅提高,其中DRAM与Flash等存储器产品更占TSV 3D IC出货过半比重,因此三星电子(Samsung Electronics)、尔必达等日、韩系存储器大厂已投入TSV 3D IC技术研发。据了解,尔必达已于2010年量产。
后段厂力成近年来积极切入3D IC领域,该公司董事长蔡笃恭日前曾表示,该公司与客户(应指尔必达)已经合作开发将近2年的时间,并已斥资新台币10亿~20亿元设置产线。而力成与尔必达合作关系密切,随著尔必达已经量产,力成也将会配合提供后段的服务,将以后钻孔(Via Last)技术为主。
TSV 3D IC电气特性虽佳,但技术难度较高,蔡笃恭当时预估该公司在TSV 3D IC技术将在2010~2011年进入送样阶段,最快2012年量产。


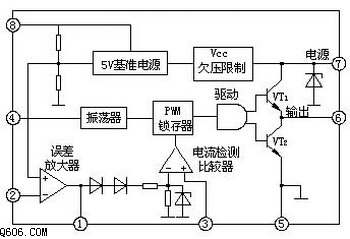










评论